ECPE-Workshop
Leistungsmodule der Zukunft
Fortsetzung des Artikels von Teil 1
Kontaktierung der Chip-Oberseite
Einer der Schwerpunkte dieses Workshops war die Kontaktierung der Chip-Oberseite (Top Die Connection), denn die bislang übliche Anbindung mit Bond-Drähten aus Aluminium stößt bei zukünftigen Anwendungen mit höheren Leistungsdichten an ihre Grenzen. Robert Woehl von Danfoss Silicon Power diskutierte den Einsatz von Bonddrähten aus Kupfer statt Aluminium. Allerdings sind die aktuellen Metallisierungen auf der Chipoberseite für das Bonden mit Kupfer ungeeignet. Um einen Schritt weiterzugehen, arbeitet Danfoss nicht nur am Bonden mit Kupferdrähten, sondern mit Kupferstreifen. Der Redner betrachtete die Zuverlässigkeit des Bondens mit Kupferstreifen. Dieser stieg um den Faktor mehr als das 16-Fache gegenüber der Standardtechnik mit Aluminiumdrähten.
Um das Ultraschallbonden mit Kupferdraht oder -bändchen zu ermöglichen, stellte Andreas Hinrich von Heraeus Electronics das Die Top System (DTS) vor, das auf der von Danfoss entwickelten Bondbuffer-Technologie basiert. Dabei wird auf den Chip eine Kupferfolie aufgesintert, auf die sich wiederum dann Kupferdrähte oder -bändchen bonden lassen, um den Chip elektrisch zu kontaktieren. Diese aufgesinterte Kupferfolie bietet verschiedene Vorteile. Zum einen schützt sie beim DTS den Chip vor den hohen Kräften, die beim Ultraschallbonden mit dicken Kupferdrähten oder -bändchen auftreten, zum anderen kann sie die Wärme spreizen, sodass die maximal auftretende Temperatur auf dem Leistungshalbleiter deutlich sinkt. Auch die Stromdichte verteilt sich gleichmäßiger.
Jobangebote+ passend zum Thema
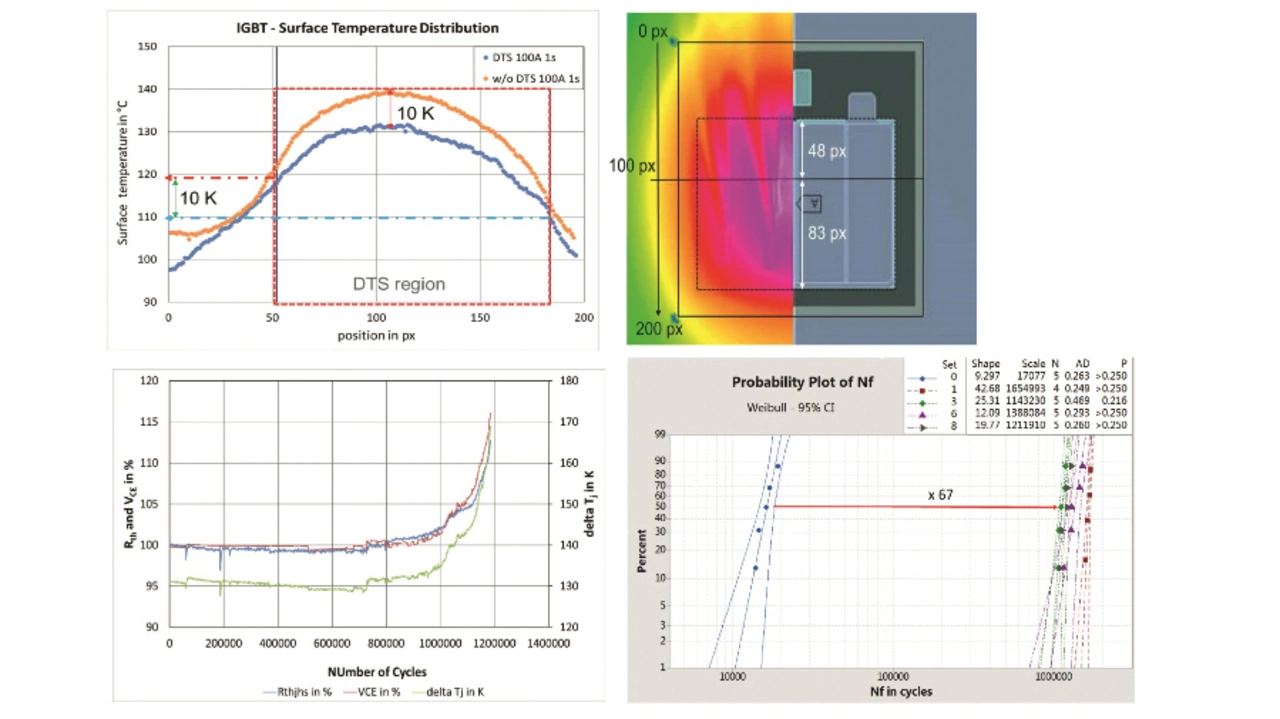
Mit dem Einsatz des DTS und dicken Kupferbonddrähtensteigt die Lebensdauer signifikant. Bei der indirekten Kühlung ohne Bodenplatte (Base Plate) des vorgestellten Testlayouts sinkt die Oberflächentemperatur des IGBT bei einer Belastung mit 136 A um 10 K gegenüber demgegenüber gelöteten und mit Aluminiumdraht gebondeten Aufbauten. Dies bedeutet auch,dass die Lebensdauer um den Faktor 67 steigt (Bild 3). Bei der direkten Kühlung mit einer Systemlötung auf Bodenplatte zeigt sich, dass alle Test-Setups mit DTS die Lebensdauer nach dem CIPS2018-Modell um den Faktor 6 bis 10 erhöhen und dass die bodenplattenlosen Aufbauten eine höhere Lebensdauer erwarten lassen als die mit Bodenplatte. Dabei muss beachtet werden, dass die Aufbauten mit Bodenplatte mit 197 A fast 50 Prozent mehr Strom vertragen mussten (und konnten), um im Test den gleichen Temperaturhub zu erzielen.
Üblicherweise erfolgt das Drahtbonden mit Ultraschall. Als Alternative stellte Dr. Hans-Georg von Ribbeck von F&K Delvotec das Bonden mithilfe von Laserstrahlung vor. Dadurch lassen sich nicht nur punktförmige Bondverbindungen realisieren, sondern mittels eines oszillierenden Lasers auch flächige Verbindungen mit Aluminium- oder Kupferbändchen für große Ströme.
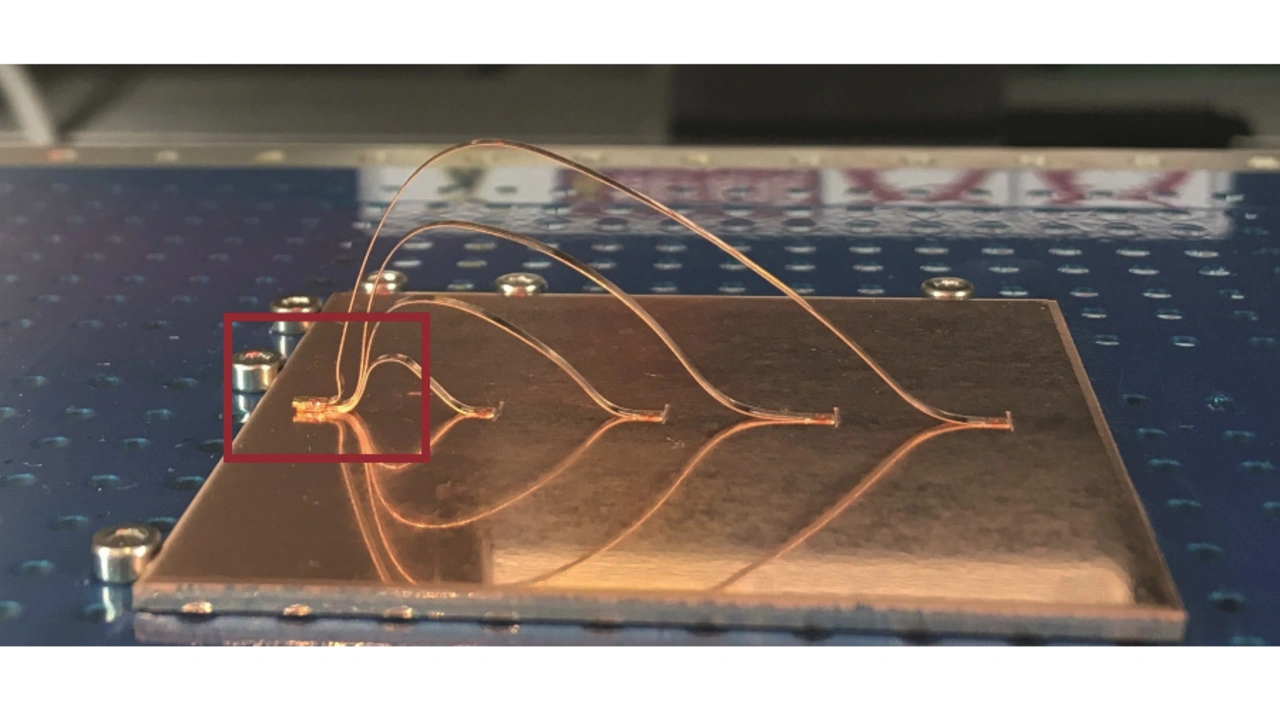
Mit dieser Technik lassen sich nicht nur starre Kontakte anbinden, sondern auch sich biegende, da für das Laserbonden kein hoher Anpressdruck oder besondere Steifigkeit des Produktes nötig sind. Zudem lassen sich auch die Sekundäranschlüsse – die vom Substrat zu den Modulterminals – mit dieser Technik realisieren. Steht nur wenig Platz für Bondverbindungen zur Verfügung, lassen sich zudem die weiteren Verbindungen per Laserbonden übereinander stapeln (Bild 4).
Zwei doppelseitig gesinterte Modultechniken – SKiN und DPD (Direct Pressed Die) – verglich Peter Beckedahl von Semikron. Bei beiden Prozessen wird der Chip auf der Oberseite mit einer darauf gesinterten flexiblen Leiterplatte kontaktiert. Der Unterschied: Bei DPD wird der Chip zusätzlich mit einem elastischen Höcker aus Silikon auf das Substrat gedrückt, und das Substrat wird nicht auf die Bodenplatte gesintert. Stattdessen genügt eine dünne Schicht Wärmeleitpaste (ca. 5 µm), sodass keine Hohlräume unter den Chips auftreten. Weil also Substrat und Bodenplatte nicht starr miteinander verbunden sind, biegt sie sich nicht aufgrund unterschiedlicher Ausdehnungskoeffizienten (Bimetall-Effekt), und so sind größere Substrate möglich. Bei einem direkten Vergleich von SKiN- und DPD-Technologie unterscheidet sich der thermische Übergangswiderstand von Sperrschicht zu Umgebung lediglich um vier Prozentpunkte.
Zum Abschluss des ersten Tages blickte Vincent Bley vom Laplace Laboratory mit dem Thema »Die Interconnection for Power Module3.0« auf Verbindungstechniken der Zukunft. Er stellte drei Forschungsthemen vor: Direktbonden von Kupfer auf Kupfer, Nanopfosten aus Kupfer sowie leitfähige Schäume. Mit Letzteren lassen sich Halbleiter, die in einer Leiterplatte eingebettet sind, elektrisch kontaktieren.
- Leistungsmodule der Zukunft
- Kontaktierung der Chip-Oberseite
- Verguss und Wärmemanagement
- Einbetten von Leistungshalbleitern