ECPE-Workshop
Leistungsmodule der Zukunft
Fortsetzung des Artikels von Teil 3
Einbetten von Leistungshalbleitern
Ein anderer Weg, Leistungshalbleiter ins System zu integrieren, ist das Einbetten (Embedding) in eine Leiterplatte oder ein keramisches Substrat. Zechun Yu vom Fraunhofer IISB berichtete über das Embedding von Wide-Bandgap-Bauelementen in ein keramisches Substrat. Zwar bietet das Einbetten in eine Leiterplatte einige Vorteile – Miniaturisierung (kein Gehäuse), niederinduktiver Aufbau (keine Bonddrähte), zweiseitige Kühlung –, aber das Einbetten in ein Keramiksubstrat bietet darüber hinaus zusätzliche Vorteile.
Darunter fallen die Temperaturfestigkeit (über +200 °C), niedriger Wärmewiderstand, hohe Stromtragfähigkeit durch Dickkupfer, Widerstandsfestigkeit gegen Korrosion und kleinerer Unterschied der Wärmeausdehnungskoeffizienten (Bild 9). Als Testvehikel nutzen die Forscher eine SiC-Diode für 3,3 kV mit einer Stromdichte von 100 A/cm². Die verschiedenen Prozessschritte wurden evaluiert, wofür sich sowohl das Löten als auch beidseitiges Sintern eignet. Im Test arbeitete die Diode bis +250 °C einwandfrei.
Jobangebote+ passend zum Thema
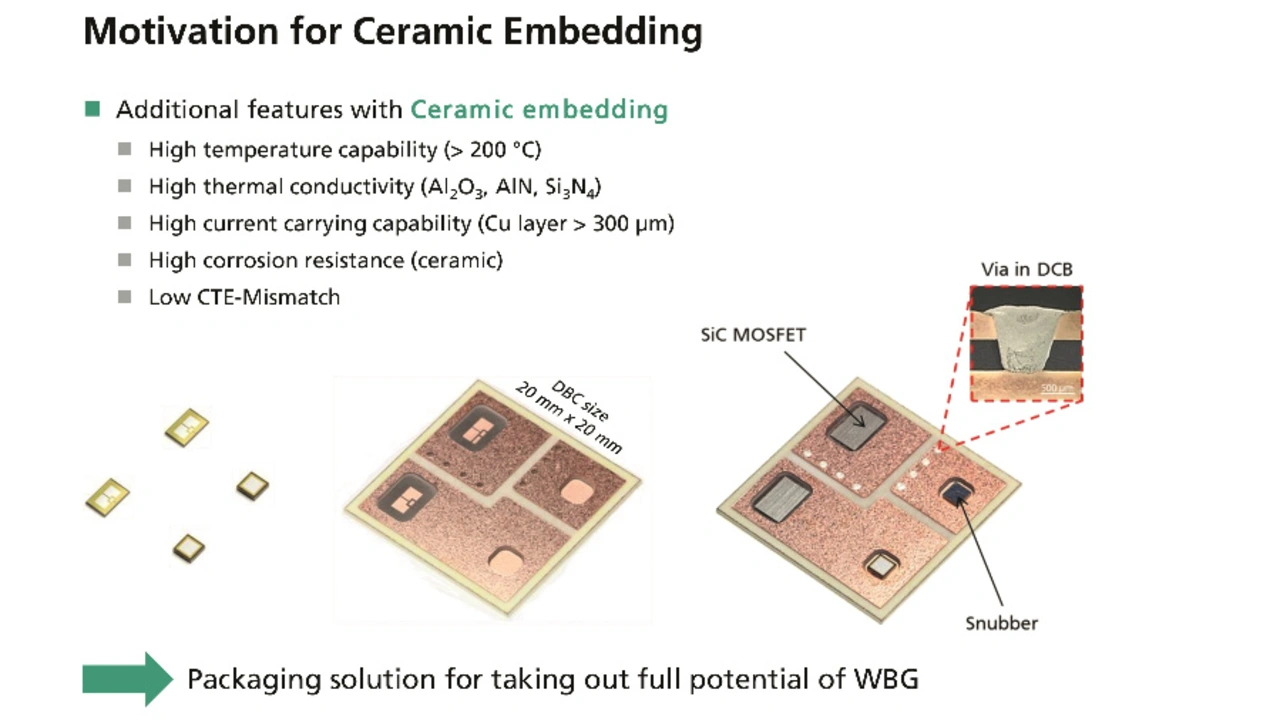
Das Einbetten in die Leiterplatte stellte Thomas Gottwald von Schweizer Electronic vor. Wie viel besser das gegenüber einem Bauteil in einem diskreten Gehäuse ist, machte er anhand eines OptiMOS 5 von Infineon deutlich. Während dieser 80-V-Transistor im diskreten TOLL-Gehäuse einen Einschaltwiderstand von 1,2 mΩ und einen maximalen Drain-Strom von 300 A aufweist, betragen im eingebetteten Smart p² Pack diese Parameter 0,9 mΩ beziehungsweise 460 A – bei jeweils gleichem MOSFET!
Auch der Wärmewiderstand sinkt um 30 Prozent (Bild 10). Gegenüber einem Aufbau auf einem Al2O3-Substrat bietet das Smart p² Pack mindestens das Zehnfache an Lastzyklen bei höherem Temperaturhub (ca. 100.000 Zyklen bei 80 K vs. > 1 Mio. Zyklen bei 120 K). Die Roadmap bei Schweizer sieht vor, bis 2020 auch für SiC und GaN entsprechende Lösungen für höhere Spannungen zu entwickeln.
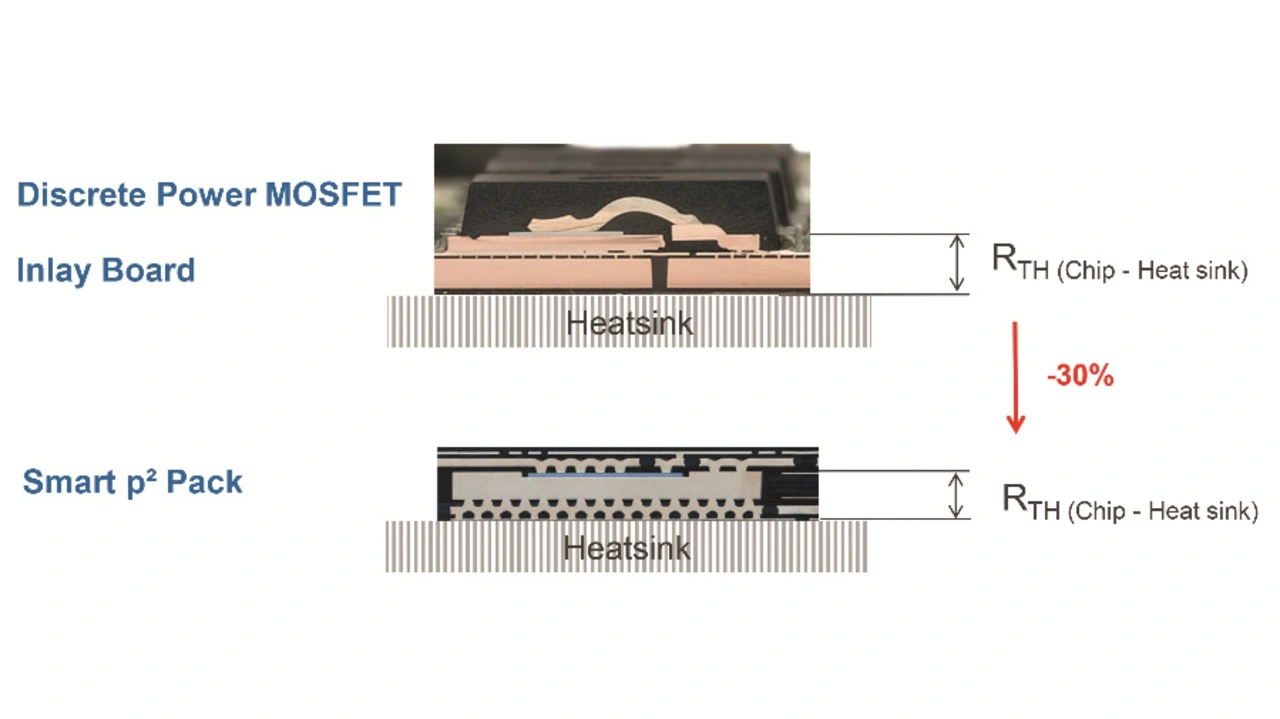
Materialien
An der Verbindungsstelle zwischen Keramiksubstrat und Bodenplatte kann es zu übermäßigen mechanische Belastung an einzelnen Ecken kommen, wenn nach dem Lötung das Substrat nicht koplanar auf der Bodenplatte aufsitzt. Dadurch startet der Delaminierungsprozess früher, und die Zyklenfestigkeit des Powermoduls sinkt. Um diesen Effekt zu verhindern, stellte Khartik Vijay die Lösung InForms von der Firma Indium. Dies ist eine wabenförmige metallene Gitterstruktur, in die das Lot aufgebracht ist und die als Abstandshalter zwischen Substrat und Bodenplatte dient. Vom Handling ähnelt sie einem Isolierplättchen, allerdings viel größer.
Ein Vorteil dabei ist auch, dass der Lötprozess überhaupt nicht geändert werden muss, sondern sich als Drop-in-Ersatz eignet. Für eine Traktionsanwendung wurden verschiedene Module Temperaturzyklen ausgesetzt, wobei die Endtemperaturen von –50 °C und +150 °C jeweils 30 Minuten gehalten und dann innerhalb von 30 Sekunden von der einen zur anderen Endtemperatur durchfahren wurden. Während bei konventionellen Modulen bereits nach einigen hundert Zyklen erste Risse und Delaminierungen festzustellen waren, konnten die Forscher bei dem mit InForm aufgelöteten Modul selbst nach 2000 Zyklen weder Risse noch Delaminierungen beobachten.
Über die Robustheit von Sinterverbindungen mit Kupferpasten referierte Hideo Nakako von Hitachi Chemical. Diese seien besonders mit Blick auf die Wide-Bandgap-Halbleiter mit ihren höheren möglichen Sperrschichttemperaturen von über +200 °C interessant. Hitachi hat dazu zwei Kupferpasten entwickelt: eine, die ohne Druckbeaufschlagung, aber unter Wasserstoffatmosphäre aushärtet, und eine andere, die einen Anpressdruck von mindestens 1 MPa unter Stickstoffatmosphäre erfordert. Letztere eignet sich auch für größere Chips mit Abmaßen von 15mm × 15 mm. Beide Pasten wurden getestet, wobei sich herausstellte, dass diejenige, die unter Anpressdruck und unter Stickstoffatmosphäre aushärtet, eine ungefähr nur halb so große Körnung (Porosity) aufwies als die andere. Im Temperaturzyklustest zeigte die feinkörnige Kupferpaste die höchste Robustheit; gegenüber der Lötverbindung ist sie um 16-Mal robuster, gegenüber der Silbersinterpaste 1,6-Mal.
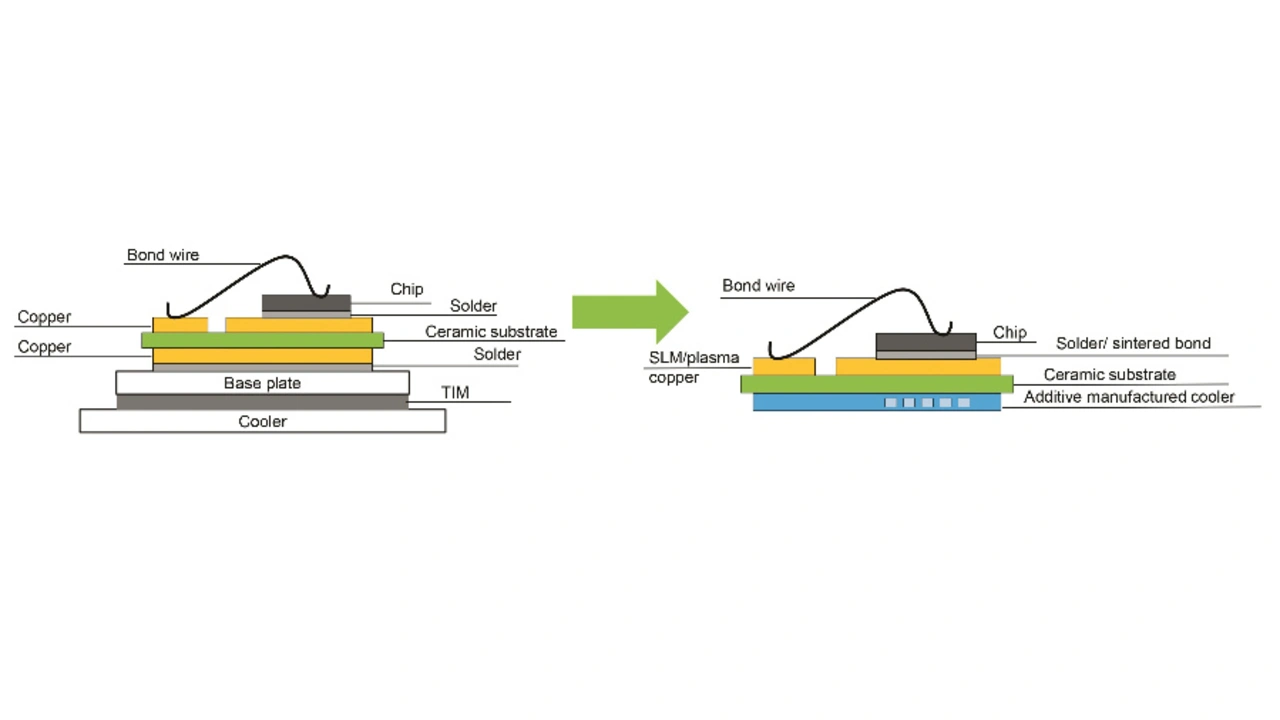
Zum Abschluss des Workshops stellte Thomas Stoll von der Universität Erlangen-Nürnberg noch die Möglichkeiten der additiven Fertigung (3D-Druck) in der Leistungselektronik vor. Diese gehen mittlerweile weit über den schnelle Aufbau von Prototypen hinaus (Rapid Prototyping). Damit lassen sich auch Teile mit hohen mechanischen Anforderungen herstellen und Schaltungen um mechatronische Eigenschaften ergänzen (Additive Mechatronization). Ein Beispiel dafür sind dreidimensionale Schaltungsträger mit eingebetteten elektronischen Komponenten. Weitere Ziele, die sich mit der additiven Fertigung adressieren lassen, sind die Fertigung benutzerspezifischer dreidimensionaler Mikrokühlkörper, das Eliminieren einer ganzen Reihe von Prozessschritten gegenüber der klassischen Modulfertigung sowie die Eliminierung der thermischen Schnittstelle, was die Wärmeableitung verbessern würde (Bild 11). Auch die Reduzierung von Gewicht und Material ist ein Ziel.
WEITERFÜHRENDE LINKS
[1] Video-Interview mit Prof. Dr. Eckart Hoene
[2] Video-Interview mit Prof. Dr. Frank Osterwald
[3] Bicakci, A., et al.: Power Modules based on Multi-layer Lead Frame Assemblies with Organic Insulation; Workshop »Advanced Power Packaging – Power Modules 2.0«, ECPE, 2019
[4] de Monchy, M.; Silver Sintering – New Form Factors for Next Generation Power Modules; Workshop »Advanced Power Packaging – Power Modules 2.0«, ECPE, 2019
[5] Hinrich, A.; Reliability of Sintered DieTopSystems in Power Cycling Tests; Workshop »Advanced Power Packaging – Power Modules 2.0«, ECPE, 2019
[6] von Ribbeck, H.-G.; Laserbonding – A Novel Solution for High Power Application Challenges; Workshop »Advanced Power Packaging – Power Modules 2.0«, ECPE, 2019
[7] Johnson, C. M., et al.; Planar Power Modules for High Voltage Applications; Workshop »Advanced Power Packaging – Power Modules 2.0«, ECPE, 2019
[8] Idaka, S.; New Developments in Resin Encapsulated Power Module; Workshop »Advanced Power Packaging – Power Modules 2.0«, ECPE, 2019
[9] Behrendt, S., Eisele, R.; New Thermal Designs of Power Modules with Inorganic Encapsulation; Workshop »Advanced Power Packaging – Power Modules 2.0«, ECPE, 2019
[10] Olesen, K.; Recent Advances in 2-phase Cooling of Power Electronics; Workshop »Advanced Power Packaging – Power Modules 2.0«, ECPE, 2019
[11] Bach, L., Zechun, Y.; Ceramic Embedding as Packaging Solution for Future Power Electronic Applications; Workshop »Advanced Power Packaging – Power Modules 2.0«, ECPE, 2019
[12] Gottwald, Th.; 60% Performance Increase by Power Mosfet Embedding; Workshop »Advanced Power Packaging – Power Modules 2.0«, ECPE, 2019
[13] Stoll, Th.; Additive Manufacturing for Power Electronics Substrate Technologies; Workshop »Advanced Power Packaging – Power Modules 2.0«, ECPE, 2019
- Leistungsmodule der Zukunft
- Kontaktierung der Chip-Oberseite
- Verguss und Wärmemanagement
- Einbetten von Leistungshalbleitern