Dreifache Durchbruchfeldstärke
SweGaN entdeckt neues Epitaxie-Verfahren für GaN auf SiC
Galliumnitrid auf Siliziumkarbid epitaktisch aufzuwachsen ist zwar nicht so komplex wie auf Silizium, aber trotzdem nicht trivial. Zufällig stellten Entwickler bei SweGaN fest, dass ihre GaN-on-SiC-Transistoren dreimal höhere Feldstärken verkraften, als erwartet. Nun wissen sie, warum.
Bei der Epitaxie kondensiert gasförmiges Galliumnitrid (GaN) auf einem Wafer aus Siliziumkarbid (SiC) und bildet eine dünne Schicht. Doch die Bindung der beiden Kristalloberflächen ist recht schlecht. An den Grenzflächen passen die Kristallstrukturen nicht richtig zueinander. Dies führt dazu, dass das Bauteil ausfällt. Die Forschung hat sich mit diesem Problem befasst und eine kommerzielle Lösung gefunden. Dabei wird eine dünne Schicht Aluminiumnitrid als Puffer zwischen die beiden Schichten eingebracht.
Doch per Zufall stellten die Entwickler bei SweGaN fest, dass ihre Transistoren deutlich höhere Feldstärken verkraften, als erwartet. Warum das so ist, konnten sie sich zunächst nicht erklären. Die Antwort fand sich auf der atomaren Ebene – in einigen kritischen Zwischenflächen im Inneren der Bauteile.
Jobangebote+ passend zum Thema
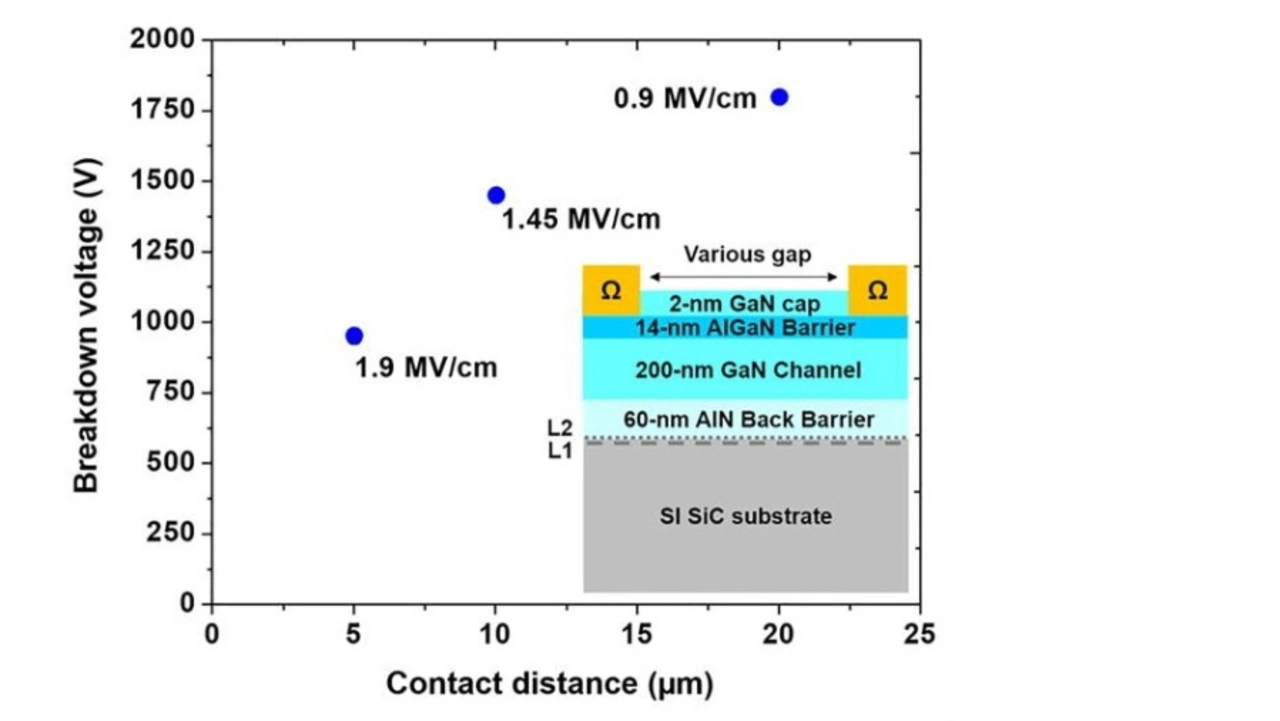
Transmorphes epitaktisches Wachstum
Forscher der Linköping University (LiU) und von SweGaN, geleitet von Lars Hultman und Jun Lu von der LiU, stellen in Applied Physics Letters eine Erklärung des Phänomens vor und beschreiben darin ein Verfahren, Transistoren mit noch höherer Spannungsfestigkeit herzustellen.
Die Wissenschaftler haben einen bislang unbekannten Mechanismus entdeckt, den sie »transmorphes epitaktisches Wachstum« nannten. Dabei wird die mechanische Spannung zwischen den verschiedenen Kristallen über mehrere Atomlagen hinweg allmählich absorbiert. Auf diese Weise können sie die beiden Schichten – Galliumnitrid und Aluminiumnitrid – auf Siliziumkarbid so aufwachsen, dass sie auf atomarer Ebene steuern können, wie die Schichten im Material zueinander angeordnet sind.
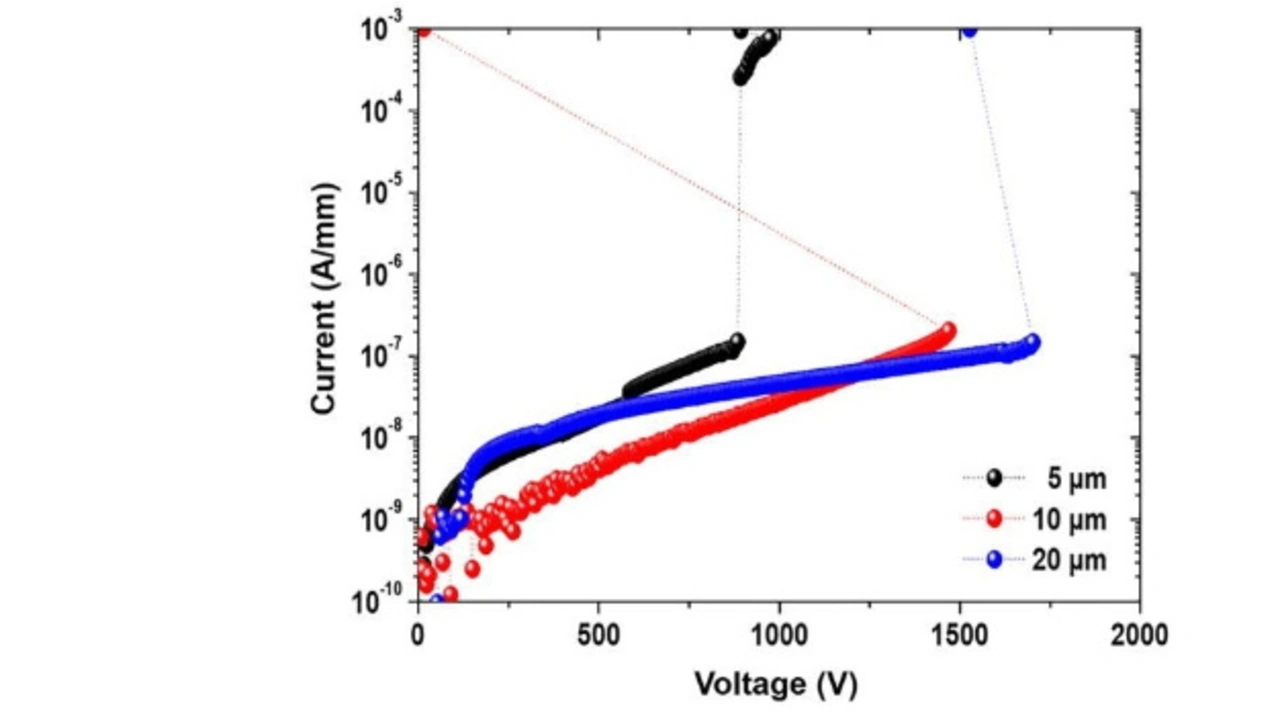
Dieser neue Wachstumsmechanismus verhindert, dass sich zu Beginn der Epitaxie keine Strukturdefekte bilden. Dadurch lassen sich korngrenzenfreie AlN-Nukleationsschichten und anschließend hochwertige pufferfreie GaN-Heterostrukturen auf SiC-Substraten züchten.
Bei der damit erzeugte GaN-HEMT-Heterostruktur mit einer Gesamtdicke von weniger als 300 nm auf einem halbisolierenden SiC-Substrat liegt die elektrische Durchbruchfeldstärke bei etwa 2 MV/cm, also fast dreimal höher als das von GaN-on-Si-Epiwafern mit einer konventionellen dicken Pufferlage (Buffer Layer). Die vertikale Durchbruchsspannung beträgt über 3 kV. Dies bedeutet, dass der Einschaltwiderstand des Bauteils nach der Baliga-Kennzahl um mehr als eine Größenordnung niedriger sein könnte als der heute erreichbare Wert.
Originalpublikation
Jun Lu, et al., Transmorphic Epitaxial Growth of AlN Nucleation Layers on SiC Substrates for High-Breakdown Thin GaN Transistors. Appl. Phys. Lett. 115, 221601 (2019). DOI: 10.1063/1.5123374