Dank Advanced Packaging und Chiplets
1000 Mrd. Transistoren auf einem Chip
Intel will in der zweiten Hälfte dieses Jahrzehnts die ersten Glassubstrate für die nächste Generation des Advanced Packaging einsetzen – und damit Moore´s Law bis weit ins nächste Jahrzehnt fortführen.
Im Vergleich zu den heutigen organischen Substraten bietet Glas mehrere Vorteile: Es lässt sich besonders flach und eben herstellen und es hat eine bessere thermische und mechanische Stabilität, was zu einer wesentlich höheren Verbindungsdichte in einem Substrat führt. Diese Vorteile werden es Chip-Designern ermöglichen, hochdichte und leistungsstarke ICs in einem Gehäuse zu integrieren, etwa für datenintensive Anwendungen wie KI. Intel will in der zweiten Hälfte dieses Jahrzehnts komplette Glassubstrate auf den Markt bringen, die es ermöglichen, die Integration entsprechend des Mooreschen Gesetzes über das Jahr 2030 hinaus weiter voranzutreiben.
Jobangebote+ passend zum Thema
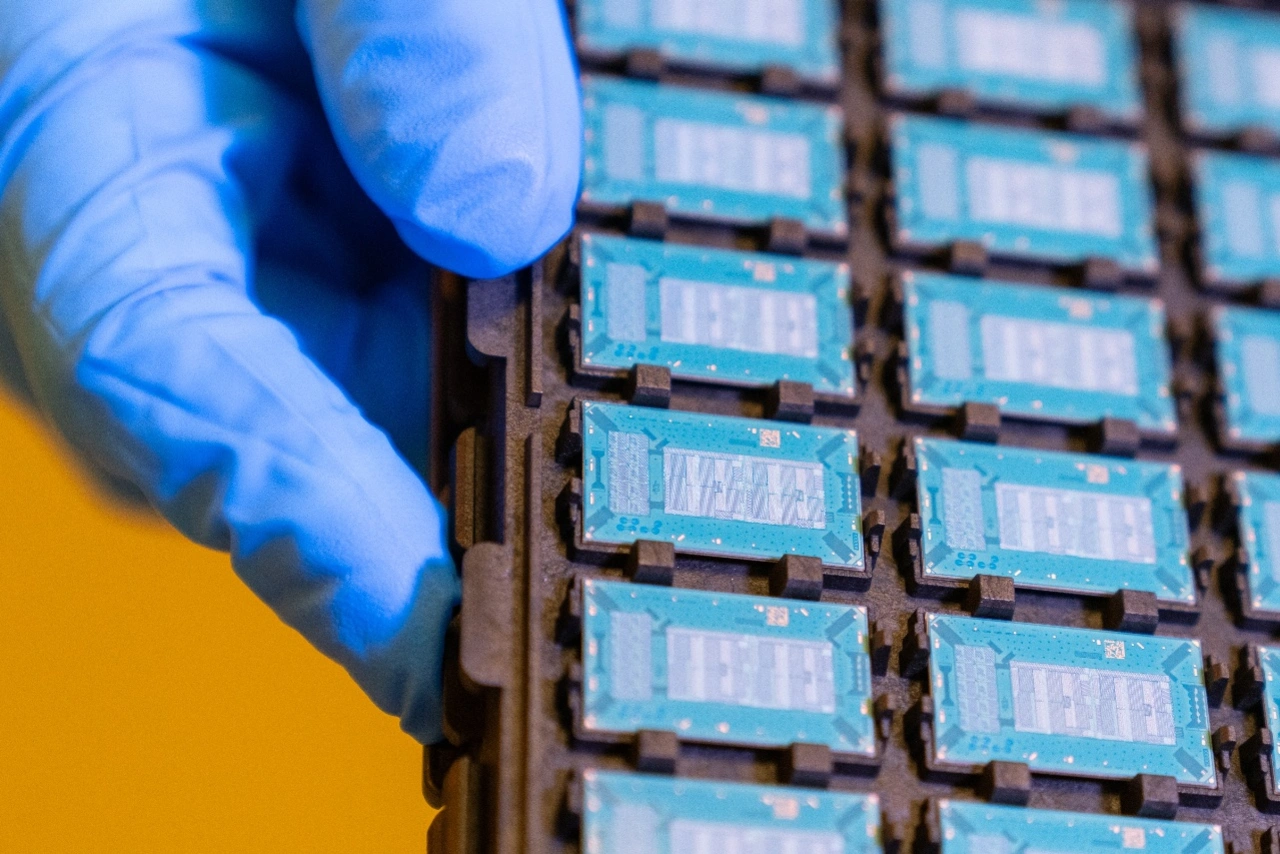
Bis zum Ende des Jahrzehnts wird sich die Zahl der Transistoren in einem Chip voraussichtlich nicht mehr erhöhen lassen, wenn organische Materialien als Basis für die Substrate verwendet werden. Deshalb sind die Glassubstrate der nächste entscheidende Schritt für die weitere Skalierung.
Komplexe Chips wie CPUs, GPUs und KI-Prozessoren bestehen heute aus mehreren ICs, sogenannten Chiplets, die in dem Chip integriert werden. Dazu sind Substrate erforderlich, über die die Chiplets ähnlich wie Chips über Leiterplatten verbunden sind. Die Substrate bestehen heute oft aus organischen Materialen.
Glassubstrate besitzen gegenüber organischen Materialien überlegene mechanische, physikalische und optische Eigenschaften: Sie können höhere Temperaturen vertragen, bieten 50 Prozent weniger Musterverzerrungen, sie sind extrem eben, was für die geringe Tiefenschärfe der Lithografie sehr vorteilhaft ist, und verfügen über die Dimensionsstabilität, die für eine extrem enge Schicht-zu-Schicht-Überlagerung von Verbindungen erforderlich ist. Deshalb ist auf ihnen eine 10-fache Erhöhung der Verbindungsdichte möglich. Darüber hinaus ermöglichen die verbesserten mechanischen Eigenschaften von Glas sehr große Gehäuse, die sich bei guter Ausbeute fertigen lassen.
Damit lassen sich größere Chiplet-Komplexe im Vergleich zu den organischen Substraten aufbauen. Mehr Chiplets passen auf eine kleinere Fläche, es lassen sich mehr von ihnen pro Chip unterbringen. Trotz der höheren Packungsdichte führt dies zu geringerer Leistungsaufnahme, höherer Flexibilität und zu niedrigeren Gesamtkosten.
Die Toleranz von Glassubstraten gegenüber höheren Temperaturen bietet den Chiparchitekten Flexibilität bei der Festlegung der Designregeln für die Stromversorgung und die Signalführung, weil sie in der Lage sind, optische Verbindungen nahtlos zu integrieren sowie Induktivitäten und Kondensatoren bei der Verarbeitung bei höheren Temperaturen in das Glas einzubetten. Dies ermöglicht bessere Stromversorgungen sowie schnellere Signale bei wesentlich geringerem Stromverbrauch. Diese zahlreichen Vorteile werden es voraussichtlich ermöglichen, bis 2030 rund 1000 Milliarden Transistoren in einem Chip unterzubringen.
Die Glassubstrate werden zunächst in großen Chips zur Anwendung kommen, wie CPUs, GPUs und KI-Prozessoren für Rechenzentren.