SiC – eine Bestandsaufnahme (Teil 2)
Bei SiC ist noch viel Luft nach oben
Silizium-Leistungshalbleiter sind weitestgehend ausgereift, was die Grenzen des Materials betrifft – ganz anders als solche aus Siliziumkarbid (SiC). Es folgt ein Überblick über die SiC-Technologie und ein Vergleich der heutigen SiC-MOSFETs und Silizium-IGBTs. SiC hat noch viel Luft nach oben.
Um Leistungshalbleiter zu bewerten, eignet sich ein Grenzwertdiagramm, bei dem der flächenspezifischer Durchlasswiderstand (nominaler Durchlasswiderstand × Chipgröße) gegen die Nennspannung aufgetragen ist. Dies zeigt Bild 1 für heute verfügbare SiC-MOSFETs verschiedener Hersteller aus den Spannungsklassen 650 V, 1200 V und 1700 V und einem breiten Spektrum von Strom/Widerstands-Klassen. Als Referenz dienen dieselben Parameter für eine Reihe von Silizium-MOSFETs sowie für zwei Silizium-IGBTs, wobei dabei der differentielle Einschaltwiderstand verwendet und die Diodenspannung ignoriert wird.
Jobangebote+ passend zum Thema
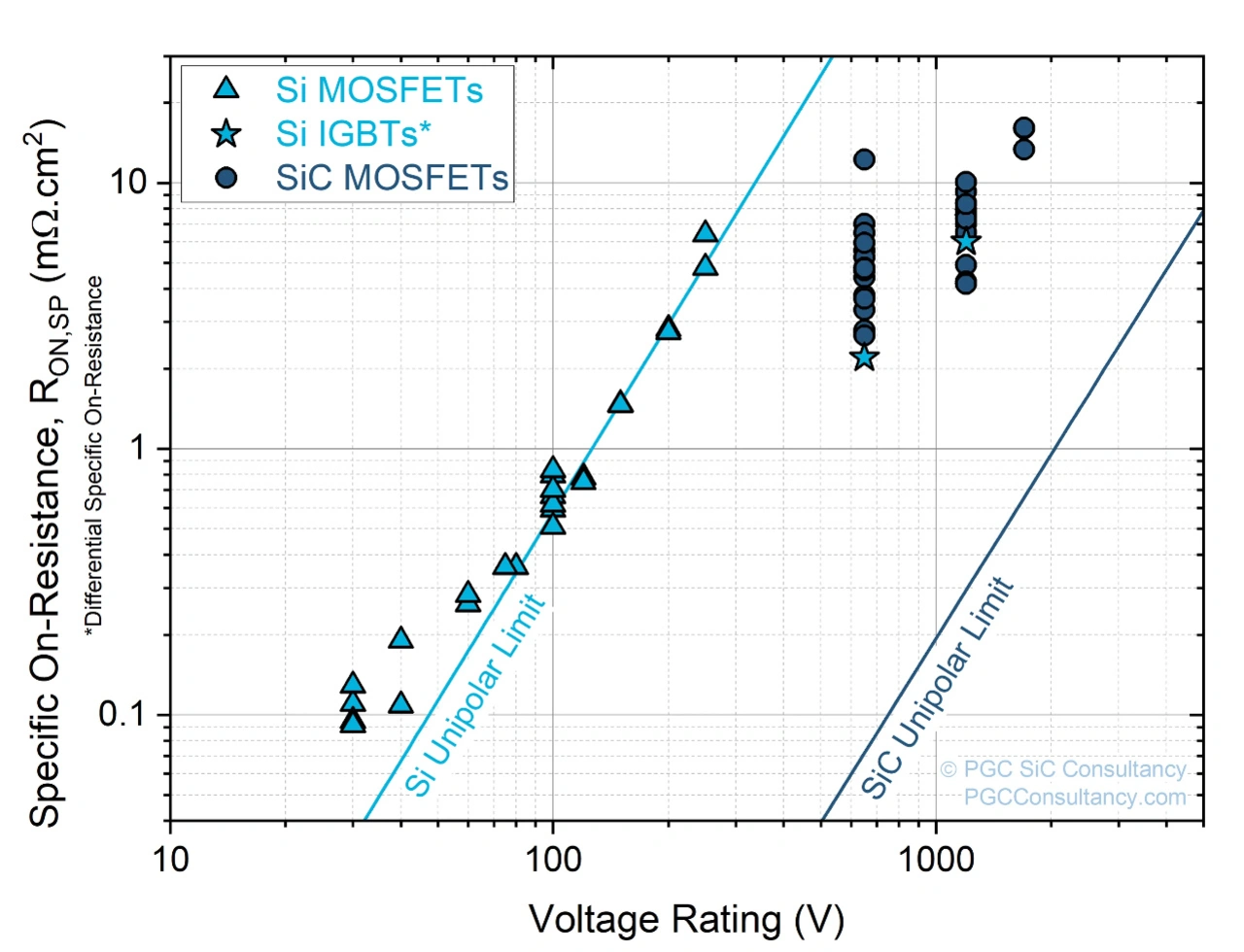
Außerdem sind in langen diagonalen Linien die Materialgrenzen dargestellt, also der niedrigste Widerstand, der bei Silizium oder Siliziumkarbid für eine bestimmte Nennspannung möglich ist. Diese als unipolare Werkstoffgrenze bezeichneten Werte ergeben sich aus der Tatsache, dass ein breiter, schwach dotierter Driftbereich erforderlich ist, um die hohe Spannung im ausgeschalteten Zustand aufzunehmen, während im eingeschalteten Zustand diese niedrige Dotierung dazu beiträgt, dass der Kanalwiderstand verhältnismäßig hoch ist. Dieser unvermeidliche Kompromiss bedeutet, dass mit jeder Verdoppelung der Durchbruchsspannung eines MOSFETs der Durchlasswiderstand um etwa das 4,5-Fache ansteigt.
Wichtig bei diesen Diagrammen ist, dass ein Bauelement trotzdem hervorragend sein kann, auch wenn es weit von der idealen unipolaren Grenze entfernt ist. Allerdings beansprucht es mehr Waferfläche als ein Bauelement, das sich an oder nahe dieser Grenze befindet, und wird daher wahrscheinlich mehr kosten. Aus der Sicht des Herstellers bedeutet dies, dass er die Zahl der Bauelemente mit einer bestimmten Kombination aus Sperrspannung und Strom pro Wafer maximieren und damit die Ausbeute maximieren kann, wenn das produzierte Bauelement nahe an der Unipolar-Grenze liegt.
Obwohl dieses Diagramm wenig darüber aussagt, wie schnell sich die Bauteile schalten lassen, wie hoch ihre thermische Belastbarkeit ist oder wie zuverlässig sie sind, zeigt es doch, wie nahe eine Bauteiltechnologie dem Optimum in Bezug auf Fertigung und Ertrag kommt.
Silizium-Bauelemente als Orientierungsrahmen
Bauelemente aus Silizium sind der natürliche Gradmesser für solche aus Siliziumkarbid und die ideale Startposition. Da die Materialqualität von Silizium über Jahrzehnte hinweg durch zahlreiche Generationen verbesserter Bauelemente perfektioniert wurde, steht dem Erreichen der idealen Technologiekurve fast nichts mehr im Wege. Die neuesten Silizium-MOSFETs, die für diese Arbeit analysiert wurden (Bild 1), sind so gut, dass sie auf oder sogar unter der unipolaren Grenze erscheinen, was vielleicht die Fehlertoleranz der Berechnung der unipolaren Grenze verdeutlicht. Erst unterhalb von 100 V werden die Materialgrenzen von Silizium-MOSFETs deutlich, da der Gesamtwiderstand des Bauelements von den festen Widerständen des Substrats, des JFET-Bereichs und des Kanals dominiert wird und nicht mehr vom skalierbaren Widerstand des Driftbereichs.
Ebenfalls in Bild 1 eingezeichnet sind zwei Beispiele für Silizium-IGBTs. Diese bipolaren Bauelemente verwenden nicht nur Majoritätsladungsträger (Elektronen), sondern auch Minoritätsladungsträger (Löcher), um den Driftbereich mit Ladungsträgern zu überfluten, um den Durchlasswiderstand zu senken. Dadurch erscheinen diese Bauelemente unterhalb der unipolaren Grenze von Silizium. Allerdings hat diese sogenannte Leitfähigkeitsmodulation ihren Preis: Die Injektion und Entfernung aller Minoritätsträger erfordert Zeit und bringt erhebliche Schaltverluste mit sich.
Wie gut ist Siliziumkarbid heute?
Im Folgenden gehen wir auf einige wichtige Erkenntnisse aus dem Spektrum der untersuchten SiC-Bauelemente ein.
Betrachtet man die erfassten Bauteile, so zeigt sich, dass die Parameter innerhalb der einzelnen Spannungsklassen erheblich streuen. Was jedoch die Bauteile mit dem jeweils niedrigsten Widerstand eint, ist zum einen, dass sie die höchsten Stromwerte aufweisen. Es handelt sich also um große Chips mit großen aktiven Flächen, sodass ein geringerer Anteil des Chips auf nicht stromführende Bereiche entfällt, beispielsweise auf das Gate-Pad und die Anschlussbereiche.
Zum anderen stammen die Bausteine mit dem niedrigsten Widerstand von demselben Hersteller, dessen Produkte durchweg den niedrigsten spezifischen Widerstand und die kleinsten Chipgrößen aufweisen. In der Tat gibt es eine erhebliche Streuung zwischen den Herstellern, die zum Teil diejenigen begünstigt, die erst vor kurzem neue Produkte auf den Markt gebracht haben. Es gibt jedoch einen eindeutigen Trend, der darauf hindeutet, dass einige Hersteller ihre Produkte überdimensionieren (Derating), indem sie diese für viel höhere Spannungen und Ströme auslegen, als im Datenblatt angegeben sind.
Insbesondere bei 650 V Sperrspannung sind die SiC-MOSFETs noch weit von ihrer unipolaren Grenze entfernt. Ihr Durchlasswiderstand ist in der Tat so hoch, dass die heutigen 650-V- Trench-Gated-Field-Stop-IGBTs sogar etwas geringere Durchlassverluste aufweisen. Trotzdem bedeutet allein die Tatsache, dass der Widerstand der unipolaren SiC-Bauelemente in der gleichen Größenordnung liegt wie der eines bipolaren, leitwertmodulierten Silizium-IGBTs, dass der relativ geringe Anstieg der Durchlassverluste durch die großen Schaltverluste der IGBTs in den Schatten gestellt wird, wenn beide Bauelemente bei einer praxisnahen Schaltfrequenz arbeiten.
Dadurch kann die SiC-Lösung schneller und mit höherem Wirkungsgrad arbeiten. Tesla hat dies beim Wechselrichter des Model 3 von 2018 demonstriert [1]. Dieser soll nur knapp 40 Prozent des Gewichts des Wechselrichters im Nissan Leaf haben, obwohl seine elektrische Leistung mehr als doppelt so hoch ist. Dank der höheren Effizienz lässt sich die Anzahl der teuren und schweren Batterien im Fahrzeug verringern, wodurch sich die Kosten für die kleinen, aber teuren SiC-Komponenten amortisieren.
Sweetspot von SiC bei 1200 V
Auch wenn sich Siliziumkarbid im 650-V-Bereich bewährt hat, 1200-V-Bauteile sind viel näher am Sweetspot des Materials. Dort haben SiC-MOSFETs einen flächenbezogenen Widerstand, der näher an der unipolaren Grenze des Materials liegt. Bei 1200 V liegt dieser Wert »nur« 14- bis 33-mal darüber, bei 650 V aber bei 35- bis 90-mal. Der Grund dafür ist, dass bei 650 V die festen Widerstände von Kanal und Substrat dominieren und nicht nur der variable Anteil des Driftbereichs, der für die Berechnung der unipolaren Grenze maßgebend ist.
Ein Vergleich von SiC-MOSFETs mit 650 V und 1200 V gegenüber Silizium-IGBTs mit gleicher Spannung und gleichem Nennstrom verdeutlicht die Vorteile. In der Tabelle 1 zeigt sich, dass ein SiC-MOSFET mit 650 V im Vergleich zu einem Silizium-IGBT mit 650 V eine doppelt so hohe Leistungsdichte und 6,5-mal geringere Schaltverluste aufweist. Diese Werte steigen jedoch bei höheren Spannungen sprunghaft an. Ein SiC-Bauelement mit 1200 V, das einen Silizium-IGBT mit 1200 V ersetzen soll, hat eine 16-mal höhere Leistungsdichte und 11-mal geringere Schaltverluste.
| Parameter | SiC-MOSFET zu IGBT bei 650 V | SiC-MOSFET zu IGBT bei 1200 V |
|---|---|---|
| Chipfläche | 5x kleiner | 5x kleiner |
| Leistungsdichte | 2x höher | 16x höher |
| Schaltverluste | 6,5x kleiner | 11x kleiner |
| Schaltzeit | 1,5x schneller | 7x schneller |
| Preis | 3x höher | 3,5x größer |
Tabelle 1: Relativer Vergleiche zwischen SiC-MOSFETs und gleichwertigen Silizium-IGBTs
SiC als Schlüsselelement für Elektrofahrzeuge
Der Trend, die Batteriespannung bei Elektrofahrzeugen von 400 V auf 800 V zu verdoppeln, hat eine Reihe von Vorteilen, denn bei gegebener Leistung führt dies dazu, dass sich der Strom halbiert. Dadurch lassen sich die Batterien schneller aufladen [2], da sie sich weniger stark erwärmen, die Antriebsmotoren sind kleiner und leichter, da weniger Kupferwicklungen benötigt werden, und die Kabel, über die der Strom fließen muss, sind leichter. Dies wirkt sich stark auf den Gesamtwirkungsgrad des Systems aus, vergrößert die Reichweite oder verringert das Gewicht der Batterie und senkt die Systemkosten.
Daher wird Siliziumkarbid eine Schlüsselrolle dabei spielen, das Potenzial von 800-V-Designs zu maximieren. Bei 1200 V fängt die SiC-Technologie nämlich erst an, ihre Vorteile auszuspielen. Es bleiben allein Bedenken hinsichtlich der Zuverlässigkeit, des Designs und/oder konservativer Anwendungsbereiche als Gründe dafür, bei den Silizium-IGBTs zu bleiben. Daher stellt sich beim aktuellen Porsche Taycan die Frage, warum sich die Entwickler trotz des Übergangs zu 800 V für eine Lösung mit Silizium-IGBTs entschieden haben, während man sich beim Lucid Air mit 900 V für SiC-MOSFETs entschieden hat.
Zusammenfassend lässt sich sagen, dass die Siliziumtechnologie weitestgehend ausgereift ist, mit MOSFETs an der Grenze des technisch Machbaren und einer hoch entwickelten IGBT-Technologie. Im Gegensatz dazu ist die SiC-Technologie noch sehr jung, aber nach nur einem Jahrzehnt und etwa drei Bauteilgenerationen sind die SiC-MOSFETs den Silizium-IGBTs deutlich überlegen. Die Daten belegen: Auch wenn Siliziumkarbid bei 650 V gut ist, bei 1200 V und darüber wird es ständig besser.
Referenzen
[1] L. Gear, Tesla's Innovative Power Electronics: The Silicon Carbide Inverter, IDTechEx (Aufgerufen am 14.09.2022)
[2] D. Jolley, Shifting to 800-volt systems: Why boosting motor power could be the key to better electric cars, Drivemode (Aufgerufen am 14.09.2022)