Galliumnitrid: Schnell und mit Potenzial
Licht aus dem Schatten des Siliziums
Fortsetzung des Artikels von Teil 1
Warum Galliumnitrid?
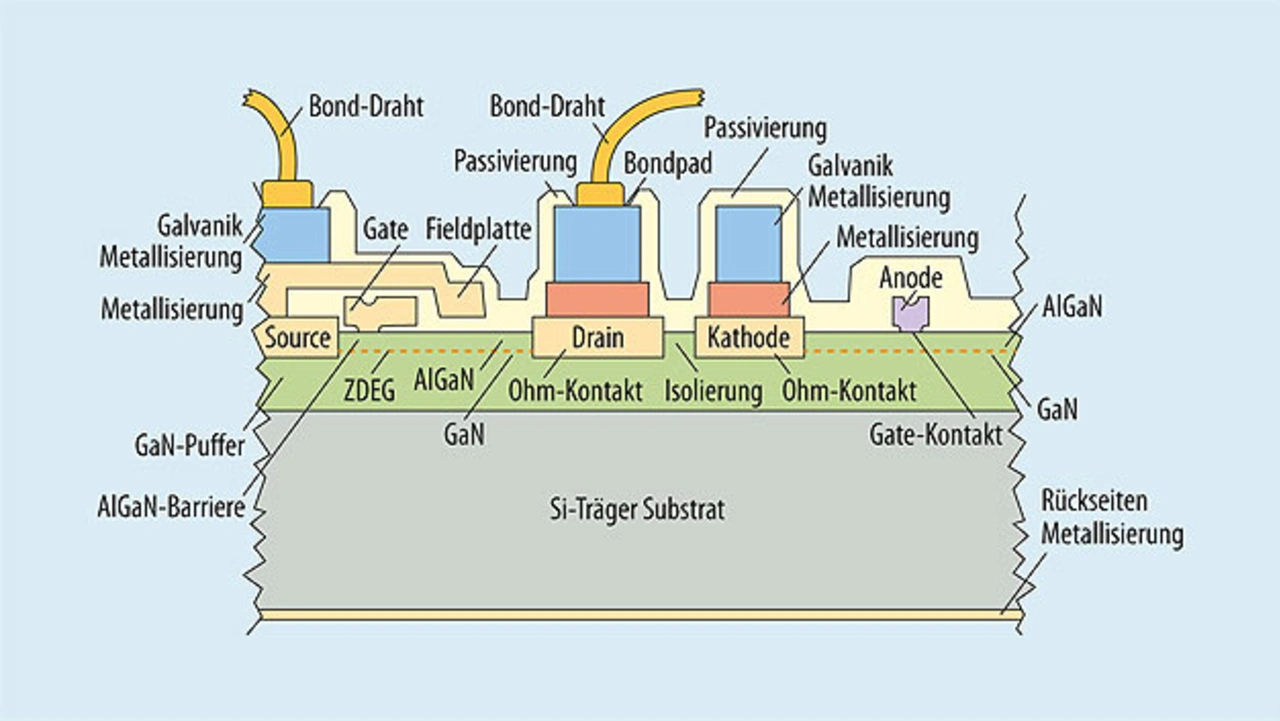
Die Vorteile von Galliumnitrid liegen in einer sehr großen Bandlücke des Materials von 3,42 eV in Kombination mit ausgezeichneten Transporteigenschaften im Kanal des als Schalter arbeitenden Feldeffekttransistors mit Beweglichkeiten wie beim Silizium. Grundlegend ist weiterhin die Fähigkeit, neben dem GaN auch Heterostrukturen unter Verwendung von Aluminium wachsen zu können, so dass sich – ungewöhnlich für die Leistungselektronik – laterale AlGaN/GaN-Schalter-Bauelemente ergeben. Bild 1 zeigt die Struktur eines lateralen Leistungstransistors sowie laterale, abgeleitete Heterostruktur-GaN-Schottky-Dioden.
Jobangebote+ passend zum Thema
Ein vermeintlicher Nachteil ergibt sich für GaN zunächst aus der Tatsache, dass es bislang keine Volumenkristalle von ausreichendem Durchmesser größer 2 Zoll gibt, auf denen Epitaxie und Leistungselektronik-Technologien erfolgen können. Das Wachstum von GaN auf GaN-Substraten reduziert sich daher bislang auf experimentelle Versuche in der Forschung.
Interessant für kommerzielle Anwendungen ist jedoch die Möglichkeit, GaN auf Silizium in der 111-Orientierung zu wachsen. Das ist nicht die Orientierung der CMOS-Technologie, jedoch ermöglicht sie die Anwendung von Si-basierten Technologieansätzen. Die Fehlanpassung der Gitterkonstanten von AlGaN und GaN zu Silizium ist dabei beträchtlich und erfordert starke Anstrengungen für ein qualitativ hochwertiges Wachstum. Die Fähigkeit, unter Verwendung des Elements Aluminium dabei AlGaN/GaN-Heterostrukturen zu wachsen, erlaubt eine besonders gute Kontrolle eines Feldeffekttransistor-Kanals, in dem der Strom geführt wird.
Die Herstellung
Das Wachstum der GaN-Schichten auf dem Silizium-Träger muss zunächst durch geeignete Anwachsbedingungen ermöglicht werden. Eine Pufferschicht sorgt für den Ausgleich der Gitterkonstanten von (Al)GaN auf Si, um die massive Fehlanpassung von 18 % auszugleichen.
Wie gesagt, beruhen GaN-Transistoren im Unterschied zu den konventionellen vertikalen Transistortechnologien wie Power-MOSFETs oder IGBTs auf einer lateralen HEMT- (High-Electron-Mobility-Transistor) Technologie. Das bedeutet: Der Durchlassstrom fließt nicht wie bei vertikalen Bauelementen durch das Bulk-Material, sondern lateral entlang der AlGaN/GaN-Grenzfläche nahe der Chip-Oberfläche. Damit sind alle Anschlüsse (Drain, Gate und Source) auf der Chip-Oberseite und können über Leiterbahnen verdrahtet werden.
Neu, aber auch nicht über die Maßen ungewöhnlich ist die Dotierung von GaN-Bauelementen. Diese erfolgt nicht wie sonst üblich durch Dotierprofile, sondern durch Polarisationsdotierung. Die AlGaN-Barriere hat gegenüber GaN eine leicht veränderte Gitterkonstante, was sowohl zu spontaner als auch zu piezoelektrischer Polarisation an der Grenzfläche zwischen den Materialien führt. Dadurch werden Ladungsträger von der Oberfläche des Bauelements in den sich ausbildenden Kanal an der Grenzfläche zwischen AlGaN und GaN gezogen.
- Licht aus dem Schatten des Siliziums
- Warum Galliumnitrid?
- Die Herausforderungen
- Das etwas andere Rückwärtsverhalten
- Monolitisch integrierte Leistungsschaltkreise
- Literatur