Fraunhofer IAF
Galliumnitrid-Schaltungen monolithisch integriert
Fortsetzung des Artikels von Teil 1
GaN-HEMT mit integrierter Freilaufdiode
GaN-Transistoren haben keine Body-Diode im Rückwärtsbetrieb wie Silizium-Power-MOSFETs, wo diese technologiebedingt inhärent vorhanden ist. Jedoch benötigen die meisten Schaltwandler-Topologien so eine antiparallele Diode. Doch auch bei GaN-Transistoren gibt es ein nutzbares Rückwärtsverhalten.
Vereinfacht kann man einen GaN-Transistor bei kleineren Spannungen als bidirektionales Bauelement ansehen. Damit gilt die Gate-Schwellspannung nicht nur zwischen Gate und Source, sondern auch zwischen Gate und Drain. Das heißt, auch wenn die Gate-Drain-Spannung größer wird als die Gate-Schwellspannung, wird das Bauelement leitend. Bei negativen Drain-Source Spannungen lässt sich dieser Zustand leicht erreichen.
Jobangebote+ passend zum Thema
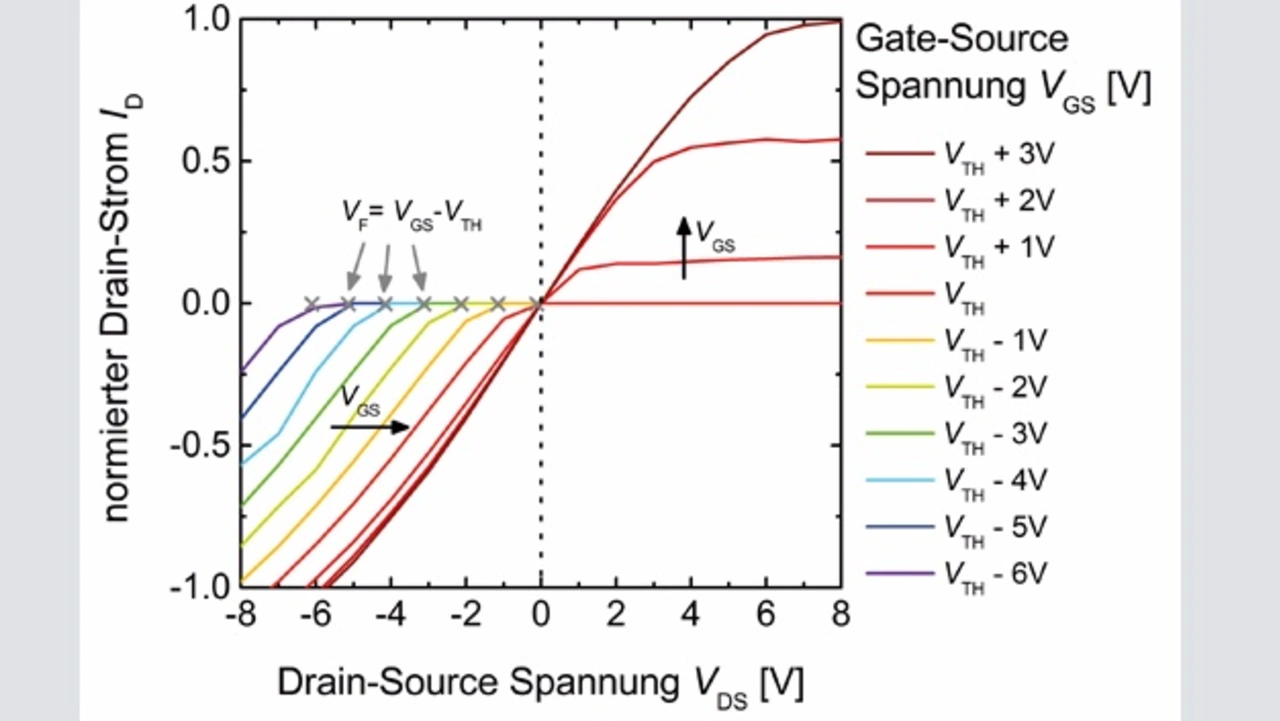
Das Rückwärtsverhalten im dritten Quadranten der Ausgangskennlinie ähnelt dann einer Freilaufdiode, wobei die Vorwärtsspannung dieser Diode von der Gate-Source-Spannung abhängig ist (Bild 3). Die Vorwärtsspannung dieser Quasi-Freilaufdiode errechnet sich aus UF = UGS – Uth. Im Durchlassbetrieb, wenn die Gate-Source-Spannung größer als die Schwellspannung Uth ist, ist der Transistor ohnehin offen, sowohl im Vorwärts- als auch im Rückwärtsbetrieb. Üblicherweise erfolgt aber die Rückleitung aus dem Sperrbetrieb zum Beispiel als Freilauf bei einer induktiven Last. Das heißt die Gate-Source-Spannung ist kleiner als die Schwellspannung und der Transistor schaltet in einen verlustbehafteten Rückwärtsbetrieb. Er zeigt dabei ein Diodenverhalten mit hoher Vorwärtsspannung. In der HEMT-Struktur entstehen die Verluste dabei lokal am Gate-Kontakt. Dies kann das Bauelement im Dauerbetrieb zerstören oder die Zuverlässigkeit reduzieren. Dies lässt sich auf unterschiedliche Weise verhindern:
- Zuschalten einer schnellen Freilaufdiode. Allerdings entstehen durch weitere Verbindungen weitere parasitäre Effekte und das zusätzliche Leistungsbauelement verursacht Kosten.
- Betrieb des Bauelements ohne zusätzliche Freilaufdiode. Während des verlustbehafteten Rückwärtsbetriebs schaltet man das Bauelement mit einer Gate-Source-Spannung über der Schwellspannung in den Durchlassbetrieb. Das ist jedoch bei schnell schaltenden Anwendungen sehr aufwendig und erfordert präzises Timing.
- Verwendung einer HEMT-Struktur mit integrierter Freilaufdiode (Bild 4). Diese Struktur lässt sich schon heute ohne größere Produktionskosten, Flächenaufwand und Verluste realisieren. Solche GaN-Transistoren mit integrierter Diode sind derzeit allerdings noch nicht am Markt.

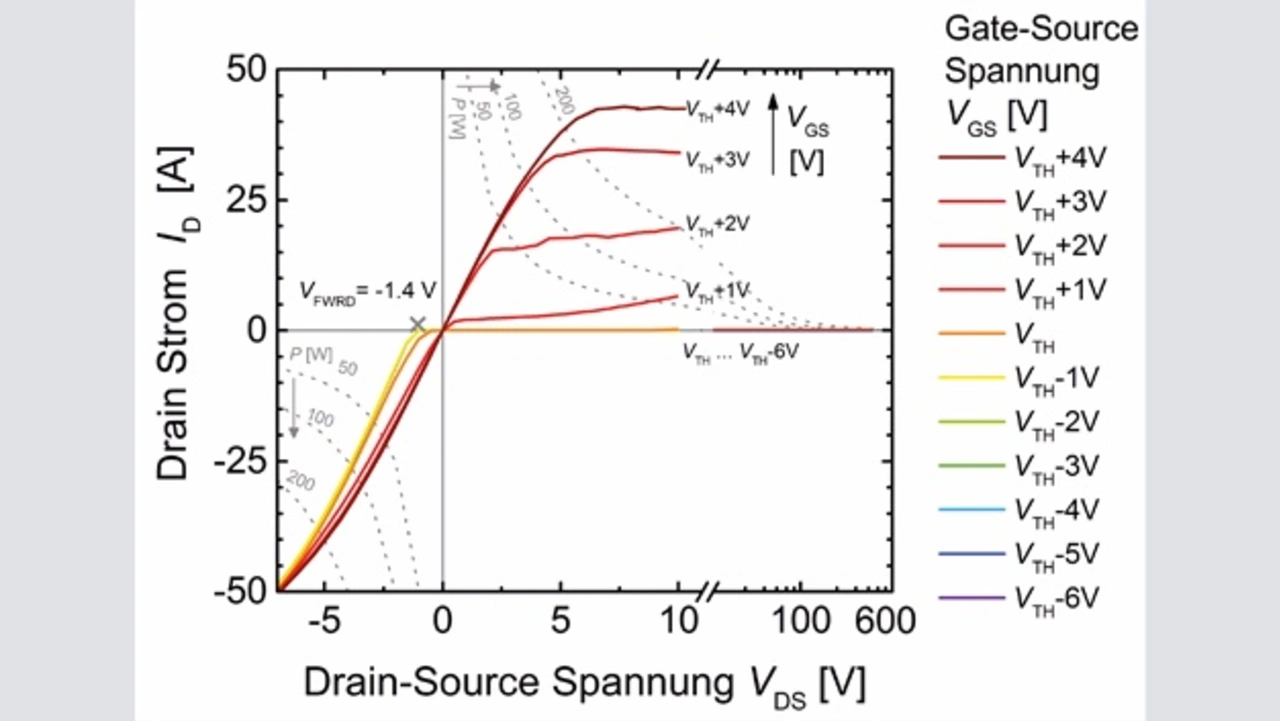
Trotz der Besonderheiten ist der Rückwärtsbetrieb von GaN-Transistoren äußerst attraktiv. Denn im Vergleich zu Si-MOSFETs benötigen GaN-HEMTs eine nur sehr kleine Ladungsmenge QRR (Reverse Recovery Charge), um die Rückleitung aus dem Sperrbetrieb zu ermöglichen und umgekehrt (Bild 5). Damit hat ein GaN-Transistor sehr kleine Schaltverluste zwischen Sperrbetrieb und Rückleitung.
Analog zum Vorwärtsbetrieb kann man auch für den Rückwärtsbetrieb das Produkt aus dem Durchlasswiderstand und der Schaltladung als Leistungskennzahl nutzen. Das Produkt RON,RVS ∙ QRR besteht in diesem Fall aus dem Durchlasswiderstand im Rückwärtsbetrieb und der Ladungsmenge, die für den Schaltvorgang nötig ist. Ein Vergleich unterschiedlicher Freilaufdioden zeigt Bild 6, wo der Verlustfaktor RON,RVS ∙ QRR sowohl von Body-Dioden als auch von Einzeldioden dargestellt ist. Im Vergleich zu Si-Bauelementen erreichen GaN- und SiC-Chips deutlich kleinere Werte. Die Unterschiede sind bemerkenswert. In der 600-V-Klasse erzielen GaN und SiC 500 bis zu 1000-mal niedrigere Werte im Vergleich zu den Si-Body-Dioden von Leistungs-MOSFETs und bis zu 10-mal niedrigere Werte im Vergleich zu Si-Schottky-Dioden.
Wegen dieser enorm kleinen Schaltladungsmengen sprechen sogar manche von einer »Zero Recovery Ladung«. Doch auch bei einem GaN-Schalter ist immer eine gewisse Menge an Ladung nötig, um den Kanal zu öffnen oder zu sperren. Der neu entwickelte GaN-Transistor mit integrierter Freilaufdiode erreicht somit sehr kleine Werte, vergleichbar mit den GaN-Schottky-Dioden und den SiC-Komponenten. Die enorm kleinen Ladungen, die zum Schalten nötig sind, könnten völlig neue Anwendungen in Schaltwandern ermöglichen, gerade auch in Topologien, bei denen das Freilaufverhalten von großer Bedeutung ist.
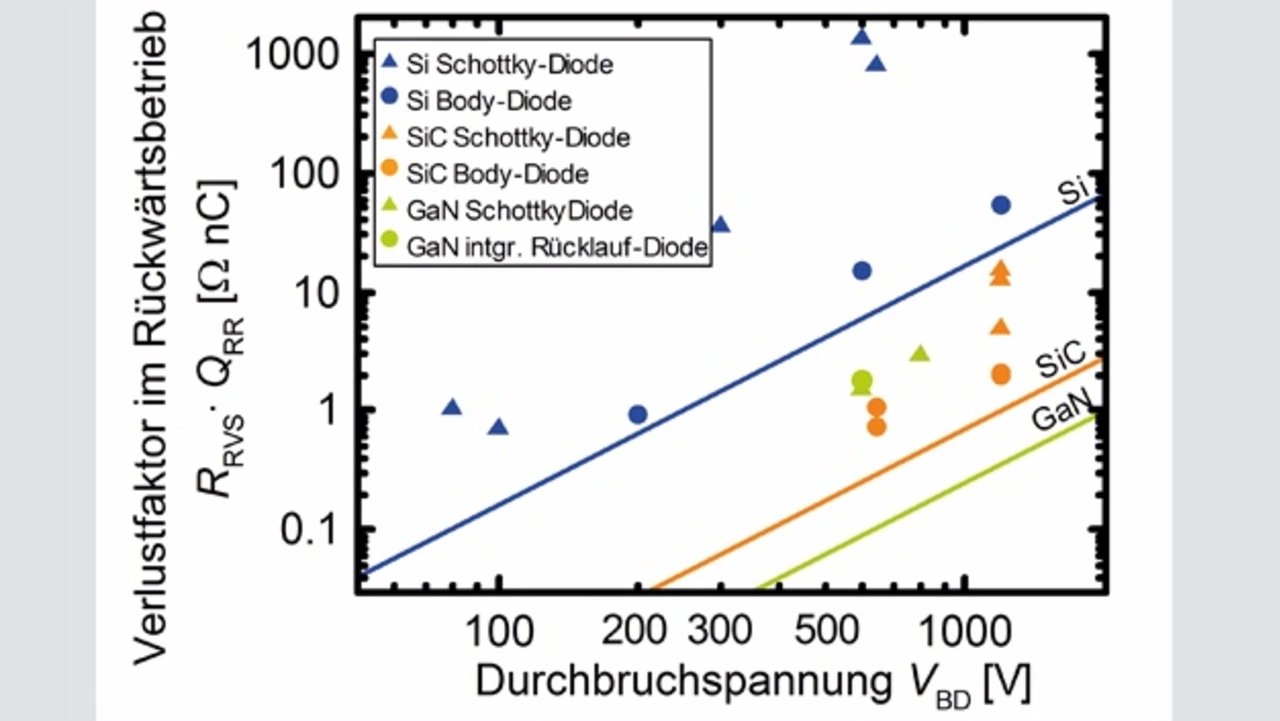
- Galliumnitrid-Schaltungen monolithisch integriert
- GaN-HEMT mit integrierter Freilaufdiode
- Monolithisch integrierte Halbbrücke und Sensoren