GaN-FETs für Schaltnetzteile
Durchstarten dank großer Bandlücke
Von Elektrofahrzeugen bis hin zu Industrieinfrastrukturen: Eine höhere Effizienz und höhere Leistungsdichten erfordern eine Abkehr von klassischen Silizium-Strukturen. GaN-FETs bieten mit höheren Betriebsspannungen, kürzeren Schaltzeiten und höheren Wirkungsgraden einen Weg in die Zukunft.
Angesichts gesellschaftlicher und gesetzlicher Anforderungen ist Energieeffizienz eine Priorität für elektronische Systeme. Bei vielen Anwendungen, von Elektrofahrzeugen bis hin zu Hochspannungs- und industrieller Infrastruktur, sind Effizienz und Leistungsdichte der Energieumwandlung entscheidend für den Erfolg des Designs.
Um diesen Anforderungen gerecht zu werden, müssen die Entwickler von Schaltnetzteilen von den klassischen auf Silizium basierten Metalloxid-Feldeffekttransistoren (MOSFETs) und Bipolartransistoren mit isoliertem Gate (IGBTs) abrücken, da diese schnell an ihre theoretischen Grenzen stoßen.
Stattdessen sollten die Entwickler Bauelemente in Betracht ziehen, die auf Materialien mit großer Bandlücke (Wide Bandgap, WBG) wie Galliumnitrid (GaN) basieren. GaN-Bauelemente schalten schneller als Si-Bauelemente, können höhere Spannungs- und Leistungspegel verarbeiten, sind bei einem gegebenen Leistungspegel viel kleiner und arbeiten mit einem viel höheren Wirkungsgrad.
Grundlagen der GaN-FETs
Hochspannungs-Halbleiterschalter sind grundlegende Elemente in Stromwandlerschaltungen. Deren Entwickler haben sich darauf konzentriert, die Leistung dieser Bauelemente durch folgende Maßnahmen zu verbessern:
➔ Verringerung der Leitungsverluste durch Reduzierung des Serienwiderstands im eingeschalteten Zustand
➔ Verringerung der Schaltverluste durch Erhöhung der Übergangsgeschwindigkeiten
➔ Reduzierung parasitärer Effekte
Diese Entwicklungsbemühungen waren im Allgemeinen bei Silizium-MOSFETs und IGBTs erfolgreich, aber die Verbesserungsrate hat sich verlangsamt, da der Betrieb dieser Bauelemente ihre theoretischen Grenzen erreicht.
Infolgedessen wurden in den vergangenen Jahren WBG-Bauelemente aus SiC (Siliziumcarbid) und GaN eingeführt, die inzwischen in Serie produziert werden. Diese Komponenten bieten höhere Betriebsspannungsbereiche, kürzere Schaltzeiten und einen höheren Wirkungsgrad.
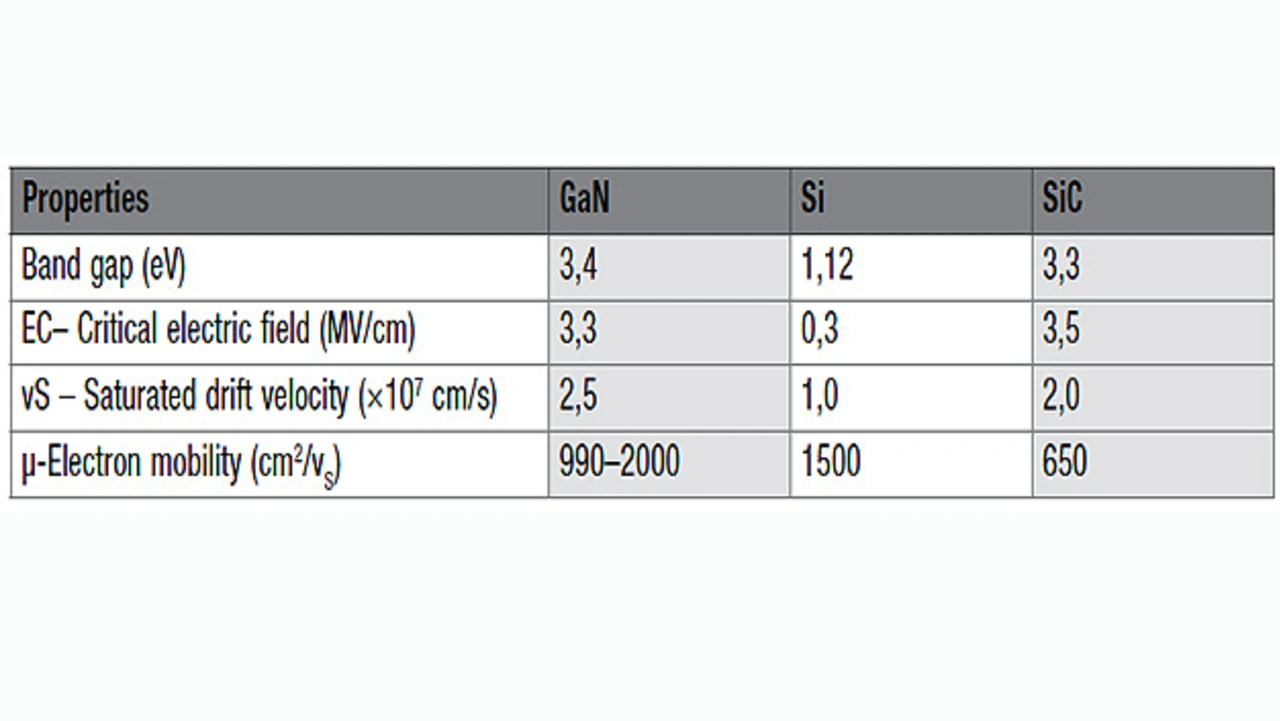
Mit dem Terminus Bandlücke wird bei Halbleitern die Mindestenergie beschrieben, die erforderlich ist, um Elektronen anzuregen, damit sie aus ihrem gebundenen Zustand in einen freien Zustand übergehen und Strom leiten (Tabelle). Bauelemente, die mit Halbleitern mit breiter Bandlücke hergestellt werden, können bei viel höheren Spannungen, Frequenzen und Temperaturen arbeiten als Bauelemente mit herkömmlichen Halbleitermaterialien wie Si.
Ihre hohe Temperaturtoleranz bedeutet, dass sich diese Komponenten unter normalen Bedingungen mit viel höherer Leistung betreiben lassen. WBG-Halbleiter mit einem höheren kritischen elektrischen Feld und höherer Mobilität haben zudem einen niedrigeren Drain-Source-Durchlasswiderstand (RDS(ON)), was die Leitungsverluste verringert. Und nicht zuletzt zeichnen sich Materialien mit breiter Bandlücke meist auch durch eine hohe Geschwindigkeit der freien Elektronen aus, wodurch sie mit höheren Schaltgeschwindigkeiten arbeiten können.
Im Vergleich zu Si, das eine Bandlücke von 1,12 eV aufweist, sind GaN und SiC Verbundhalbleiter, deren Bandlücke mit 3,4 eV beziehungsweise 3,3 eV etwa dreimal so groß ist. Damit können beide höhere Spannungen und höhere Frequenzen unterstützen.
Durch seine höhere Elektronenbeweglichkeit ist GaN viel geeigneter für Hochfrequenzanwendungen mit hoher Performance. Höhere Schaltgeschwindigkeiten und höhere Betriebsfrequenzen, die durch GaN-Leistungs-FETs ermöglicht werden, führen zu einer verbesserten Signalsteuerung, zu passiven Filterdesigns mit höheren Grenzfrequenzen und zu niedrigeren Brummströmen. Dies ermöglicht die Verwendung kleinerer Induktivitäten, Kondensatoren und Transformatoren, was zu einer Verringerung der Gesamtgröße und des Gewichts führt.
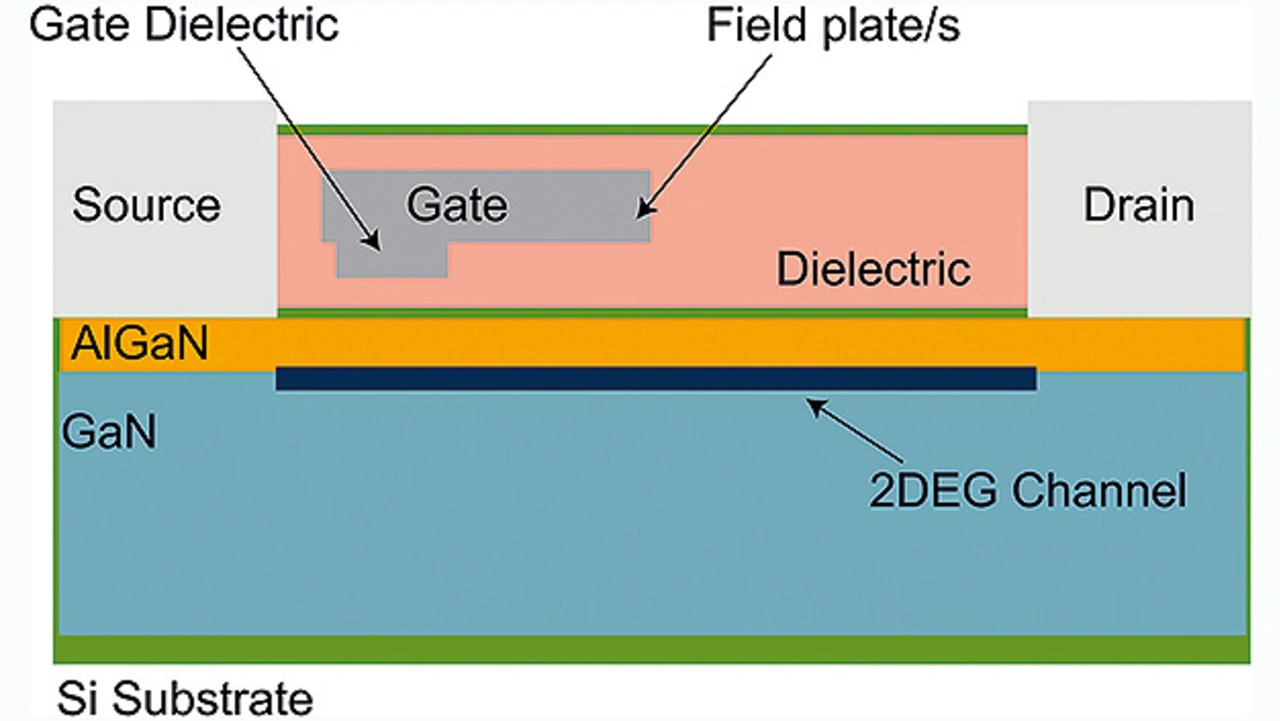
GaN-FETs werden als Transistoren mit hoher Elektronenbeweglichkeit (HEMT) bezeichnet. Ihre hohe Elektronenbeweglichkeit ist eine Funktion der FET-Struktur. GaN-FETs nutzen bestehende Silizium-CMOS-Produktionsanlagen, was sie kostengünstig macht. Auf dem Si-Substrat wird eine GaN-Schicht gebildet (Bild 1), indem eine Keimschicht und eine abgestufte Schicht aus GaN und Aluminiumgalliumnitrid (AlGaN) als Isolationsschicht (im Diagramm nicht dargestellt) abgeschieden werden, bevor die reine GaN-Schicht wächst. Eine zweite AlGaN-Schicht wird auf der GaN-Schicht abgeschieden. Dadurch entsteht eine piezoelektrische Polarisation, wobei unmittelbar unter dem AlGaN ein hochleitender Kanal mit einem Überschuss an Elektronen erzeugt wird. Dieser Überschuss an Elektronen wird als zweidimensionales Elektronengas (2DEG) bezeichnet. Der Name spiegelt die sehr hohe Elektronenbeweglichkeit in dieser Schicht wider. Unter dem Gate bildet sich eine Verarmungszone. In seiner Funktionsweise ähnelt das Gate einem N-Kanal-Silizium-MOSFET im Anreicherungsmodus. Eine positive Spannung, die an das Gate dieses Bauelements angelegt wird, schaltet es ein.
Diese Struktur wird mehrfach wiederholt, um eine leistungsstarke Komponente zu bilden. Im Ergebnis wird so ein grundsätzlich einfacher, eleganter und kostengünstiger Ansatz für die Leistungsschaltung erreicht.
Um ein Bauteil mit höherer Spannung zu erhalten, wird der Abstand zwischen Drain und Gate vergrößert. Da der spezifische Widerstand von GaN-2DEG sehr niedrig ist, ist die Auswirkung auf den Widerstand durch die Erhöhung der Sperrspannungsfähigkeit im Vergleich zu Silizium-Bauelementen viel geringer.
GaN-FETs lassen sich so konstruieren, dass sie in einer von zwei Konfigurationen arbeiten: im Anreicherungsmodus oder im Verarmungsmodus. FETs mit Anreicherungsmodus sind normalerweise ausgeschaltet, sodass eine positive Spannung relativ zu Drain/Source an das Gate angelegt werden muss, um den FET einzuschalten. FETs mit Verarmungsmodus sind normalerweise eingeschaltet, sodass eine negative Gate-Spannung relativ zum Drain/Source angelegt werden muss, um den FET auszuschalten. FETs mit Verarmungsmodus sind in einem Stromversorgungssystem problematisch, da vor dem Einschalten des Systems eine negative Vorspannung an den GaN-Verarmungs-FET angelegt werden muss.
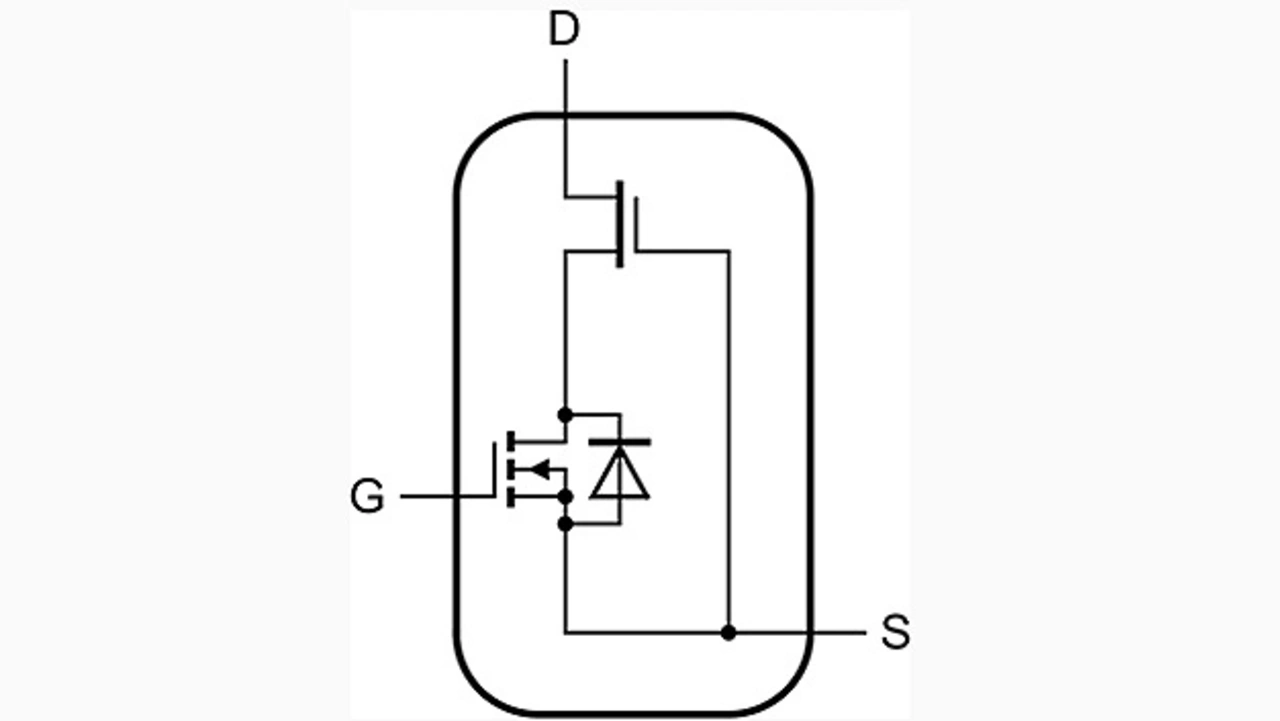
Eine Möglichkeit, dieses Problem zu umgehen, besteht darin, einen Niederspannungs-Silizium-FET mit einem GaN-FET im Verarmungsmodus in einer Kaskodenschaltung zu kombinieren, wie in Bild 2 dargestellt.
Diese Kaskodenschaltung verwendet eine Si-MOSFET-Gate-Struktur, die den Vorteil hat, dass die Gate-Ansteuerungsgrenzen höher sind als bei bestehenden MOSFET-Gate-Treiber-ICs und dass der GaN-FET im Verarmungsmodus beim Einschalten ausgeschaltet ist.
Eine der wichtigsten Eigenschaften von GaN-FETs ist ihr hoher Wirkungsgrad. Zu den Gründen dafür zählen ein geringer Serienwiderstand, der die Leitungsverluste senkt, schnellere Schaltzeiten, die die Schaltverluste verringern, und eine geringere Rückspeiseleistung, die für die niedrigen Rückspeiseverluste verantwortlich ist.

Unter Verwendung einer gemeinsamen Halbbrücken-Aufwärtswandlertopologie ist es möglich, die Wirkungsgrade von GaN-FETs und Si-MOSFETs zu vergleichen (Bild 3). Der Aufwärtswandler hat eine Eingangsspannung von 240 V, die Ausgangsspannung beträgt 400 V und die Schaltfrequenz liegt bei 100 kHz.
In Bild 4 werden die Wirkungsgrade und Verluste über einen Leistungsbereich von bis zu 3500 W verglichen.

Im Vergleich zu MOSFETs ist der Wirkungsgrad der GaN-FETs um etwa 20 Prozent höher, und die Verlustleistung ist etwa um den Faktor drei geringer. Bei 2000 W beträgt der Verlust bei den MOSFETs etwa 62 W; bei den GaN-FETs sind es nur 19 W. Dadurch kann das Kühlsystem kleiner ausfallen, wodurch sich der volumetrische Wirkungsgrad des Aufwärtswandlers verbessert.
Weniger offensichtlich ist, dass die Messung für den GaN-FET aufgrund seiner höheren Maximalspannung bis fast 3500 W durchgeführt wurde. Der GaN-FET hat also einen klaren Vorteil.
- Durchstarten dank großer Bandlücke
- Erste Schritte mit GaN für höhere Spannungen





