High-NA EUVL
Der nächste entscheidende Schritt in der Lithografie
Fortsetzung des Artikels von Teil 2
AttoLab: für eine schnellere Entwicklung des High-NA Patterning Ecosystems
Um den Lernprozess für die Belichtung mit Dünnfilm-Resists zu beschleunigen, hat imec beschlossen, zusammen mit KMLabs in das AttoLab zu investieren. Das Labor ermöglicht es, die grundlegende Dynamik der Fotolack-Belichtung unter High-NA EUV-Lithografiebedingungen zu erforschen, bevor der erste 0,55NA EXE:5000 Prototyp von ASML verfügbar ist.
Im AttoLab wird die High-NA-Belichtung bei 13,5 nm mit einer hellen, kohärenten, hoch harmonischen EUV-Quelle in einem interferenzartigen Aufbau emuliert. Anfang des Jahres konnten mit einem Lloyd's-Mirror-basierten Interferenzaufbau zum ersten Mal erfolgreich Lines/Spaces mit einem 20-nm-Pitch in einem Metalloxid-Resist mit nur einem Belichtungsschritt strukturiert werden. Diese Apparatur liefert entscheidende Erkenntnisse für den nächsten Schritt, die Erweiterung auf 300 mm-Wafer-Interferenzbelichtungen (die derzeit installiert wird), die theoretisch bis zu einem noch nie dagewesenen Abstand von 8 nm herabreichen kann.
Eine auf Interferenz basierende EUV-Quelle unterscheidet sich von dem Ansatz, der in den High-NA EUV-Lasern von ASML verwendet wird, die Zinntröpfchen verdampfen, um EUV-Licht zu erzeugen. Die Photonen prallen anschließend an mehreren Spiegeln im Scanner ab, werden von der Maske reflektiert und treffen schließlich auf das Resist auf dem Wafer. Während die Scanner von ASML für die Massenproduktion von Chips ausgelegt sind, werden die im AttoLab verwendeten Interferenzgeräte niemals den erforderlichen Durchsatz, der im Feld notwendig ist, erreichen.
Aber imec verfolgt mit diesem Aufbau auch ein anderes Ziel: die Untersuchung der EUV-Photonenabsorption und der ultraschnellen Strahlungsprozesse, die anschließend im Fotolackmaterial induziert werden, um mehr über die kritischen stochastischen Druckfehler zu erfahren. Mithilfe verschiedener Aufbauten können verschiedene Resistmaterialien unter Hoch-NA-Bedingungen innerhalb weniger Sekunden getestet und die Entwicklung optimierter Struktur-, Ätz- und Messtechniken unterstützt werden, die für die High-NA-EUV-Lithografie geeignet sind.
Jobangebote+ passend zum Thema
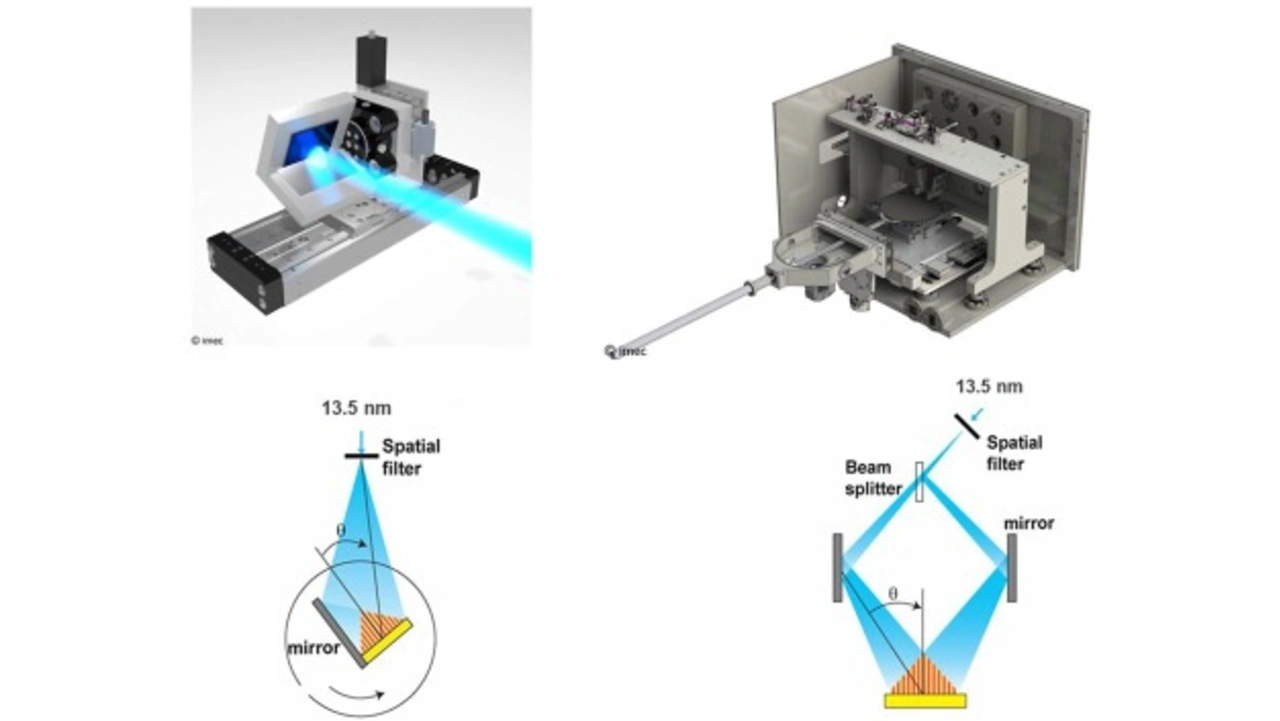
Fazit
Zusammen mit ASML in einem gemeinsamen High-NA EUV-Labor konzentriert sich imec auf die Vorbereitung der Infrastruktur, die mit der Entwicklung von High-NA-Scannern einhergeht. Zu diesem Zweck setzt imec auf alle Material- und Equipment-Hersteller und lädt sie ein, zum Aufbau eines kompletten High-NA-Ecosystems beizutragen.
- Der nächste entscheidende Schritt in der Lithografie
- Prozess- und Messtechnik: eine gemeinsame Anstrengung
- AttoLab: für eine schnellere Entwicklung des High-NA Patterning Ecosystems
- Autoren