Thermisches Management
Dem Verschleiß entgegentreten
Fortsetzung des Artikels von Teil 2
Neue Möglichkeiten bei der Verbindungstechnik
In letzter Zeit sind neue Verbindungstechniken für den Einsatz in der Leistungselektronik vorgestellt worden. Diese zeigen auf, dass in Zukunft die Verbindung zwischen Chip und Substrat ohne Weichlötung auskommen wird. Darüber hinaus hat das Kupferdrahtbonden Einzug gehalten, um der geforderten höheren Stromtragfähigkeit Rechnung zu tragen. Die Technologie wird ergänzt durch eine hoch zuverlässige Systemlötung, die im Vergleich zu heutigen Modulen das Thermal-Cycling um den Faktor Zehn verbessert.
Jobangebote+ passend zum Thema
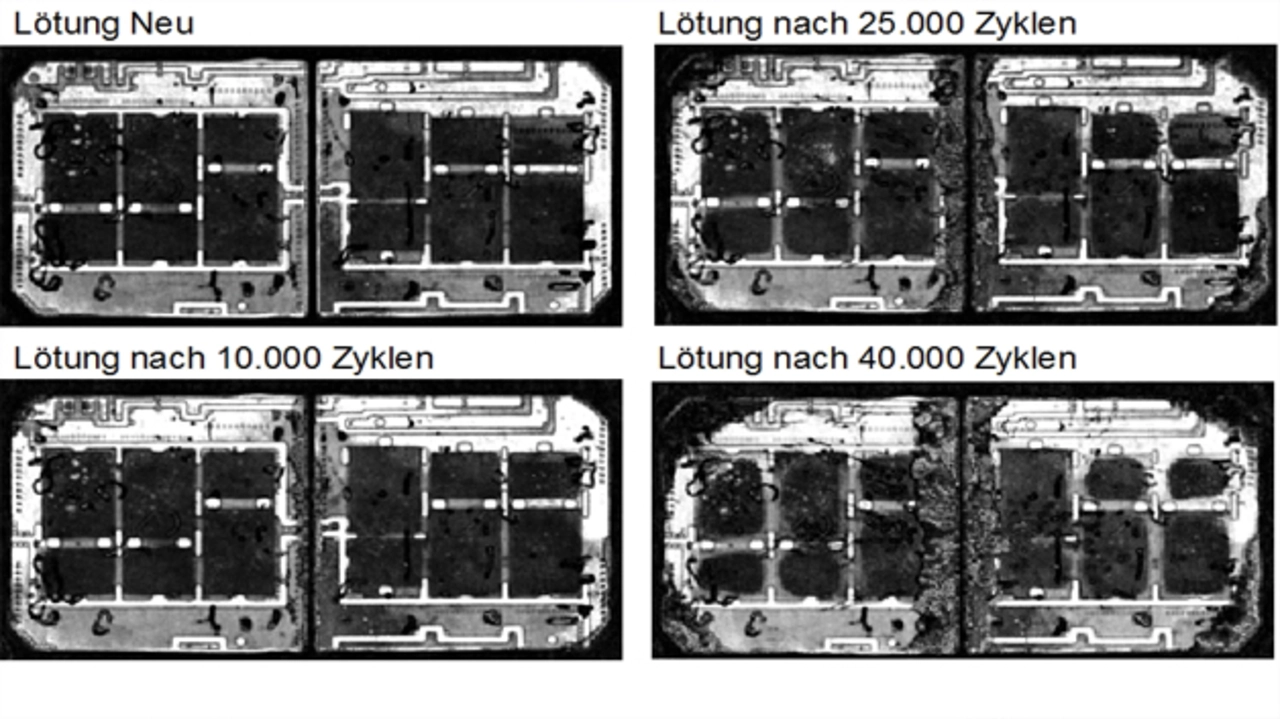
Teile dieses neuen Ansatzes sind bereits in neueren Entwicklungen implementiert und verlängern die Lebensdauer signifikant. Die aus einem Ultraschallmikroskop stammenden Aufnahmen in Bild 5 zeigen deutlich die Verbesserung der neuen Systemlötung. Im Bild sind Ergebnisse eines Tests zusammengefasst, der über 30 000 Zyklen beinhaltete. Das End-of-Life-Kriterium der Module wurde in diesem Test allerdings nicht erreicht. Für nach heutigem Standard gefertigte Produkte gilt eine Spezifikation von 12 000 Zyklen unter identischen Testbedingungen.
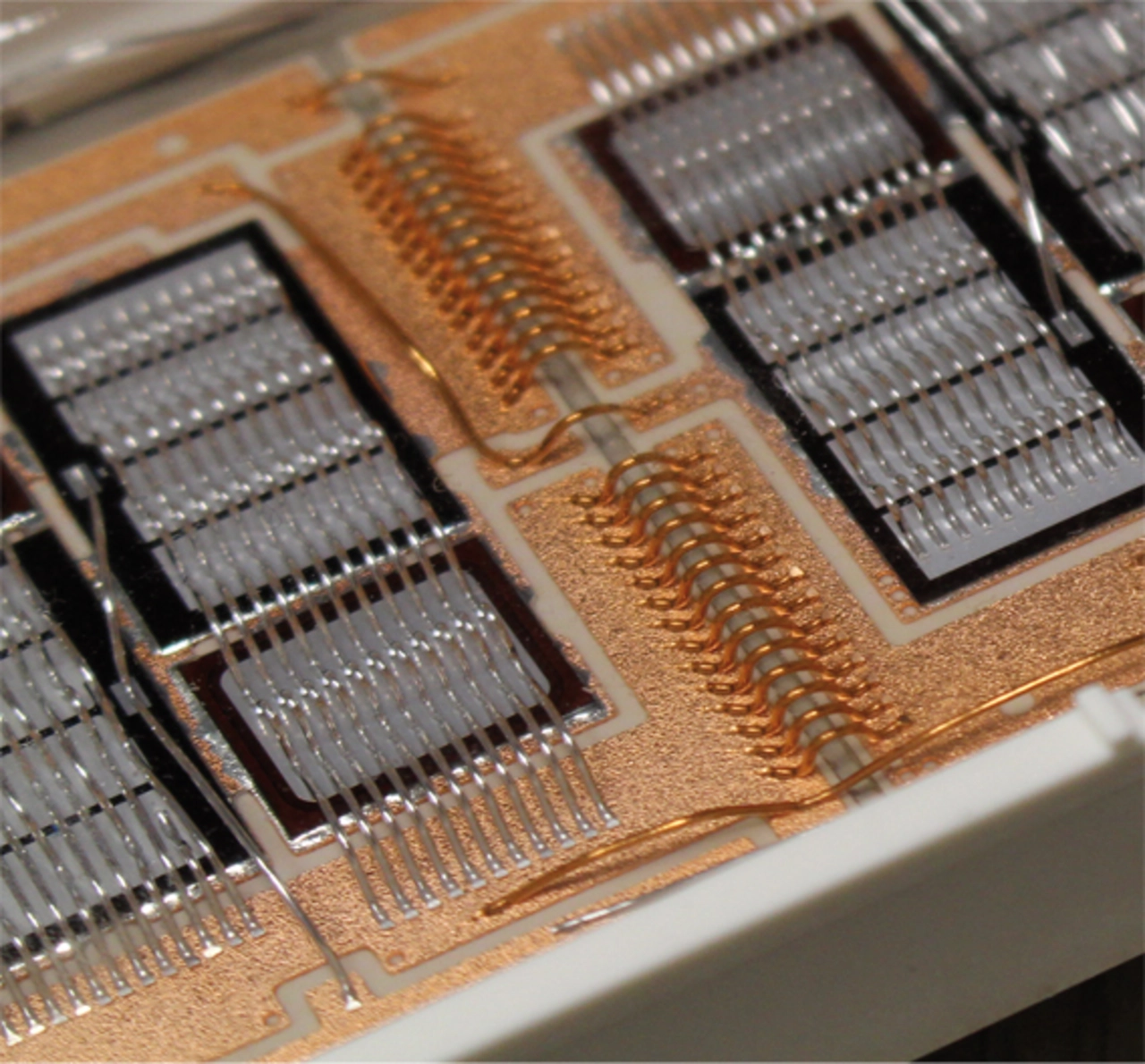
Neben der neuen Lötung haben auch Kupferbonddrähte Einzug in die Serienfertigung von Halbleitermodulen gehalten. Seit kurzem sind Module verfügbar, in denen die Aluminiumbonddrähte der Systembondung, also den Verbindungen zwischen den einzelnen DCBs, durch Kupferdrähte ersetzt sind (Bild 6). Diese Neuerung zählt ebenfalls zu den thermischen Maßnahmen, da bei den vorgesehenen Stromstärken mit Aluminiumdraht die im Modul erlaubten zulässigen Werte für die Maximaltemperaturen überschritten worden wären.
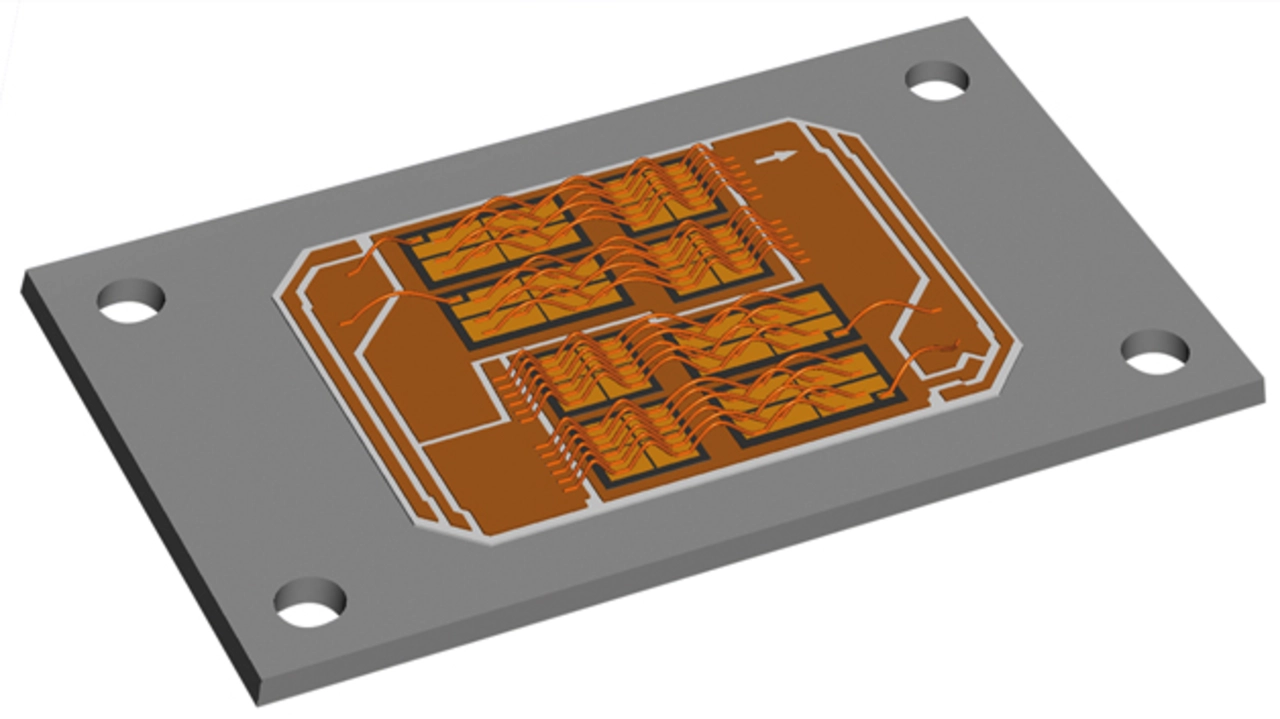
Beide Technologien sind Ableger der ».XT«-Technologie von Infineon. Dieser ganzheitliche Ansatz soll die Chipgeneration »IGBT5« mit einem Gehäuse vereinen, in dem Kupferoberflächen am Chip auch das Kupferdrahtbonden für Silizium erlauben. Die hoch zuverlässige Systemlötung ist ebenfalls Teil des Gesamtkonzeptes. Eine .XT-Einheit, wie sie zum Einsatz kommen soll, ist in Bild 7 dargestellt.
Wenngleich Halbleiterhersteller nach Verbesserung in der Konstruktion von Modulen trachten, bleibt ein wichtiger Aspekt in der Fertigung des Anwenders bestehen. Zwischen dem Halbleitermodul und dem Kühlkörper bedarf es einer thermisch leitenden Schicht. Diese Schicht ist notwendig, um einen hinreichenden und langzeitstabilen thermischen Transfer zwischen Modul und Kühlkörper zu gewährleisten.
- Dem Verschleiß entgegentreten
- Auf Lebensdauer auslegen
- Neue Möglichkeiten bei der Verbindungstechnik
- Probleme bei den Wärmeleitmaterialien