Neue Herausforderungen durch Miniaturisierung
Trends bei Leistungshalbleitern
Fortsetzung des Artikels von Teil 2
Leistungs-Halbleiter schneller schalten
Der Bedarf an Modulen und Systemkonfigurationen mit weit niedrigerer Impedanz steigt mit jeder neuen Generation von Si-Bauelementen aller Spannungsklassen. Natürlich ist der Zwang zu niederinduktiven Modul- und System-Konzepten umso höher, solange der Bedarf an Bauteilen mit niedriger Spannung bei gleichzeitig hohen Strömen da ist. Dies ist besonders bei Hybrid- und Elektrofahrzeugen mit Wechselrichtern der Fall, die mit Zwischenkreisspannungen bis 450 V und maximalen Strömen von 600 A arbeiten. Eine Sperrspannung von 600 V wird sehr schnell erreicht, wenn hier nicht sowohl das Modul als auch das Gesamtsystem sorgfältig mit Streuinduktivitäten unter 25 nH konzipiert wurden - 600 A in 100 ns zu schalten bedeutet immer noch Spitzen von 150 V. Auch hier können höhere Sperrspannungsklassen und/oder langsameres Schalten ein Ausweg sein, aber dies führt zu erhöhten statischen und dynamischen Verlusten.
Jobangebote+ passend zum Thema
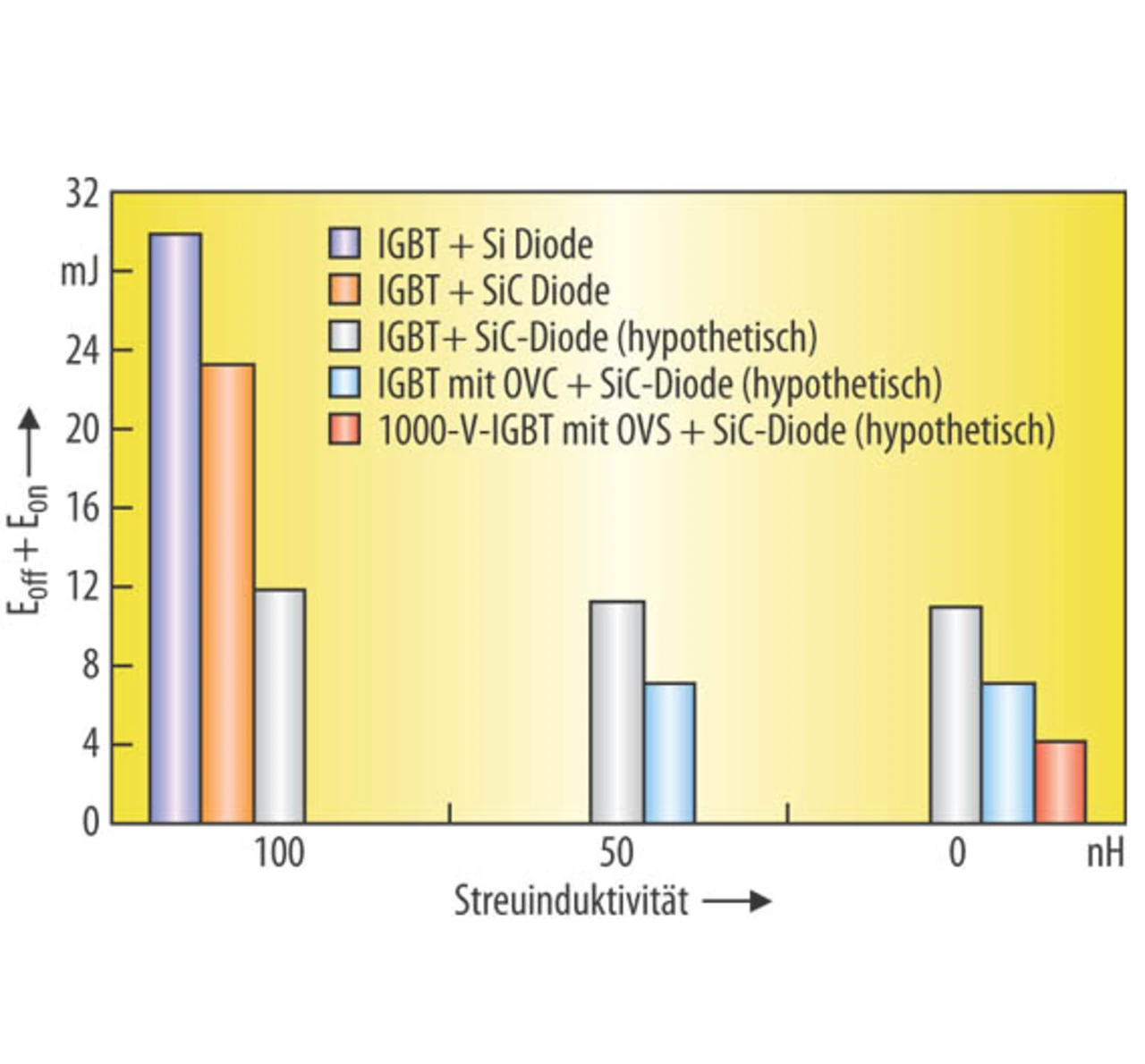
Eine enorme Verbesserung der Einschaltverluste und Spannungsüberhöhung kann mit SiC-Dioden anstelle von bipolaren Dioden erreicht werden. Die Rückfluss-Ladung ist hier auf eine sehr geringe kapazitive Ladung der Sperrschicht der Diode reduziert. Dies führt zu einer Reduzierung der Einschaltverluste in IGBT und Diode.
In Bild 10 ist ein simulierter Vergleich der Schaltverluste von heutigen Standard-Bauelementen (IGBT und Si-Diode) mit einem Baustein-Paar mit SiC-Diode dargestellt, basierend auf einem 1200-V/150-A-IGBT und einer Gesamt-Streuinduktivität von 100 nH - entsprechend der oben genannten 25 nH für einen Strom von 600 A. Der um 20 % geringere Gesamtverlust ist hier nur auf niedrigere Einschaltverluste aufgrund der fehlenden Reverse-Recovery-Ladung in der SiC-Diode zurückzuführen (siehe auch [8]).
In einer solchen Konfiguration kann der IGBT bei gleich bleibender Kollektor-Emitter-Sättigungsspannung UCEsat viel besser für schnellere Ein- und Ausschaltzeiten optimiert werden, wobei sich gegenüber den Standard-Bauelementen ein Gesamtverlust von nur 40 % einstellt - in Bild 10 als ein „hypothetisches“ Bauelement (linke Gruppe, gelber Balken) dargestellt. Diese Verluste können mit kleineren Streuinduktivitäten in Verbindung mit einer zusätzlichen vertikalen Optimierung (OVS) weiter reduziert werden, woraus sich bei gleicher UCEsat eine geringere Speicherladung ergibt und sich die Verluste um weitere 40 % verringern lassen.
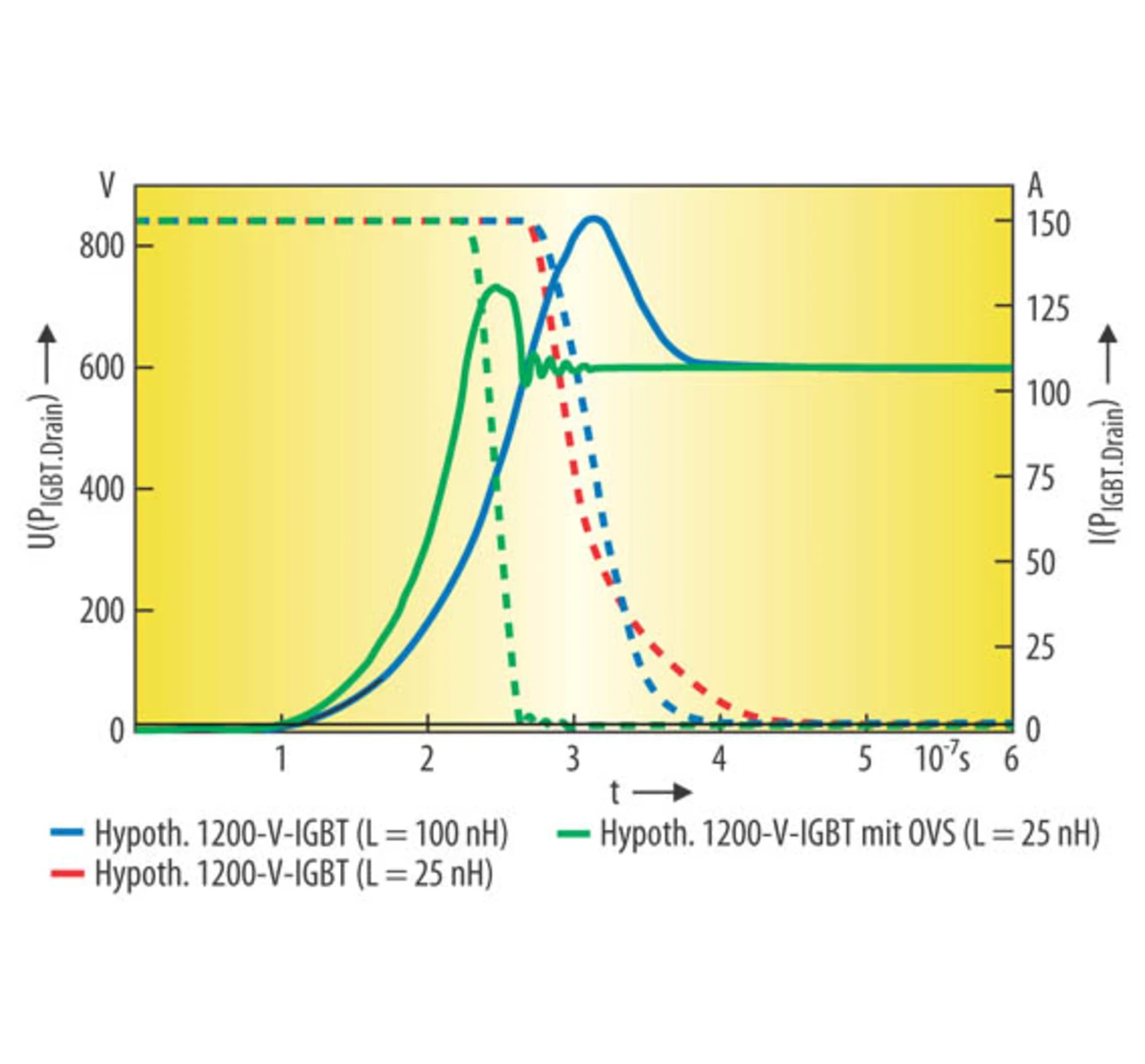
Bei derart niedrigen Streuinduktivitäten von 50 nH bei 150 A (entsprechend 7,5 nH für 1000 A) ist es nicht mehr notwendig, ein Bauelement mit 1200 V Sperrspannung in einer Anwendung mit einer maximalen Zwischenkreisspannung von 800 V zu verwenden. Wird das Bauelement für eine Sperrspannung von 1000 V eingestellt, lassen sich die Verluste um weitere 40 % reduzieren. Schließlich erreicht man ein Potenzial zum Verringern der Schaltverluste um einen Faktor von mehr als sieben (Bild 11).
All diese Optimierungen müssen ausgeführt werden, um das Potenzial von SiC-Schalter wie JFET oder MOSFET oder vielleicht später den GaN Bauelementen voll ausschöpfen zu können - dabei darf die Wirtschaftlichkeit nicht aus den Augen verloren werden (Formel (2)).
Argument zur höheren Temperaturfähigkeit neuer Materialien nutzlos
Wie bereits angeklungen, liegt das Potenzial von neuen Halbleitermaterialien wie SiC oder GaN zum einen auf Seite der schnelleren Schaltzeiten, zum anderen bei dem sehr niedrigen Ron ohne Schwelle wie bei IGBT und bipolaren Dioden. Als sekundärer Vorteil zeigt sich eine Eignung für höhere Temperaturen. Dies ist aber noch nicht wirklich brauchbar, da es noch keine Montagetechnik gibt, um eine Eignung von Si bis 200 °C voll auszuschöpfen, oder gar eine noch höhere Temperatur bei SiC oder GaN. So ist das Temperatur-Argument für die Einführung neuer Materialien nur ein sehr schwaches.
Um die Vorteile der besseren elektrischen Eigenschaften auszunutzen, ist es unbedingt notwendig, weit bessere thermische und elektrische Montage-Technologien mit sehr niedrigen Streuinduktivitäten und mit einer um Faktor 10 bis 20 besseren Lastwechselfestigkeit bei höheren Temperaturhüben zu schaffen. Der gleiche Weg ist bei der Verbesserung zukünftiger Si-Bauelemente zu beschreiten.
Unter dem Aspekt der Formel (2) ist es von großem Vorteil, eine inte-grierte Diode in einem SiC-JFET mit gleicher Leistung wie eine SiC-Schottky-Diode zu haben. Dies könnte dazu beitragen, dass SiC sehr bald verstärkt Anwendung findet: Die höhere nutzbare Stromdichte kann bei geringeren Modulgrundflächen ausgenutzt werden und somit zu einer höheren Leistung bei speziellen Anwendungen führen - wobei sich Formel (2) früher auszahlen würde.
- Trends bei Leistungshalbleitern
- Kleinere Bauteile, neue Technologien
- Leistungs-Halbleiter schneller schalten
- Literatur & Autor