Niedrige Verluste bei moderater Last
SiC-MOSFETs in Halbbrücken-Leistungsmodulen
Fortsetzung des Artikels von Teil 1
Test von 900-V-SiC-MOSFETs
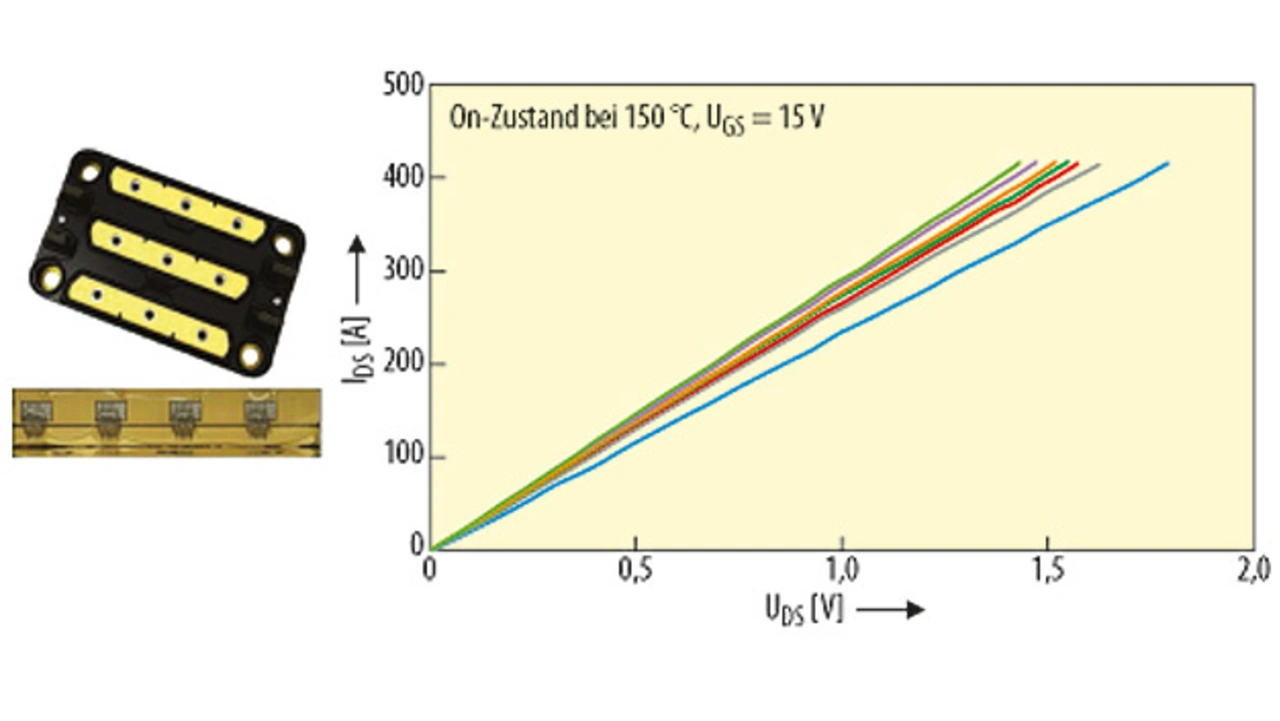
Test von 900-V-SiC-MOSFETs
Mit Hilfe des 900-V-SiC-MOSFETs wurden zwei Halbbrücken-Leistungsmodule im Format 62 mm mit einer Induktivität von 4 nH und einem Widerstand von 1,25 mΩ bzw. 2,5 mΩ entwickelt. Im Weiteren wird das 2,5-mΩ-Modul behandelt. Bei dieser Modulversion sind für jede Schaltposition vier 900-V-/10-mΩ-SiC-MOSFETs vorhanden.
Für die Messungen wurden 16 Schaltpositionen herangezogen. Bei 150 °C ergab sich für RDS(on) ein Mittelwert von 3,6 mΩ (Bild 4). Zum Vergleich wurde ein Si-IGBT-Modul mit 650 V und 430 A der Reihe EconoDual 3 (FF450R07ME4_B11) herangezogen.
Trotz einer um 250 V höheren Sperrspannung weist das SiC-Modul deutliche Vorteile auf, und zwar in Bezug auf die Erholzeit der Body-Diode, die Gate-Ladung und die Rückwirkkapazität (Reverse Transfer Capacitance). Die SiC-Komponente weist zudem ein symmetrisches Leitungsverhalten im 3. Quadranten auf. Mit einem Mittelwert von 3,6 mΩ bei 150 °C zeichneten sich die acht SiC-Power-Module außerdem durch sehr niedrige Verluste im On-Zustand aus.
Jobangebote+ passend zum Thema
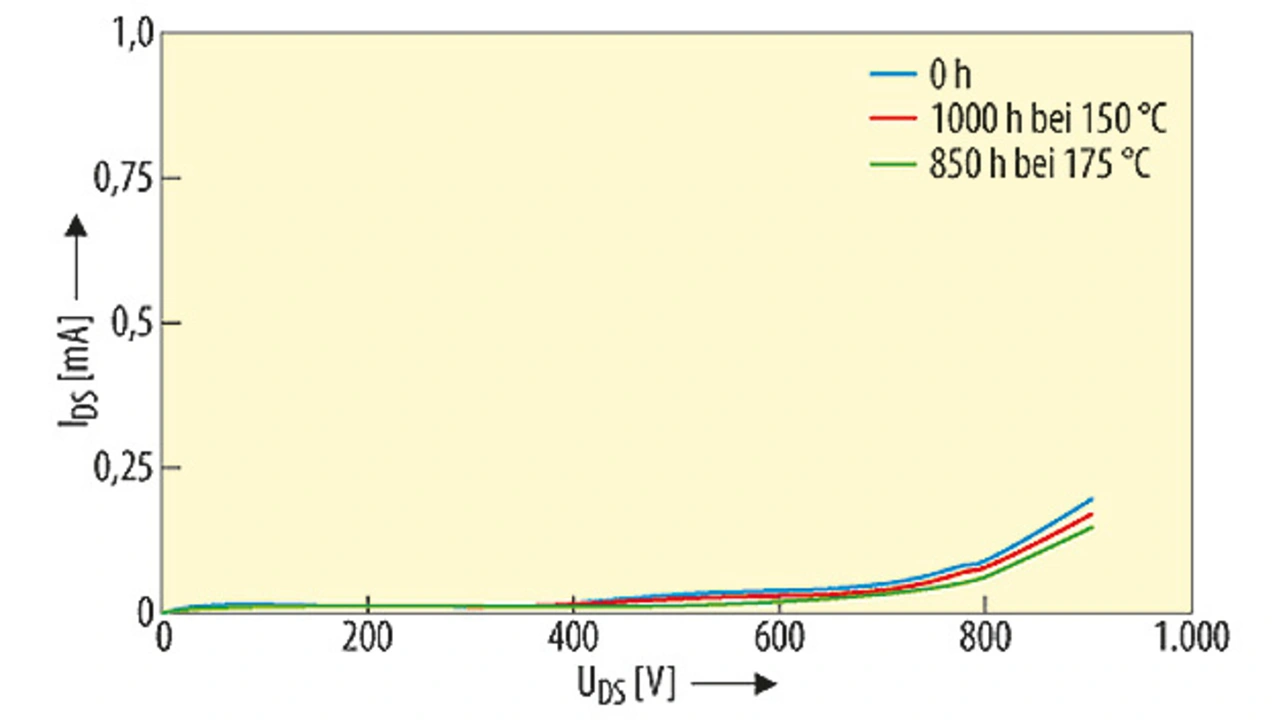
HTRB-Tests
Eine kleine Zahl der Leistungsmodule mit SiC-Bausteinen (900 V und 2,5 mΩ) wurde zudem einem HTRB-Test (High Temperature Reverse Bias) unterzogen. Sechs Module mit acht Transistoren pro Modul oder insgesamt 48 Transistoren absolvierten einen Test von 1000 Stunden bei 150 °C ohne Ausfall. Fünf der sechs Module (40 Transistoren) durchliefen anschließend nochmals einen Test von 850 Stunden bei 175 °C – ebenfalls wurden keine Ausfälle während oder nach dem Test festgestellt.
In Bild 5 wurden die Verlustströme der Leistungsmodule als Funktion der Durchlassspannungen UDS bis 900 V vor Beginn der Tests, nach einem 1000-Stunden-Test bei 150 °C und nochmals nach weiteren 850 Stunden bei 175 °C detektiert.

1,25-mΩ-SiC-MOSFET-Module
In einem zweiten Testlauf wurden die gleichen Halbbrücken-Leistungsmodule mit acht statt vier Transistoren (SiC-MOSFETs mit 900 V, 10 mΩ) pro Schaltposition bestückt. Pro Modul kamen also 16 Transistoren zum Einsatz. Insgesamt wurden acht solche Module zusammengestellt, für die I-U-Kennlinien im On-Zustand aufgenommen wurden (Bild 6). Die angelegte Gate-Source-Gleichspannung reichte von 0 V bis +15 V und wurde in 3-V-Schritten erhöht. Die Werte für den On-Status wurden sowohl bei 25 °C (links) als auch bei 175 °C (rechts) ermittelt. In beiden Fällen wurde eine Strombelastbarkeit von 800 A gezeigt.
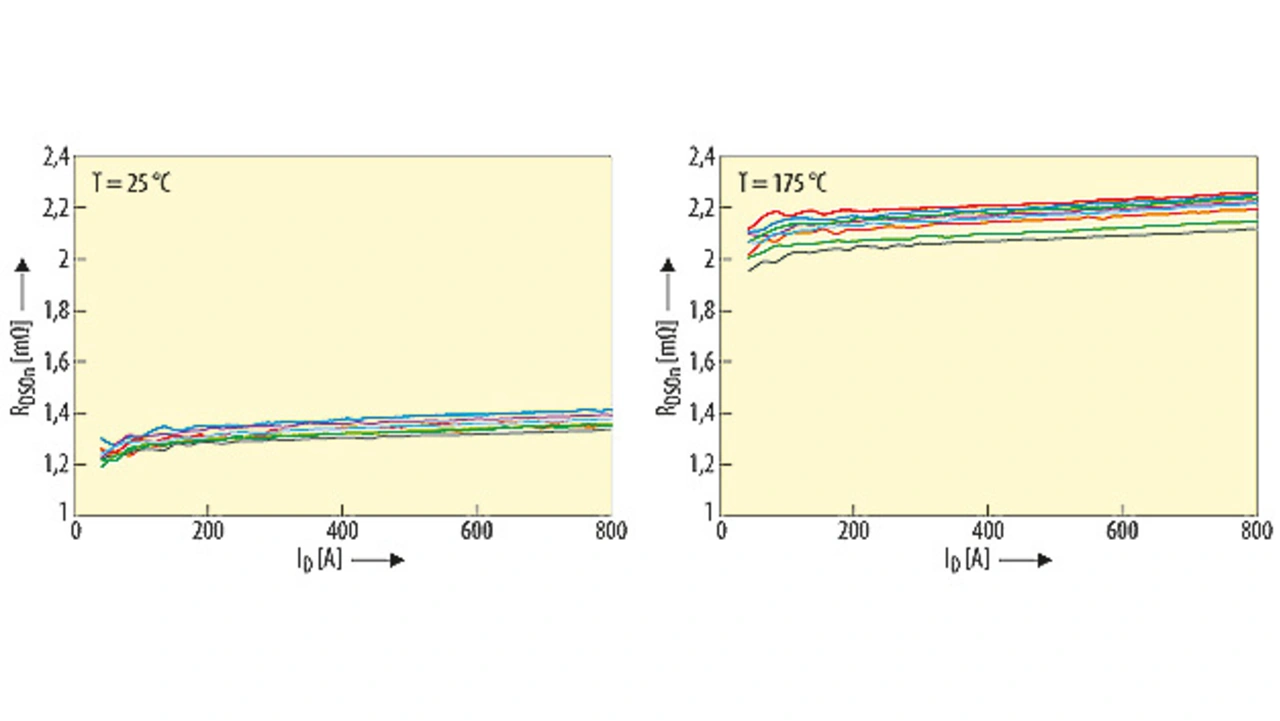
Zudem wurden Messungen des RDS(on)-Wertes an SiC-MOSFET-Halbbrücken-Modulen (900 V) durchgeführt, und zwar als Funktion des Senkenstroms bis 800 A. Auch hier wurden jeweils bei 25 °C und 175 °C Messungen durchgeführt (Bild 7). Bei niedrigen IDS-Werten von circa 50 A ergab sich ein mittlerer RDS(on) von etwa 1,25 mΩ bei 25 °C, der bei 800 A auf 1,35 mΩ anstieg, wobei hier die Eigenerwärmung zweifellos zu einem Temperaturanstieg beitrug. Der Großteil der RDS(on)-Werte entfällt in diesem Fall auf den Leiterwiderstand.
Bei 175 °C ergab sich bei allen Modulen ein RDS(on) von weniger als 2,25 mΩ, selbst bei 800 A. Durch diese Werte im On-Status lassen sich deutlich niedrigere Wandlerverluste erreichen, etwa bei Antrieben von Elektromobilen.
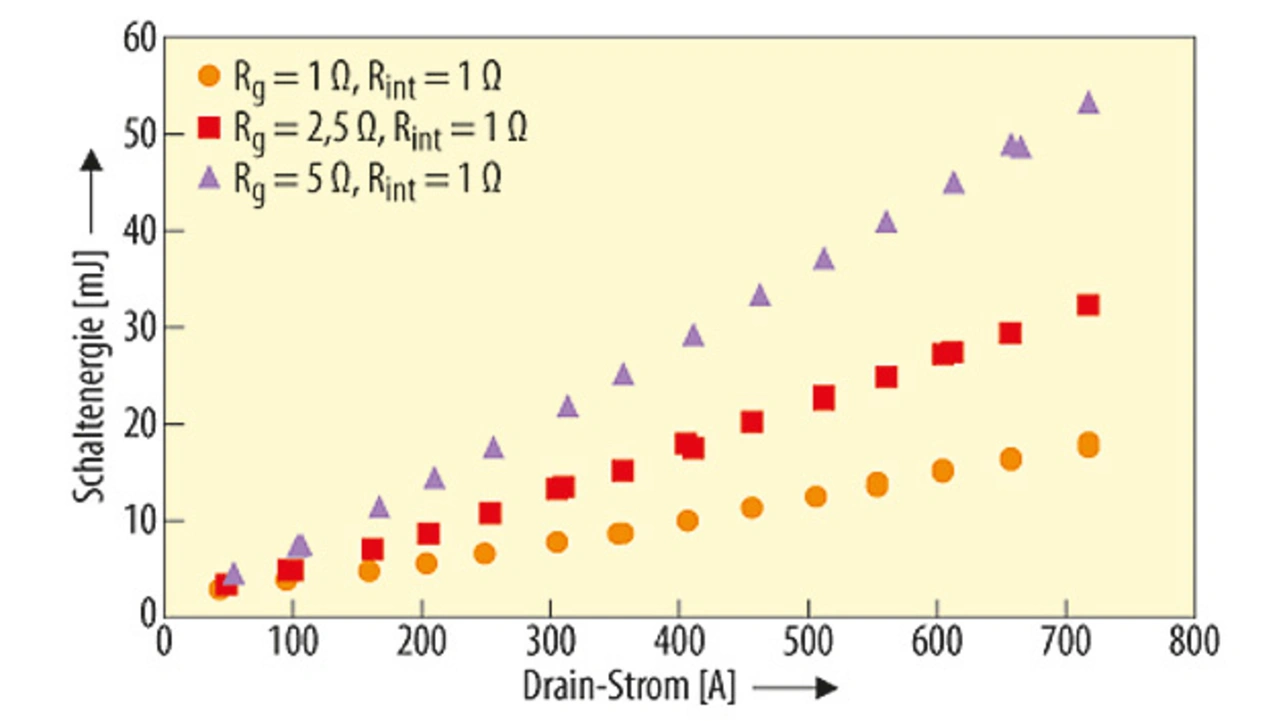
Messungen von Schaltzeit und -energie
Zum Abschluss erfolgten Messungen der Schaltzeiten und der Schaltenergie an den Halbbrücken-Leistungsmodulen mit SiC-MOSFETs (900 V und 1,25 mΩ). Im Rahmen der Tests wurde ein interner 1-Ω-Gate-Widerstand in Serie zu jedem einzelnen SiC-MOSFET geschaltet. Der externe Gate-Widerstand wurde variiert mit 1 Ω, 2,5 Ω und 5 Ω.
Wie zu erwarten, nahm die Schaltenergie mit steigendem externem Gate-Widerstand zu. Allerdings führten die niedrigeren du/dt-Werte auch zu einem geringeren Überschwingen. Selbst bei einem externen Gate-Widerstand von 5 Ω wurde bis 750 A und bei einer Bus-Spannung von 600 V nur eine Schaltenergie von 52 mJ gemessen (Bild 8). Die Höhe der Schaltenergie ist zudem bei Leistungsmodulen auf Basis von MOSFETs unabhängig von der Temperatur.
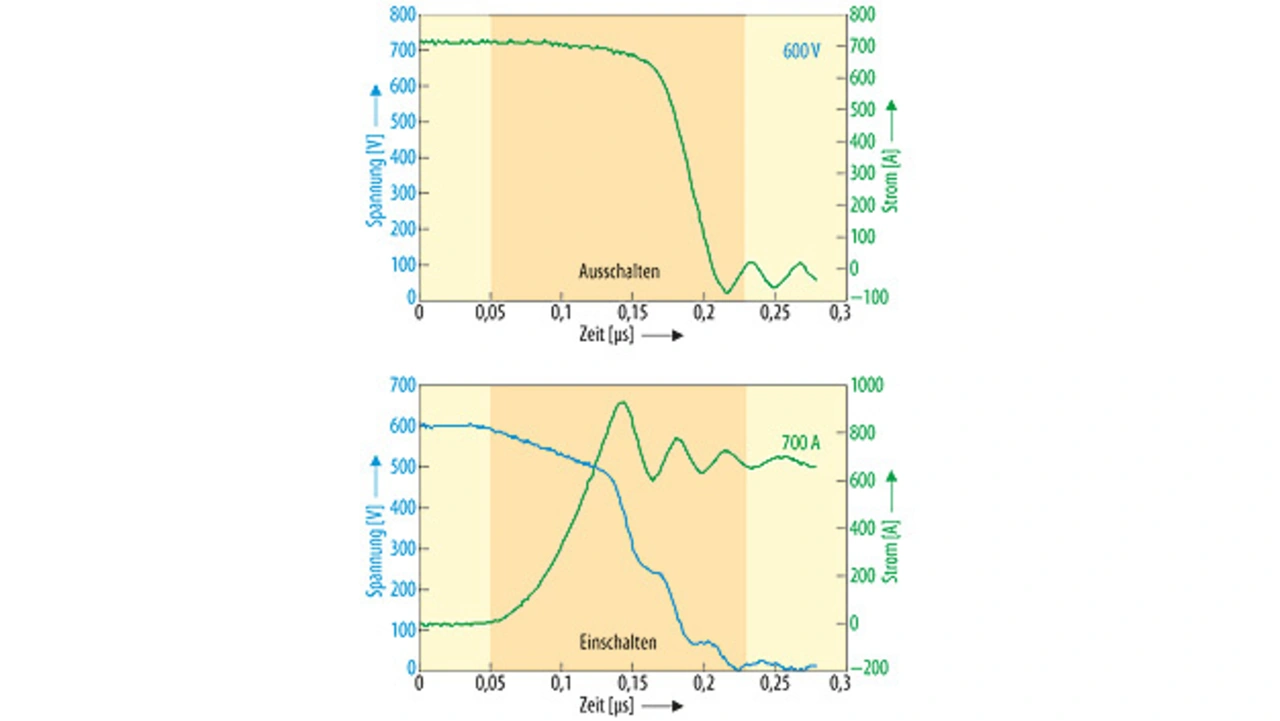
Das Schaltverhalten beim Ein- und Ausschalten wird in Bild 9 dargestellt bei einem externen Gate-Widerstand von Rg=5 Ω. Dabei ist es wichtig, darauf hinzuweisen, dass in diesem Modul keine externe SiC-Schottky-Freilaufdiode verwendet wird, sondern nur die interne Body-Diode.
Leistungsmodule, bei denen SiC-MOSFETs Verwendung finden, können also um bis zu 70 Prozent niedrigere RDS(on)-Werte aufweisen als IGBTs und MOSFETs auf Basis von Silizium. Das macht Leistungskomponenten mit Siliziumkarbid-Bausteinen für Anwendungen interessant, bei denen niedrige Leitungsverluste im unteren Lastbereich gefragt sind, etwa Antriebe von Elektromobilen. Das gilt vor allem für Module mit Busspannungen von 400 bis 700 V.
SiC-MOSFETs und entsprechende Halbbrücken-Leistungsmodule für solche Einsatzfelder sind bereits verfügbar, beispielsweist mit 900 V, 800 A und 1,25 mΩ. Somit steht Entwicklern eine leistungsfähige Alternative zu herkömmlichen Bausteinen auf Silizium-Basis zur Verfügung.
Literatur
[1] K. Shirabe, M. Swamy, J. Kang, M. Hisatsune, M. Das, R. Callanan und H. Lin: Design of 400 V Class Inverter Drive Using SiC 6-in-1 Power Module. ECCE, 15.–19. September 2013
[2] Kimimori Hamada: Installation of all-SiC Inverter System to Hybrid Electric Vehicle. International Conference on SiC and Related Materials, 4.–9. Oktober 2015
[3] R. Colin Johnson: SiC/GaN Poised for Power. EE Times, 1. September 2015
[4] V. Pala et al.: Record-low 10 mΩ SiC MOSFET in TO-247, rated at 900V. IEEE Applied Power Electronics Conference (APEC), 20.–24. März 2016
[5] Infineon 650V, 19 mΩ MOSFET, Teilenummer IPZ65R019C7, www.infineon.com/dgdl/Infineon- IPZ65R019C7-DS-v02_00-en.pdf
[6] Infineon 650V 100 A IGBT, Teilenummer IGZ100N65H5, www.infineon.com/dgdl/Infineon- IGZ100N65H5-DS-v02_01-EN.pdf
Der Autor
| Jeffrey Casady |
|---|
| ist Business Development & Programs Manager bei Wolfspeed. |
- SiC-MOSFETs in Halbbrücken-Leistungsmodulen
- Test von 900-V-SiC-MOSFETs