Niedrige Verluste bei moderater Last
SiC-MOSFETs in Halbbrücken-Leistungsmodulen
Bei Anwendungen im niedrigen Frequenzbereich, etwa den Antriebssträngen von E-Fahrzeugen, sind niedrige Leitungsverluste bei geringer Last gefragt. Leistungsmodule mit SiC-MOSFETs erfüllen diese Anforderung gut. Ein Beispiel sind mit 900-V-/10-mΩ-SiC-MOSFETs bestückte Halbbrücken-Leistungsmodule.
MOSFETs auf Basis von Siliziumkarbid (SiC) weisen im Vergleich zu Silizium-Leistungshalbleitern niedrige Leitungsverluste im moderaten Frequenzbereich auf. Das ist beispielsweise in Einsatzfeldern wie der Elektromobilität und der Antriebstechnik wichtig. In der Praxis wirkt sich das bei Elektrofahrzeugen in einer um bis zu 10 Prozent höheren Reichweite aus. Außerdem kann die Motorleistungssteuerung um bis zu 80 Prozent verkleinert werden.
Die meisten Antriebe arbeiten überwiegend im niedrigen Lastbereich. Dort erreichen SiC-Leistungsmodule um bis zu 70 Prozent niedrigere Leitungsverluste auf als Si-IGBTs. Je nach Systemarchitektur variieren diese Werte. Legt man die Fahrzyklen zugrunde, die die US-Umweltbehörde für Elektrofahrzeuge spezifiziert hat, können SiC-MOSFETs die Wechselrichter-Verluste des Antriebsstrangs eines Elektrofahrzeugs um 65 bis 73 Prozent verringern. Diese Werte lassen sich bei einem permanentmagneterregten Synchronmotor mit 90 kW, Synchron-Gleichrichtung der SiC-MOSFETs und bei Verzicht auf eine externe, antiparallel geschaltete Diode erzielen.
Geringere Inverter-Verluste wirken sich zudem positiv auf die Komponenten aus, die für die Rückgewinnung von Energie zuständig sind, etwa in Form eines niedrigeren Gewichts, eines optimierten Wärmemanagements und geringerer Kosten der Energiespeicher (Akkus).
Jobangebote+ passend zum Thema
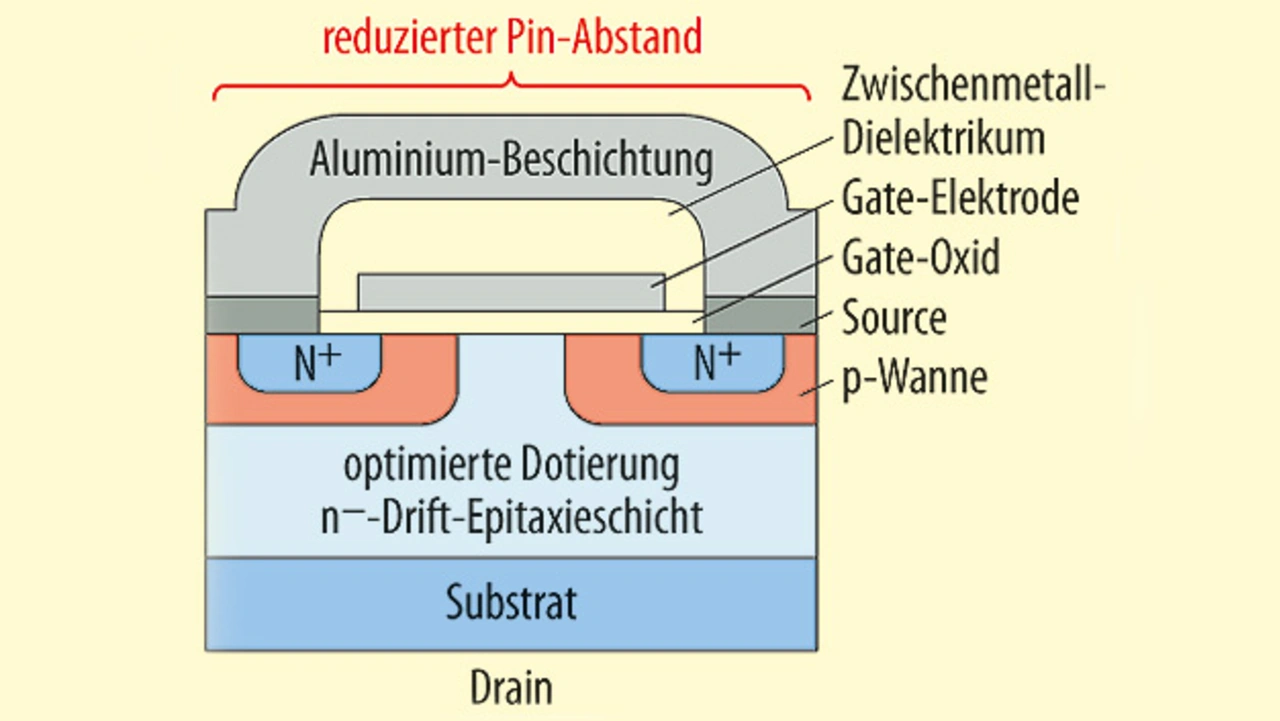
Neuartiger SiC-MOSFET erforderlich
Um diese Vorzüge ausnutzen zu können, sind allerdings spezielle SiC-MOSFETs und -Module erforderlich. Wolfspeed hat eine solche Komponente entwickelt. Sie weist in einem 900-V-Halbbrücken-Leistungsmodul mit 62 mm Länge einen sehr niedrigen On-Widerstand von 1,25 mΩ auf. Die Schaltenergie und der RDS(on) des Moduls sind für Temperaturen von bis zu 175 °C spezifiziert. Die High-Temperature-Reverse-Bias-Werte (HTRB) wurden ebenfalls bis 175 °C getestet.
Bei dem eingesetzten SiC-MOSFET handelt es sich um einen neuen Baustein mit 900 V und 10 mΩ mit einer planaren DMOS-Struktur (Double Diffused Metal Oxide Semiconductor), siehe Bild 1. Der flächenspezifische Durchlasswiderstand RDS(on) wurde auf 2,3 mΩ·cm2 reduziert; damit wurde ein deutlich geringerer Wert erreicht als bei Silizium- und anderen, vergleichbaren SiC-MOSFET-Komponenten im selben Spannungsbereich. Der 900-V-MOSFET hat eine Fläche von 4,38 mm × 7,28 mm und ist mit einer Aluminium-Beschichtung der Dicke 4 µm für das Standard-Aluminium-Wire-Bonding von Gate und Source auf der Oberseite versehen.
Temperaturabhängiges Verhalten
Das Die des Bausteins in einem TO-247-3L-Gehäuse verfügt über sieben Drahtverbindungen (Wire Bonds) mit 203,2 µm Durchmesser auf dem Source Pad sowie ein Draht-Bond mit 127 µm Durchmesser am Gate Pad. In dieser Konstellation fällt ein Widerstand von etwa 1,5 mΩ durch das Packaging an, zudem eine Induktivität von circa 15 nH ohne Source-Kelvin-Kontakt. Das Drahtbonden begrenzt den maximalen Durchlassstrom IDS auf etwa 75 A.
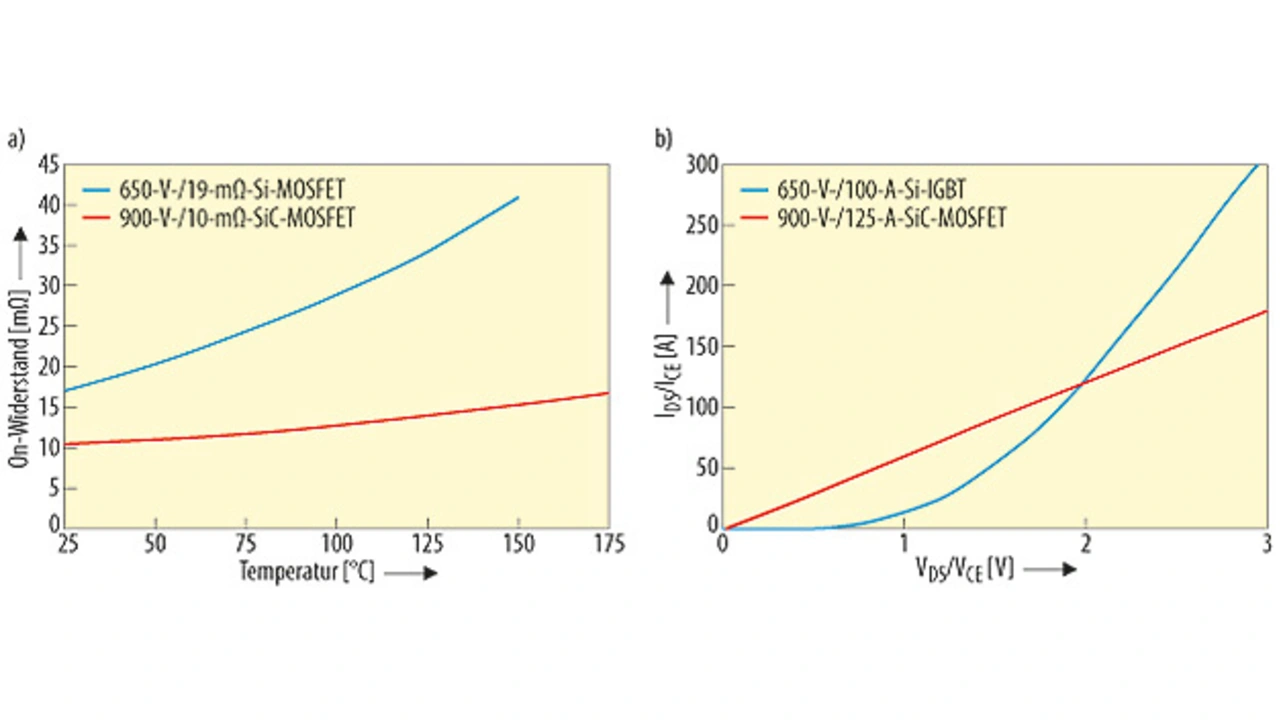
Der in Abhängigkeit von der Temperatur ermittelte RDS(on) ist positiv, jedoch im Vergleich zu Si-MOSFETs deutlich niedriger. Bild 2a zeigt das Temperaturverhalten eines 650-V-/19-mΩ-Superjunction-MOSFET auf Siliziumbasis im Vergleich zur SiC-Version mit 900 V und 10 mΩ. Bei 150 °C ist der Anstieg des RDS(on) des Silizium-MOSFET um den Faktor 1,5 höher als beim SiC-MOSFET mit 900 V. Bezogen auf den gesamten Temperaturbereich von 25 bis 175 °C steigt der On-Widerstand des Si-Bausteins auf den 2,4-fachen Wert. Der Anstieg fällt damit um 60 % höher aus als beim SiC-MOSFET.
In Bild 2b wird der On-Widerstand des SiC-Bausteins (900 V, 10 mΩ) mit dem eines 650-V-Si-IGBT verglichen, und zwar in Bezug auf den Abfall der Durchlassspannung (UDS/UCE). Bei niedrigen Durchlassspannungen (<2 V Durchlassspannungs-Verlust) sind die On-Leitungsverluste beim SiC-MOSFET deutlich niedriger als beim Si-IGBT. Der Si-IGBT weist eine Kniepunktspannung auf, die den Einschaltvorgang um etwa 0,8 V verzögert. Bis 125 A weist der SiC-MOSFET einen deutlich geringeren Abfall der Vorwärtsspannung auf, obwohl die Sperrspannung mit 900 V um 250 V höher liegt als beim Si-IGBT mit 650 V.
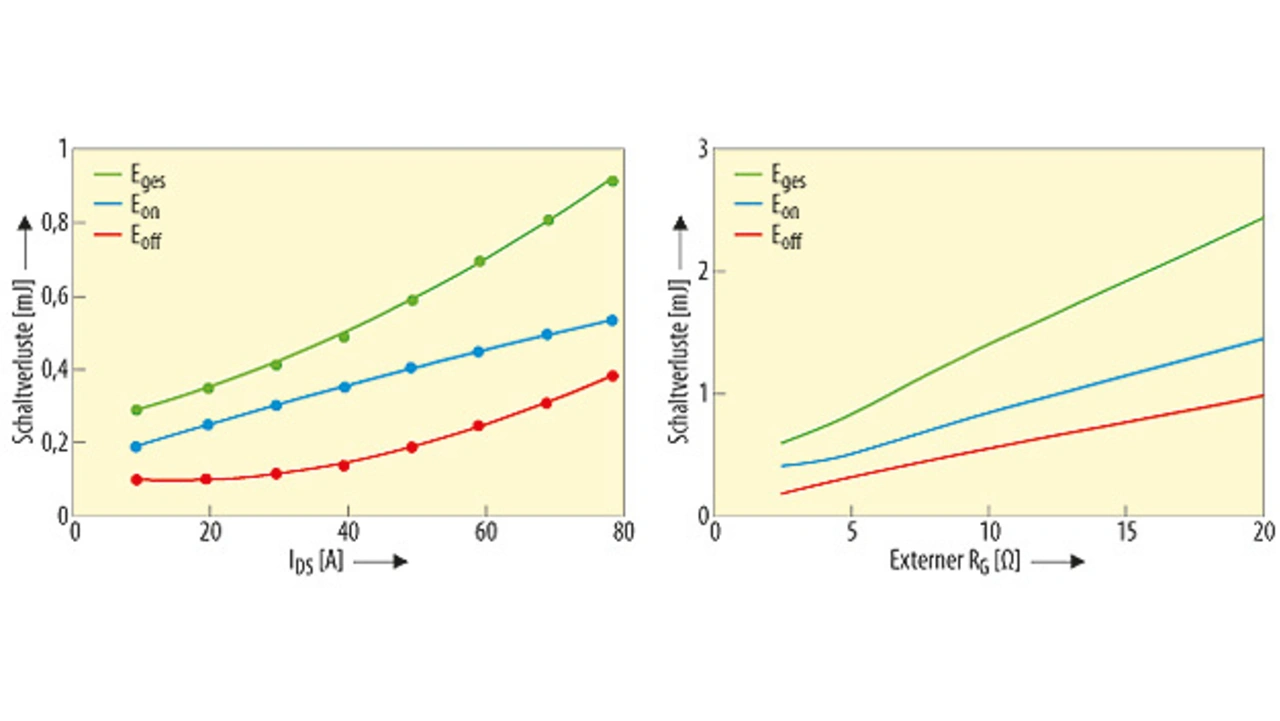
Messung der Schaltenergie
Für den SiC-Baustein aus Bild 1 wurde die Schaltenergie gemessen. Dabei kam allerdings ein TO-247-4L-Gehäuse mit Source-Kelvin-Kontakt zum Einsatz, um die Auswirkungen der Source-Induktivität auf das Gate-Signal zu minimieren. Ein Source-Kelvin-Anschluss kann die Schaltverluste reduzieren, vor allem bei SiC-MOSFETs mit hohen du/dt-Werten. Außerdem ist durch die Verwendung eines solchen Source-Kelvin-Kontakts die Vergleichbarkeit mit aktuellen Modulen besser möglich, da solche Kontakte heute üblicherweise in den Modulen zum Einsatz kommen.
Bild 3 zeigt die Messwerte der Schaltenergie beim Schalten der Gate-Spannung von –4 V bis +15 V und der Drain-Spannung von 800 V bis 0 V. Bei 60 A wurden nur 0,7 mJ bei einem externen Gate-Widerstand von 2,5 Ω gemessen. In Bild 3 sind daneben auch die Schaltverluste als Funktion des externen Gate-Widerstandes dargestellt. Ein größerer RG(ext) kann Stromkurven begradigen und die EMI-Filterung vereinfachen, dies jedoch auf Kosten von höheren Schaltverlusten.
- SiC-MOSFETs in Halbbrücken-Leistungsmodulen
- Test von 900-V-SiC-MOSFETs