Infineon / Thermisches Management
Top-Side-gekühlte Chipgehäuse bei JEDEC registriert
Bei Hochleistungsanwendungen wie der Elektromobilität ist das thermische Management der MOSFETs besonders kritisch. Für solche Anwendungen eignen sich die Top-Side-gekühlten Gehäuse QDPAK und DDPAK von Infineon, die nun als JEDEC-Standard registriert worden sind.
Eine neue Ära für Gehäusebauformen will Infineon Technologies mit der JEDEC-Registrierung der oberflächenmontierten TSC-Gehäuse (Top Side Cooling) der Serien QDPAK und DDPAK einläuten. Zusammen mit den technischen Vorteilen der Technologie ist die Registrierung der neuen JEDEC-Gehäusefamilie nach dem MO-354-Standard eine wichtige Voraussetzung dafür, dass Hochleistungsanwendungen in industriellen und automobilen Systemen der nächsten Generation zu Top-Side-gekühlten Designs wechseln.
»Als Lösungsanbieter beeinflusst Infineon die Halbleiterindustrie auch weiterhin durch innovative Gehäusetechnologien und Fertigungsprozesse«, erklärt Ralf Otremba, Lead Principal Engineer für High Voltage Packaging bei Infineon. »Die Standardisierung unsere Top-Side-gekühlten Gehäuse wird dazu beitragen, eines der Hauptprobleme der OEMs beim Design von Hochspannungsanwendungen zu beseitigen, indem die Pin-Kompatibilität zwischen den Anbietern sichergestellt wird.«
Jobangebote+ passend zum Thema
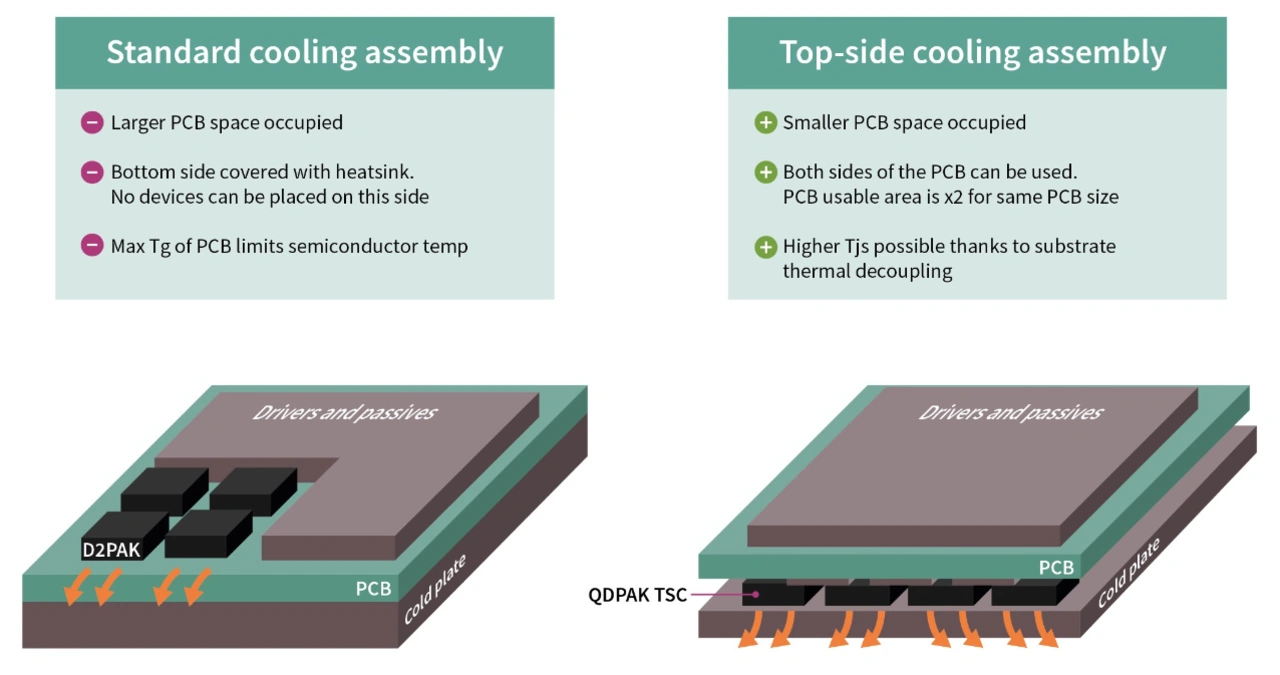
Um Kunden den Übergang von den bedrahteten Bauformen TO-220- und TO-247 zu erleichtern, bieten die oberflächenmontierten QDPAK- und DDPAK-Bauteile gleichwertige thermische Eigenschaften bei verbesserter elektrischer Leistung. Basierend auf einer Standardhöhe von 2,3 mm können Entwickler nun komplette Anwendungen wie Onboard-Charger- und DC-DC-Wandler mit allen TSC-Bauteilen in der gleichen Höhe designen. Im Vergleich zu bestehenden Lösungen, die ein 3D-Kühlsystem erfordern, kann dies die Designs vereinfachen und die Systemkosten für die Kühlung reduzieren.
Darüber hinaus bietet das TSC-Gehäuse einen bis zu 35 Prozent geringeren Wärmewiderstand als die standardmäßige Bottom-Side-Kühlung (BSC). Da beide Seiten der Leiterplatte genutzt werden können, nutzen TSC-Gehäuse die Leiterplattenfläche besser und verdoppeln die Leistungsdichte mindestens. Auch das Wärmemanagement der Gehäuse lässt sich durch die thermische Entkopplung vom Substrat verbessern, da der Wärmewiderstand der Zuleitungen im Vergleich zur freiliegenden Gehäuseoberseite wesentlich höher ist. Aufgrund der verbesserten thermischen Eigenschaft ist es nicht erforderlich, verschiedene Leiterplatten übereinanderzulegen. Anstatt FR4 und IMS zu kombinieren, reicht eine einzige FR4-Platine für alle Komponenten aus; außerdem sind weniger Anschlüsse nötig. So kann sich die Stückliste reduzieren, sodass die Gesamtsystemkosten sinken.
Zusätzlich zu den verbesserten thermischen und leistungsbezogenen Merkmalen lässt sich der Leistungskreis hinsichtlich Zuverlässigkeit optimieren, weil sich die Treiber sehr nahe am Leistungsschalter platzieren lassen. Die geringe Streuinduktivität der Treiber-Schalter-Schleife kann dazu führen, dass sich die Störeffekte und die Schwingungen am Gate reduzieren, sich die Leistungsfähigkeit erhöht und das Ausfallrisiko sinkt.