Si vs. SiC
Wie leistungsfähig sind SiC-MOSFETs?
Fortsetzung des Artikels von Teil 2
Zweikanaliger Aufwärtswandler im Interleaved-Betrieb
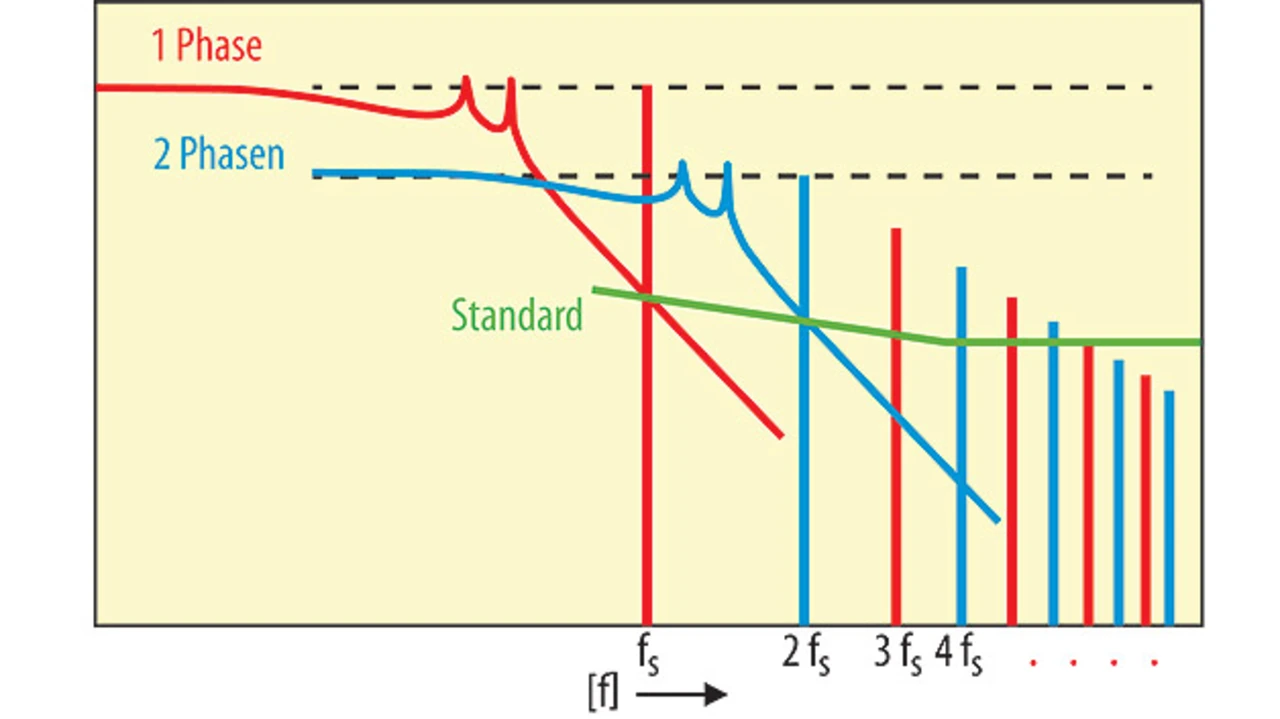
Bild 6 zeigt die unterschiedlichen differenziellen Störungen zwischen zwei Phasen im Interleaved-Betrieb und im einphasigen Betrieb ohne Interleaving. Im Interleaved-Betrieb treten die differenziellen Störungen erster Ordnung beim Doppelten der Schaltfrequenz auf und die ein- und ausgangsseitige Welligkeit können sich aufheben. Die Frequenz des EMI-Filters kann deshalb im Interleaved-Betrieb höher angesetzt werden. Das Filter kommt mit weniger Dämpfung aus und kann die Vorgaben auch mit kleineren Abmessungen erfüllen.
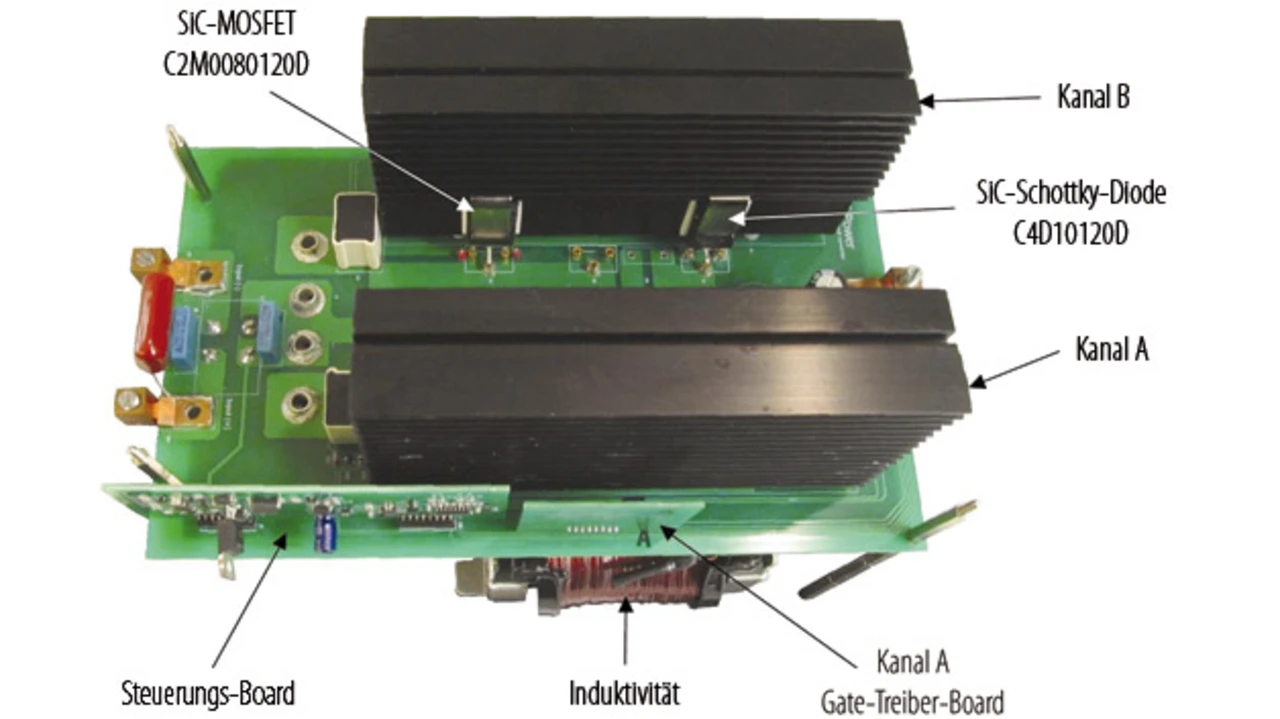
Um die Eigenschaften der SiC-MOSFETs der zweiten Generation zu verifizieren, wurde der in Bild 7 gezeigte, hart geschaltete und im Interleaved-Modus arbeitende Aufwärts-Gleichspannungswandler mit 10 kW Leistung entwickelt. Zu Vergleichszwecken wurde die Schaltung alternativ mit dem schnellen Silizium-IGBT des Typs IGW40N120H3 bestückt. Die Leiterplatte hat die Maße 240 × 140 × 90 mm³. Als Controller dient der Interleaved-PWM-Baustein UCC28220 von TI, für die Gate-Ansteuerung das IC IXDN609 von IXYS. In Tabelle 2 sind einige Eckdaten des Designs aufgeführt.
| Eingangsspannung | 450 VDC |
| Ausgangsspannung | 650 VDC |
| Nenn-Ausgangsleistung | 10 kW |
| Schaltfrequenz |
100 kHz (SiC-MOSFET) 20 kHz (Si-IGBT) |
| Abmessungen der Leiterplatte | 240 × 140 × 90 mm3 |
| Abmessungen der Drossel |
Für 100 kHz: 63 × 26 mm2 (Durchmesser × Höhe) Für 20 kHz: 140 × 108 × 68 mm3 |
Tabelle 2. Eckdaten des Designs
Wirkungsgrad und Schaltverluste
Bild 8 zeigt die Wirkungsgrad-Daten für den SiC-MOSFET mit 100 kHz Schaltfrequenz (SiC-MOSFET CMF20120D der ersten Generation und SiC-MOSFET C2M0080120D der zweiten Generation) sowie mit 20 kHz Schaltfrequenz (Si-IGBT IGW40N120H3).
Bilder 8 - 14
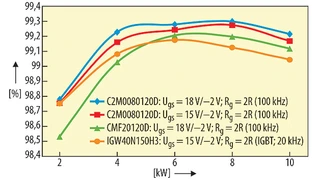


Als Ausgangsdiode wurde in beiden Fällen auf die 1.200-V-SiC-Schottky-Diode C4D10120D von Cree zurückgegriffen, um einen fairen Vergleich zu ermöglichen. Alle Daten basieren zudem auf einem externen Gate-Widerstand von 2 Ω. Die Tests ergaben, dass die SiC-Implementierung trotz der fünfmal höheren Schaltfrequenz auf einen maximalen Wirkungsgrad von 99,3 % (bei 100 kHz) kam, womit die Verluste um 18 % geringer ausfielen, verglichen mit dem höchsten Wirkungsgrad der IGBT-Lösung bei 20 kHz. Im Betrieb mit geringer Last - in dem beide Designs die niedrigsten Wirkungsgrade erzielten - kam die mit 100 kHz getaktete SiC-Lösung immer noch auf den gleichen Wirkungsgrad wie die Silizium-Lösung mit 20 kHz Schaltfrequenz. Dies bestätigt die sehr geringen Schaltverluste der SiC-MOSFETs (Bild 8).
Niedrigere Schaltverluste sind die entscheidenden Pluspunkte von SiC-MOSFETs bei hohen Schaltfrequenzen. Die Kurven in den Bildern 9 und 10 geben das Einschaltverhalten der Bausteine C2M0080120D und IGW40N120H3 wieder. Der Eon-Wert beträgt 54,5 µJ für den SiC-MOSFET und 115,1 µJ für den Si-IGBT. Die Bilder 11 und 12 zeigen dagegen das Abschalt-Verhalten des C2M0080120D und des IGW40N120H3. Dem Eoff-Wert des SiC-MOSFET von 83,3 µJ steht ein höherer Eoff-Wert des Si-IGBT von 911,5 µJ gegenüber. Aus den während der Tests aufgezeichneten Kurven geht hervor, dass die Gesamt-Schaltverluste des SiC-MOSFET bei 100 kHz ungefähr 13,8 W betragen, während die Schaltverluste des Si-IGBT bei 20 kHz mit rund 20,5 W um ungefähr 7 W höher ausfallen. Es zeigt sich, dass ein SiC-MOSFET niedrigere Schaltverluste aufweisen kann als ein Si-IGBT - auch wenn seine Schaltfrequenz fünfmal höher ist. Dies gilt insbesondere beim Abschalten: Obwohl hier ein spezieller High-Speed-IGBT verwendet wurde, entstehen beim Si-IGBT speziell beim Abschalten hohe Verluste durch das Tailstrom-Phänomen (Stromschwanz).
Thermische Eigenschaften
Die Bilder 13 und 14 erlauben einen Vergleich der thermischen Eigenschaften der Implementierungen mit dem SiC-MOSFET C2M0080120D und dem Silizium-IGBT IGW40N120H3. Die Testergebnisse beziehen sich auf eine Eingangsspannung von 450 VDC und eine Ausgangsspannung von 650 VDC bei Volllast mit 2 × 5 kW. Der Betrieb erfolgte bei einer Umgebungstemperatur von 25 °C ohne Kühlsystem am Kühlkörper und in Open-Frame-Bauweise. Als Ausgangsdiode diente in beiden Fällen die SiC-Schottkydiode C4D10120D von Cree. Aufgrund seiner niedrigeren Verluste weist der Siliziumcarbid-MOSFET eine um 40 °C geringere Gehäusetemperatur auf als der Si-IGBT, so dass er mit einem leichteren, dünneren und kostengünstigeren Kühlkörper auskommt. Die Abbildungen machen außerdem die großen Abmessungen der Drossel für die Silizium-IGBT-Lösung deutlich, die eine geringere Leistungsdichte ergibt als bei der Siliziumcarbid-MOSFET-Implementierung.
- Wie leistungsfähig sind SiC-MOSFETs?
- Überlegungen zur EMV
- Zweikanaliger Aufwärtswandler im Interleaved-Betrieb
- Vorteil SiC


