Für Advanced Packaging
Back-End- und SMT-Technologien verschmelzen
Bestückplattformen wie die »Siplace TX micron« von ASMPT machen es möglich, die bislang getrennten Bereiche Bonding und SMT-Bestückung auf einer Maschine zu kombinieren, was zu signifikanten Kosteneinsparungen führt.
Die Nachfrage nach flexibel einsetzbaren SiPs (Systems in Package) oder Modulen wächst rasant. So prognostiziert beispielsweise Mordor Intelligence, dass der Sensormarkt von 2023 bis 2028 um durchschnittliche 7,23 Prozent pro Jahr von 116,72 Mrd. Dollar auf 165,47 Mrd. Dollar anwachsen wird. Neben dem Sensormarkt gibt es viele weitere Marktsektoren. Wie 5G, E-Mobility, IoT, Optoelektronik, Virtual Reality und KI ist Advanced Packaging ebenfalls eine Schlüsseltechnologie für die kommenden Jahre.
SiPs und Module fassen aktive und passive elektronische Bauelemente zu kompakten Funktionsgruppen zusammen, die wiederum als modulare Ergänzung in größeren elektronischen und SMT-Baugruppen eingesetzt werden können. Beispiele sind Kommunikations- und Kameramodule in Smartphones. Die dafür notwendige Technologie, das Advanced Packaging, platziert Dies und Flip-Chips ebenso wie klassische SMT-Bauelemente.
Leistungsgrenzen durch Technologie-Integration überwunden
Um die geforderten Packungsdichten und damit Positioniergenauigkeiten zu erreichen, werden bisher zwei Technologien eingesetzt: reine SMT-Bestückautomaten und für Dies und Flip-Chips konventionelle Die-Bonder, eine Technologie aus dem Back-End- und Halbleiterbereich. Durch den Einsatz von zwei unterschiedlichen Verfahren, oft in getrennten Abteilungen, sind der logistische Aufwand und die thermische Belastung der Bauelemente und Baugruppen hoch. Hinzu kommt, dass die stark wachsende Nachfrage eine deutlich höhere Produktivität und Präzision erfordert, die mit reinen Die-Bondern nur durch Investitionen in zusätzliche Maschinen zu erreichen wären.
Jobangebote+ passend zum Thema

Gefragt ist also eine neue Generation von Bestückautomaten, die nicht nur SMT-Bauelemente, sondern auch die hochempfindlichen Bare Dies und Chip-Scale-Packages zuverlässig verarbeiten kann – und das mit einer Geschwindigkeit, die mit reinen SMT-Linien vergleichbar ist. Keine leichte Aufgabe, denn in SiPs und Modulen werden extrem kleine und empfindliche Bauelemente integriert. Insbesondere die superdünnen, nur 50 bis 70 µm hohen Dies sowie die 0201m-Bauelemente der neuesten Generation müssen äußerst schonend gegriffen, bewegt und bestückt werden. Weil das Advanced Packaging Technologien und Prozesse aus der Back-End- und SMT-Fertigung vereint, haben hier Anbieter die Nase vorn, die mit ihrem Produktportfolio schon immer beide Bereiche adressiert haben wie ASMPT.
Das Beste aus zwei Welten
Ein sehr gutes Beispiel für die Verschmelzung bisher getrennter Fertigungswelten ist die Bestückplattform »Siplace TX micron« von ASMPT: Mit einer maximalen Benchmarkleistung von 93.000 Bauelementen/h bei einer Standardgenauigkeit von 20 µm bedient sie drei Genauigkeitsklassen in einer Maschine. Durch Optionen wie Vakuum-Tooling lässt sich die Genauigkeit der Siplace TX micron auf 15 µm oder sogar 10 µm steigern. Bei sehr hohen Geschwindigkeiten sind nun High-Density-Bestückungen mit Bestückabständen (Placement-Gaps) von nur 50 µm möglich. Dabei gewährleistet das digitale Vision-System mit blauem Licht (Blue Lighting) eine optimale Erkennung von kontrastarmen und besonders kleinen Fine-Pitch-Bauelementen, beispielsweise mit Copper-Pillars mit kleinem Durchmesser. Die neue, hochauflösende Leiterplattenkamera ermöglicht ein besseres Erkennen und Lesen von kleinen Merkmalen und kleinen Referenzpunkten und trägt damit ebenfalls zur hohen Präzision der Siplace TX micron bei.
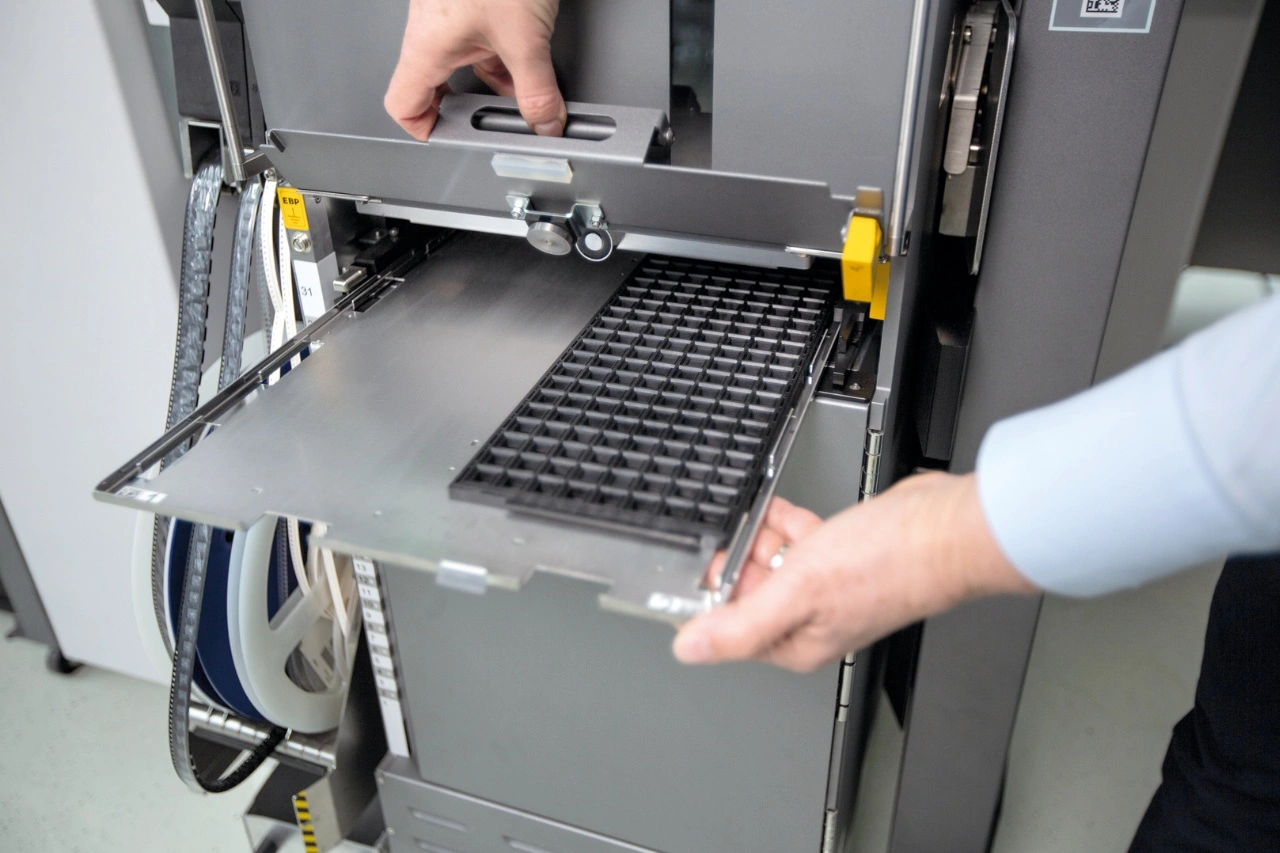
Um die Bestückleistung von 93.000 Bauelementen/h in der zweiportaligen Siplace TX micron zu erreichen, spielt der Bestückkopf CP20 eine Schlüsselrolle. Er kann mit den 4-mm- und 8-mm-Variaten und der 2 x 8-mm-Doppelspurvariante des Siplace SmartFeeder Xi sogar 0201m-Bauelemente (m steht für metrisch: 0,25 mm × 0,125 mm) und Bare Dies mit kleinsten Anschlussgrößen und einem minimalen Durchmesser von 25 µm schonend, schnell und präzise verarbeiten.
Mit einer Stellfläche von 2,23 m × 1,00 m setzt die Siplace TX micron neue Maßstäbe bei der Floorspace-Performance – ein Faktor, der in Reinräumen noch wichtiger ist als in der klassischen SMT-Fertigung. Die Maschine entspricht Reinraum-ISO-Klasse 7 und ist CE- und Semi-S2/S8-zertifiziert.
Innovatives Bauelemente-Management
Wichtig für die Verarbeitung der empfindlichen Dies: Bei der Siplace TX micron lassen sich alle zentralen Bestückprozessparameter wie z. B. Pick-up-Positionen, Beleuchtungseinstellungen des Vision-Systems, Dip-Kräfte, Verfahrgeschwindigkeiten und Bestückkräfte pro Bauelement exakt definieren. Das geht bis hin zum berührungslosen Aufnehmen (Touchless Pick-up) und Platzieren (Touchless Placement), Letzteres sogar völlig druckfrei (Zero Placement-Force). Praktisch: Die verschiedenen Bestückkräfte und Prozessvarianten lassen sich ohne Umrüsten mit demselben Bestückkopf realisieren.
Mit der Crack-Die-Inspection werden kleinste Risse im Die und mit der Chipping-Detection Beschädigungen am Rande der Dies zuverlässig erkannt. So wird verhindert, dass beschädigte Bauelemente bestückt werden und den Ertrag schmälern.

Neu bei der Siplace TX micron ist der »Multi Purpose Dual Conveyor TX«. Er verarbeitet Leiterplatten mit einem Gewicht von bis zu 8 kg und einer Dicke von bis zu 14 mm inklusive Verwölbung – bei gleichbleibend hoher Verarbeitungsgeschwindigkeit und Präzision. Selbst Leiterplattenunterstützungen mit einem Gewicht von bis zu 35 kg sind mit dieser Transportoption möglich. Als Substratträger kommen niedrige und hohe Jedec-Trays zum Einsatz. Klemm- und Entklemmgeschwindigkeit sind flexibel programmierbar.
Best Fit für die intelligente Fertigung
Wie alle modernen ASMPT-Lösungen bietet auch die Siplace TX micron umfangreiche Möglichkeiten zur M2M-Kommunikation und Vernetzung. Proprietäre und standardisierte Schnittstellen wie Works Operations Information Broker (OIB), IPC-HERMES-9852, IPC-2591 CFX oder IPC-SMEMA-9851 ermöglichen die umfassende Integration in Workflows, in übergeordnete MES/ERP-Systeme, in Traceability-Anwendungen und nicht zuletzt in das ASMPT-Konzept der intelligenten Fertigung. Es ermöglicht effizientere Prozesse, mehr Ertrag, höhere Qualität und effektiveren Personaleinsatz durch Big-Data-Processing.
Mit der Siplace TX micron zeigt ASMPT, wohin die Reise in der Elektronikfertigung geht, insbesondere bei Advanced Packaging und High-Density-Anwendungen: Sie vereint erstmals hohe Präzision und Zuverlässigkeit in der SMT-Die-Mix-Bestückung und ist damit genau die richtige Plattform, um deutlich kompaktere SiPs und Module in deutlich höheren Stückzahlen als bisher zuverlässig und kostengünstig zu fertigen.