Leistungselektronik
Neue Aufbautechnik für das Hybrid-Fahrvergnügen
Fortsetzung des Artikels von Teil 3
Im Fokus: Bond-Buffer-Technologie
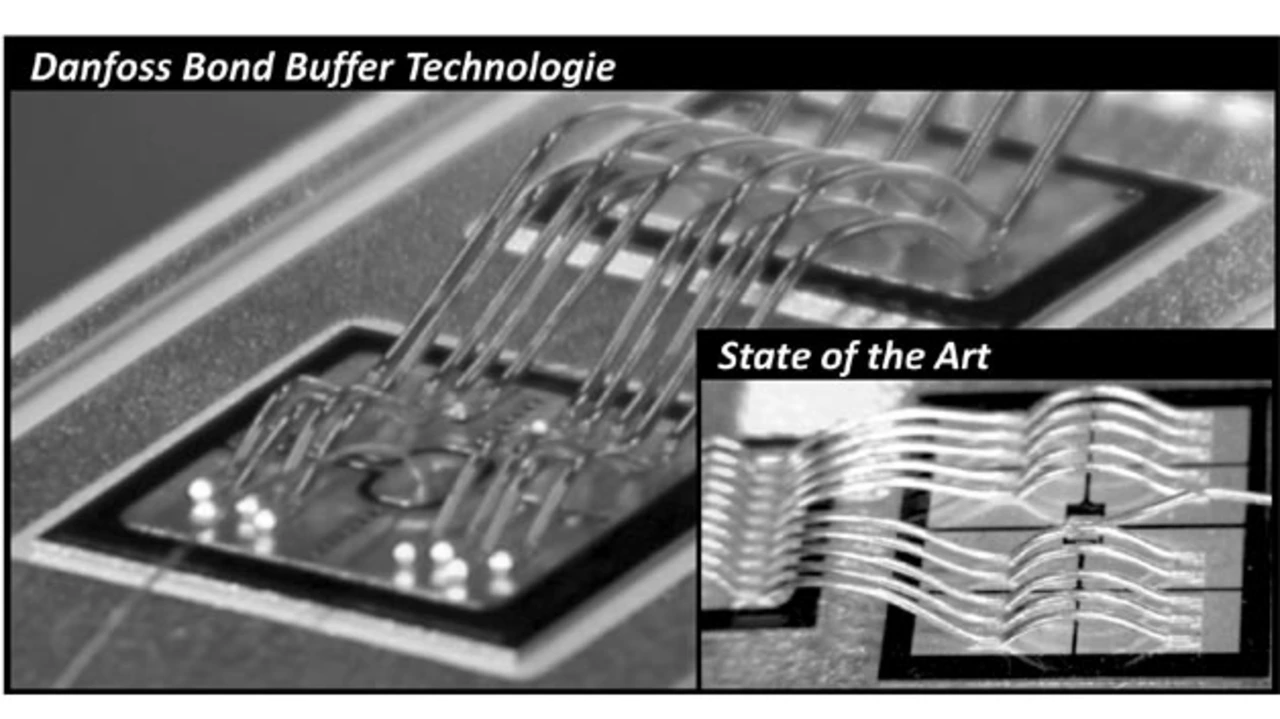
Mit Hilfe des vorgestellten Sinterverfahrens wird nicht nur der Halbleiterchip stoffschlüssig mit seinem Schaltungsträger verbunden. Im gleichen Zuge lässt sich auch auf der Chip-Oberseite eine dünne Kupferfolie aufsintern (Bild 2). Diese Folie bildet dann eine Schnittstelle zu dem oberseitigen Kupfer-Bonddraht. Gleichzeitig bildet dieser sogenannte Bond-Buffer eine zusätzliche Schutzschicht, die den Kräfteeintrag beim Drahtbondprozess absorbiert. Dadurch wird die feinstrukturierte Siliziumoberfläche des Halbleiters vor Defekten geschützt. Im Betrieb hilft die Folie, thermische Impulse aufzunehmen und die Stromdichte gleichmäßig über die Chip-Oberseite zu verteilen.
Damit entsteht ein Stapelaufbau, der die lebensdauerbegrenzenden Effekte herkömmlicher Leistungsmodule überwindet. Der Vorteil einer höheren Robustheit lässt sich auf dreifache Weise nutzen:
- Eine engere Auslegung der Halbleiterflächen führt zu geringerem Platzbedarf und reduzierten Kosten. Alternativ lässt sich das Modul mit unverändertem Halbleiterinventar auch bei hohen Temperaturen einsetzen, wie sie beispielsweise im Kühlkreislauf eines Verbrennungsmotors vorherrschen. Damit wäre die Voraussetzung für eine noch bessere räumliche Integration unter den eingeschränkten Bauraumverhältnissen im Kraftfahrzeug geschaffen.
- Außerdem ist es durch die robuste Aufbautechnik möglich, mit der gleichen Halbleiterfläche höhere Ströme zu schalten und damit mehr Antriebsleistung zu ermöglichen. Welche der oben aufgeführten Freiheitsgrade dabei speziell zum Einsatz kommen, kann der Entwickler des Fahrzeugumrichters fallweise entscheiden.
- Ein weiterer Vorzug der Kupfer-Bonddraht-Technik in Verbindung mit aufgesinterten Bondbuffern besteht darin, dass bei den Modulherstellern erprobte Anlagentechnik zum Einsatz kommt und etablierte Design-Prinzipien und die gewohnte Flexibilität einer Drahtbond-Kontaktierung weiter genutzt werden können.
- Neue Aufbautechnik für das Hybrid-Fahrvergnügen
- Halbleiterleistungsmodule aus dem Kostenblickwinkel betrachtet
- Neue Aufbau- und Verbindungstechnik
- Im Fokus: Bond-Buffer-Technologie
- Entwärmung von Leistungshalbleitern
- Literaturangaben
- Die Autoren:
- Die Autoren

