IMEC
EUV ist reif für die Serienfertigung
Fortsetzung des Artikels von Teil 2
Strukturtreue und lokale Varianzen
Ein bedeutender Aspekt des Imec-Projekts bestand in der Qualifizierung der Strukturgenauigkeit und ihrer lokalen Varianzen. Denn diese tragen wesentlich zur Eignung der vorgeschlagenen Lösungen für den industriellen Einsatz bei. Bei einem geringen Pitch von 32 nm können auch geringe Prozessvariationen in der EUV-Lithographie signifikante Auswirkungen auf die Performance eines Bausteins haben. Solche Variationen sind durch den Overlay-Versatz und die CD-Uniformität (CD: critical dimension) bedingt, aber auch durch stochastische Effekte im Resist.
Insbesondere die Uniformität der Breite und Länge der Block-Features sind wichtig. Die Breite eines Blocks an einem Graben bestimmt den Tip-to-tip-Abstand auf diesem Graben. Als Ziel des iN7-Designs soll eine kritische Tip-to-tip-Dimension von 21 nm nach der Low-k-Ätzung erreicht werden. Experimente zeigen, dass die kritische Dimension über den Wafer hinweg ausreichend uniform ist. Mit einer weiteren Feinabstimmung dürfte die Varianz unterhalb von 1 nm (3 Sigma) bleiben.
Auch die lokale Variation der Blockbreite und der Platzierung sind wichtig, denn sie bestimmen die ausreichende Überlappung der metallischen Linie mit der Durchkontaktierung (Via), mit der darüber oder darunter liegenden Layer verbunden werden. Größten Anteil an dieser lokalen Varianz hat das stochastische Rauschen, das aus statistischen Variationen resultiert, mit denen die verfügbaren Photonen mit dem Resist interagieren.
Zusätzlich zum Overlay-Versatz (wie genau der Scanner die einzelnen Layer übereinander anordnen kann) entsteht ein Platzierungsfehler bei den Lücken (Tip) von ungefähr 5 nm (3 Sigma). Ob dies für die Überlappung mit dem Via-Layer ausreicht, hängt von der vorliegenden Designregel ab. Wenn keine direkt benachbarten Vias erlaubt sind, bleibt genügend Spielraum für die Überlappung von Via-Layer und Lücken.
Eine weitere kritische Dimension ist die Länge des Blocks, denn sie ist entscheidend für die Effizienz des Trench-Blockings. Ein zu kurzer Block kann zu einem unvollständigen Schnitt des metallischen Grabens führen, während ein zu langer Block die benachbarten Gräben einengen kann. Idealerweise wird das Ende des Blocks auf der halben Länge der Spacer-Linie positioniert. Das maximale Budget für die zulässige Variation des Block-Endes gegenüber den Spacer-Kanten beträgt +8 nm.
Die dominanten Verbraucher dieses Budgets sind auch hier Overlay und Stochastik, neben einer lokalen Variation von ungefähr 6 nm (3 Sigma). Somit dürfte bei 3 Sigma und unter der Annahme, dass auch die übrigen Faktoren (wie Intra-Wafer CD-Uniformität) ausreichend klein gehalten werden, die Spacer-Breite mit 16 nm genügend Spielraum bieten, um die »SAQP plus Block«-Technologie für den iN7-Node zu ermöglichen. Die exakten Spezifizierungen können je nach Hersteller und Produkt variieren (Bild 3).
Jobangebote+ passend zum Thema
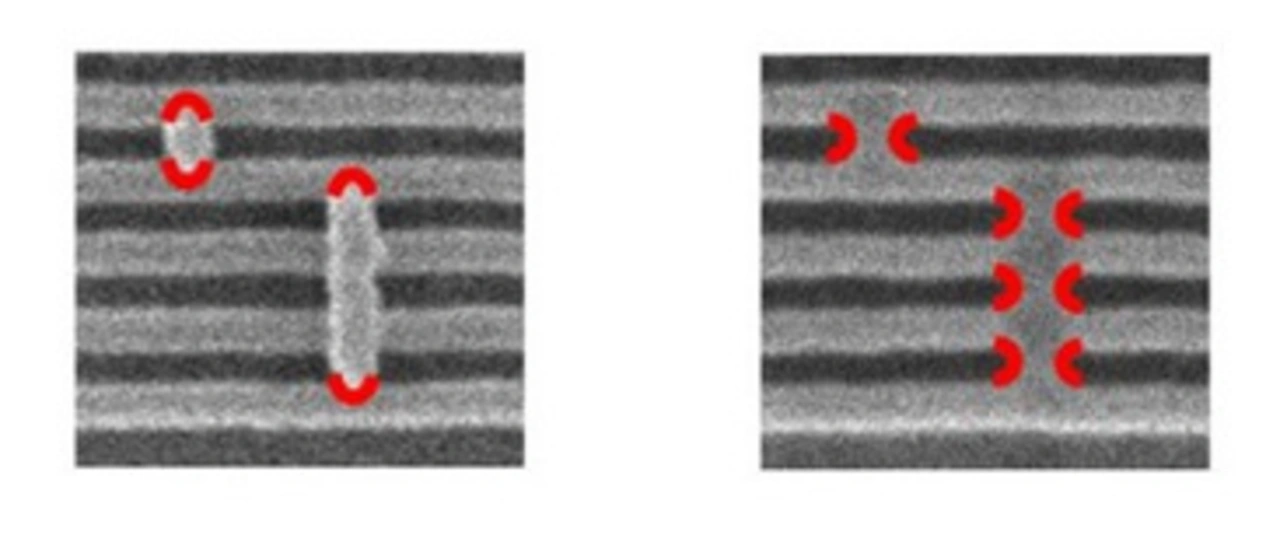
- EUV ist reif für die Serienfertigung
- Die N7-EUV-Plattform (iN7) vom Imec
- Strukturtreue und lokale Varianzen
- EUV-Implementierung für die Massenfertigung