IMEC
EUV ist reif für die Serienfertigung
Fortsetzung des Artikels von Teil 1
Die N7-EUV-Plattform (iN7) vom Imec
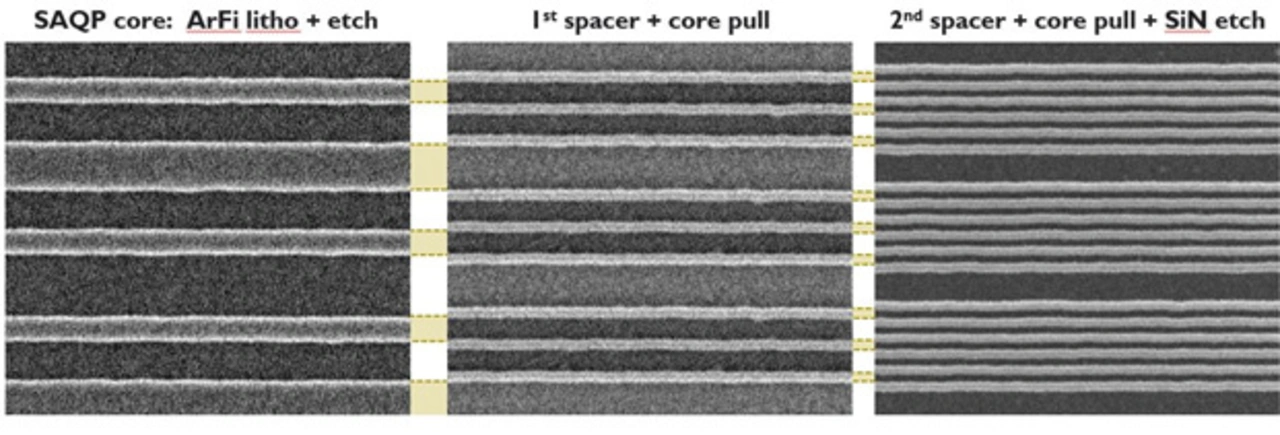
Zur Evaluierung dieser Option – 'SAQP plus EUV-Block Patterning' – nutzt Imec seine iN7-Plattform. Dabei sind zwei metallische Layer besonders wichtig: metal1 mit 42 nm Pitch und metal2 mit 32 nm Pitch (7.5 Track Design). Via1 verbindet die beiden Metalllagen, wofür ein zweifacher Damascene-Prozess genutzt wird. Mit diesen Pitches entspricht iN7 den BEOL-Anforderungen der N7-Knoten der IDMs sowie der N5-Knoten der Foundries. Die Strukturierung sowohl von metal1 sowie via1 wird mit nur einer EUV-Belichtung erzielt.
Optimierung der Designregeln, Masken und Ätzprozesse
Die Aufbringung und Evaluierung der Strukturen erforderten beträchtliche Anstrengungen und Innovationen in etlichen Bereichen der Lithographie. Als Erstes entwickelte Imec ein passendes Design und die notwendigen Designregeln, um die Strukturvorgaben zu erfüllen. Außerdem wurde ein geeignetes Resistmaterial für den EUV-Block-Prozess ausgewählt und dessen Auswirkungen auf die optische Proximity-Korrektur (OPC) untersucht. Dies führte zu einem 2D OPC Full-Chip Modell. Dieses Modell und andere rechnergestützte Lithographie-Verfahren wurden eingesetzt, um die passenden EUV-Blockmasken zu entwerfen und zu fertigen. Außerdem wurden neue Chemikalien und neuartige Integrationstechniken für den Ätzprozess entwickelt.
SAQP-Linien und EUV-Blocks
SAQP (self-aligned quadruple patterning) ist eine Double-Spacer-Technik (zwei Abstandshalter), die in der Industrie bereits gut eingeführt ist. Der Prozess erfordert einen Lithographie-Schritt sowie weitere Abscheidungs- und Ätzschritte zur Definition der Spacer.
Imecs Prozessfluss beginnt mit den Grundlinien (Core Lines) von metal2, sprich dem (Pre)-Patterning von Linien mithilfe der Immersion-Lithographie (mit dem ASML NXT:1970i Immersion-Scanner). Auf diesem Muster wird ein Layer Spacer-Material aufgebracht. Anschließend wird das Spacer-Material geätzt und das Core-Material entfernt. Dieses zweite »Core«-Pattern wird nun für den zweiten Spacer genutzt, und zwar durch Wiederholen der Sequenz »Spacer-Abscheidung, Spacer-Ätzung und Core-Material-Entfernung«.
Nach diesen Schritten ergibt jede Kante einer Grundlinie eine Dublette von Spacer-Linien. Im Endergebnis entstehen Gruppen von sechs Spacer-Linien mit vierfach dichterem Pitch (16-nm-Half-Pitch) als beim anfänglichen (Pre)-Patterning. Dieses Gittermuster wird anschließend in das SiN (Silizium-Nitrid) übertragen und erzeugt so ein Muster von SiN-Linien über einem TiN-Layer (TiN: Titan-Nitrid. Siehe Bild 1.
In einem weiteren Schritt werden die Block-Features auf das SAQP-Pattern aufgebracht. Zunächst wird das Spacer-Pattern mit Spin-on Carbon (SoC) beschichtet. Nach dem Aufbringen des Resistmaterials wird mithilfe der EUV-Belichtung (ASML NXE:3300) die Block-Features im Resist auf dem SoC erzeugt. Nach der SoC-Ätzung entstehen säulenförmige Block-Features aus SoC mit 65 nm Höhe auf den Spacer-Linien. Dieses 'SAQP plus Block Pattern' wird anschließend auf den darunterliegenden TiN-Layer übertragen, der als Hartmaske fungiert. Durch das Ätzen der Gräben in diesem Muster in den darunter liegenden Low-k-dielectric-Layer und ihre Metallisierung erhält man das endgültige metal2-Muster. Die Breite der Block-Features bestimmt die kritische Tip-to-tip-Dimension von metal2 (Bild 2).
Jobangebote+ passend zum Thema
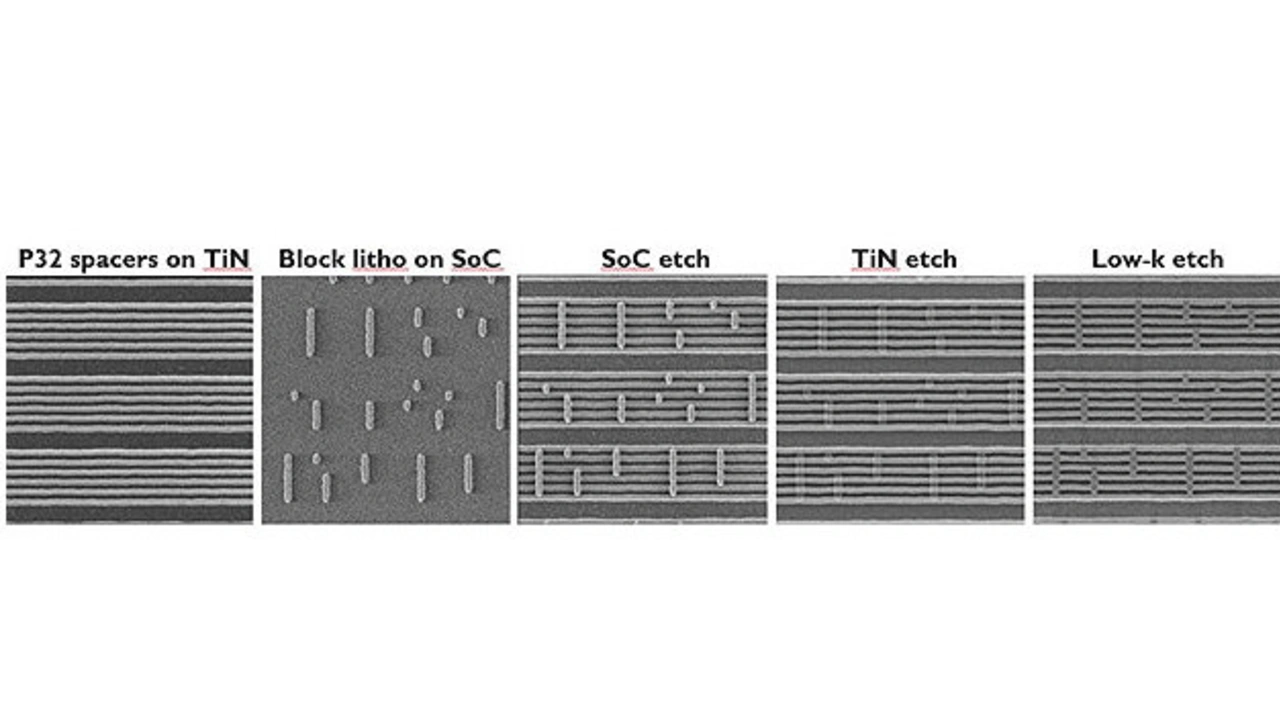
- EUV ist reif für die Serienfertigung
- Die N7-EUV-Plattform (iN7) vom Imec
- Strukturtreue und lokale Varianzen
- EUV-Implementierung für die Massenfertigung