Siliziumkarbid - Teil 2
Eigenschaften und Strukturen von SiC-Komponenten
Fortsetzung des Artikels von Teil 2
SiC-Leistungs-Module
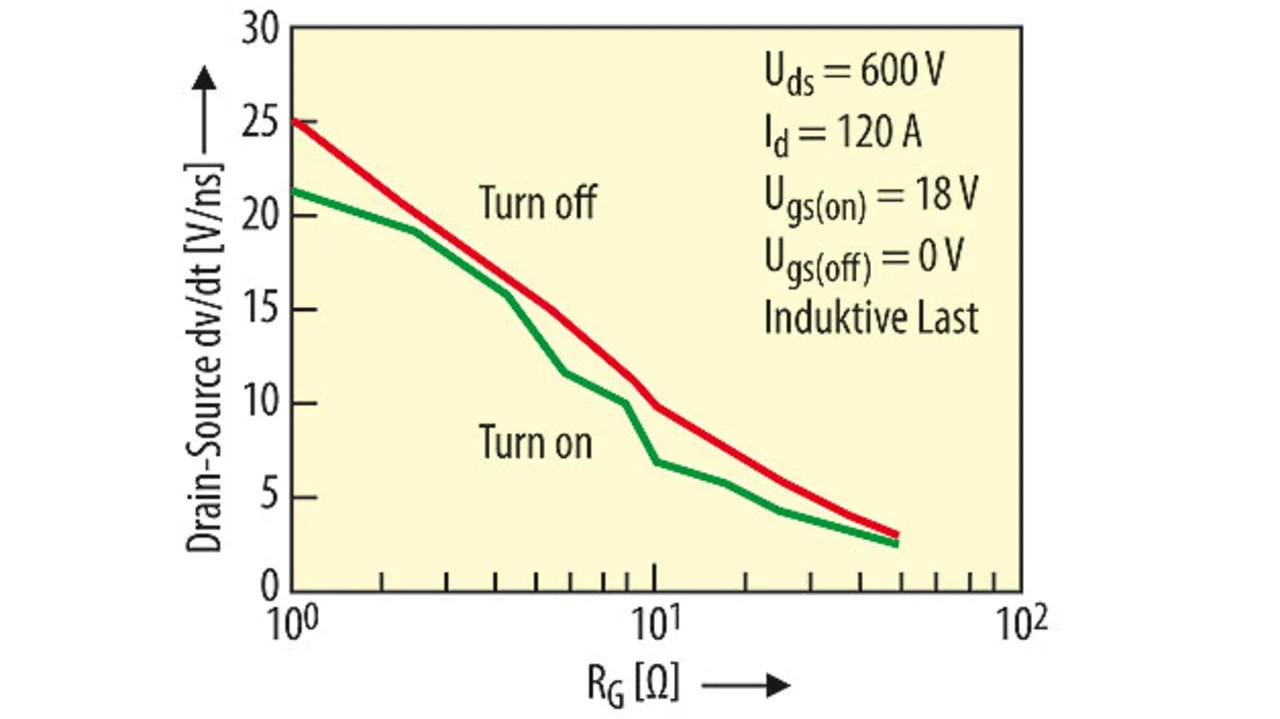
Aus Si-IGBTs und Si-FRDs bestehende IGBT-Module werden häufig als Leistungs-Module für hohe Spannungen und Stromstärken eingesetzt. Mit SiC-Power-Modulen lassen sich die Schaltverluste, die durch den Stromschweif von Si-IGBTs und den Sperrverzögerungsstrom von Si-FRDs entstehen, beträchtlich reduzieren. Vorteile hierbei sind der gesteigerte Umwandlungs-Wirkungsgrad durch die geringeren Schaltverluste, die einfachere thermische Auslegung (kleinere und kostengünstigere Kühlkörper oder Kühlsysteme sowie Ersatz von Wasser- oder Gebläsekühlung durch Konvektionskühlung) sowie kleinere passive Bauelemente (Induktivitäten und Kondensatoren). Dank ihrer Eignung für höhere Schaltfrequenzen werden SiC-Power-Module immer häufiger in Netzteilen für Industrie-Equipment, PV-Power-Konditionierern usw. eingesetzt. Die SiC-Power-Module von Rohm sind derzeit in Halbbrücken-Konfiguration verfügbar und bestehen entweder nur aus SiC-MOSFETs oder aus SiC-MOSFETs in Verbindung mit anti-parallelen SiC-Schottky-Dioden.
Dank der schnellen Sperrverzögerungs-Eigenschaften der SiC-Schottky-Dioden (bzw. der Body-Dioden von SiC-MOSFETs) sind die Sperrverzögerungs-Verluste Err von SiC-Power-Modulen fast gleich null. Ihr Eoff-Wert ist außerdem wesentlich kleiner als bei IGBTs, weil SiC-MOSFETs keinen Stromschweif aufweisen. Eon und Eoff nehmen tendenziell proportional zum Strom zu, wobei die Proportionalität vom externen RG abhängt. Während der Sperrverzögerungsstrom von Si-FRDs und der Stromschweif von IGBTs mit zunehmender Temperatur ansteigen, verändern sich die Schalteigenschaften der SiC-Module, deren Funktion auf Majoritätsträgern beruht, bei steigender Temperatur nur geringfügig. Die Schwellenspannung von SiC-Bauelementen geht außerdem bei hohen Temperaturen zurück. Unterm Strich bewirkt dies, dass SiC-Power-Module mit zunehmender Betriebstemperatur niedrigere Eon-Werte und geringfügig höhere Eoff-Werte aufweisen.
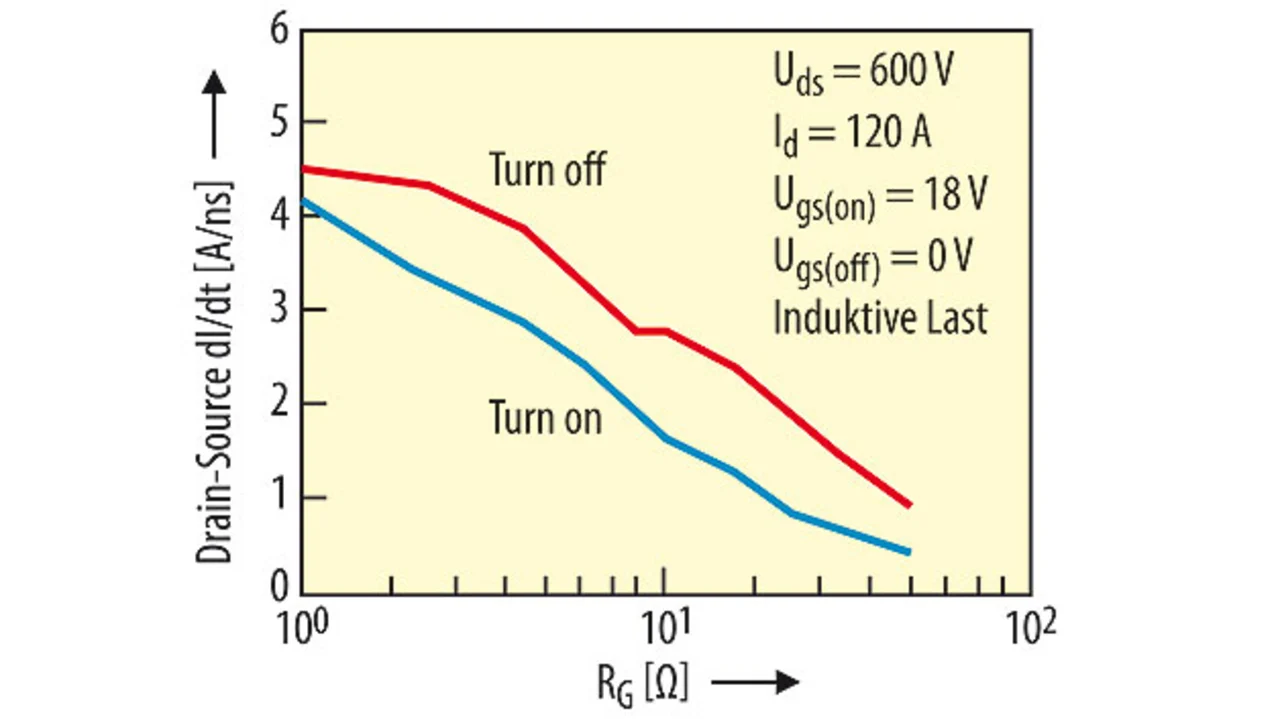
Ein hoher externer Gate-Widerstand reduziert den Lade-/Entladestrom zum bzw. vom Gate und verringert dadurch die Schaltgeschwindigkeit. Dies kann den Eon-Wert sowie den Eoff-Wert ansteigen lassen und die Leistungsfähigkeit beeinträchtigen. Um dies zu verhindern, sollte wann immer möglich ein kleiner Gate-Widerstand verwendet werden. Die Kurven geben die Abhängigkeit von dV/dt (Bild 6) und dI/dt (Bild 7) vom externen Gate-Widerstand wieder. Rohm hat seine SiC-Power-Module unter verschiedenen Bedingungen getestet und dabei zu keiner Zeit beobachten können, dass hohe dV/dt- oder dI/dt-Werte zu einem Durchbruch geführt hätten.
Die maximalen Ugs-Werte von SiC-MOSFETs betragen zwischen –6 V und –22 V, und die empfohlenen Gate-Treiberspannungen lauten Ugs(on) = 18 V und Ugs(off) = 0 V. Die empfohlene negative Vorspannung – falls sie zur Anwendung kommt – liegt zwischen –3 V und –5 V. Innerhalb der spezifizierten Grenzwerte wird das Gate umso schneller geladen bzw. entladen (mit entsprechend geringeren Eon- bzw. Eoff-Werten), je höher Ugs(on) und Ugs(off) gewählt werden. Im nächsten Abschnitt werden die Ergebnisse eines Vergleichs zwischen den neuesten 1200-V/100-A-Halbbrücken-IGBT-Modulen dreier verschiedener Hersteller (Stand: 2012) und einem SiC-Modul von Rohm mit gleichen Eckwerten vorgestellt.
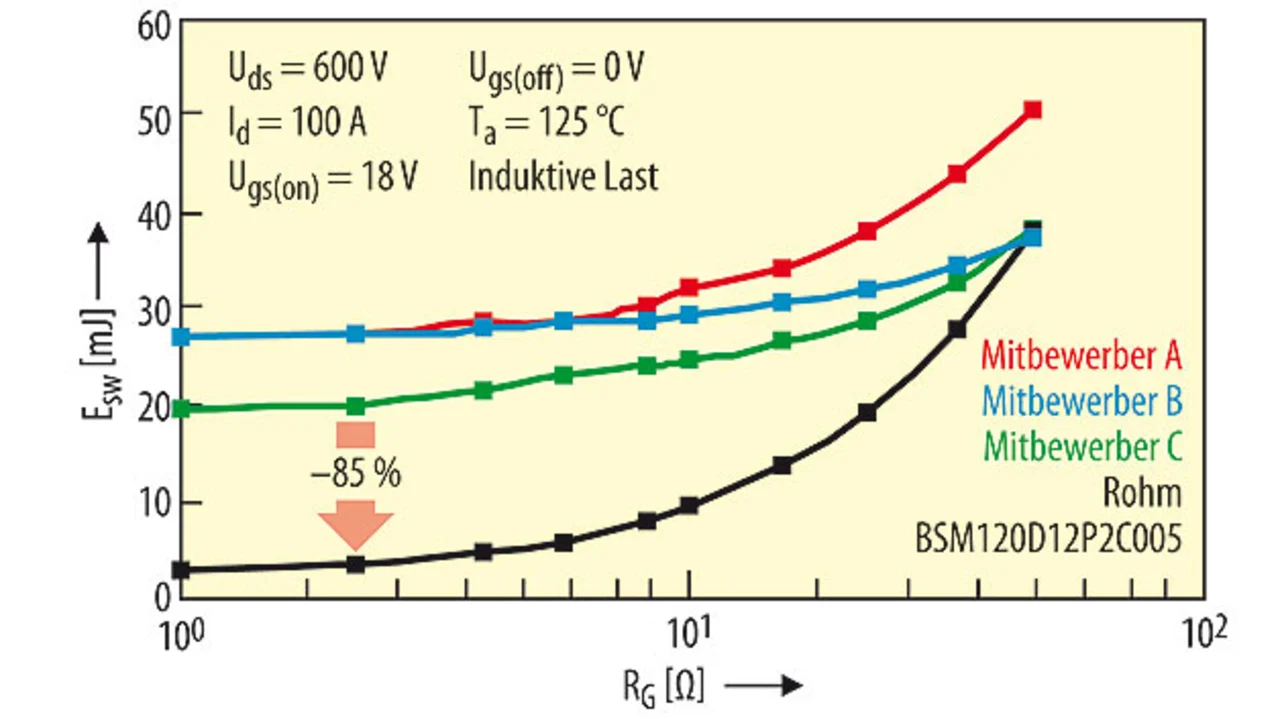
Wird der externe Gate-Widerstand passend gewählt, können SiC-Power-Module die Gesamt-Schaltverluste (Eon + Eoff + Err) gegenüber modernsten IGBT-Modulen um ca. 85 % reduzieren (Bild 8). SiC-Power-Module lassen sich mit Frequenzen von 50 kHz und mehr ansteuern, was das Verwenden kleinerer Filterbauteile zulässt. Mit konventionellen IGBT-Modulen sind solche Betriebsbedingungen problematisch und generell nicht machbar. Darüber hinaus werden IGBT-Module wegen der hohen und mit der Sperrschichttemperatur zunehmenden Verluste normalerweise nur mit der Hälfte des Nennstroms betrieben. Bei SiC-Modulen ist der Stromminderungsfaktor wegen der geringeren Schaltverluste dagegen deutlich kleiner. Daraus folgt, dass SiC-Module anstelle von IGBT-Modulen mit höherem Nennstrom verwendet werden können.
Bei IGBT-Modulen kommt es wegen des hohen maximalen Sperrverzögerungsstroms der Si-FRDs zu großen Schaltverlusten. SiC-Schottky-Dioden dagegen weisen außergewöhnlich niedrige Irr-Werte und kurze trr-Werte auf, so dass die Schaltverluste bei ihnen vernachlässigbar gering sind.
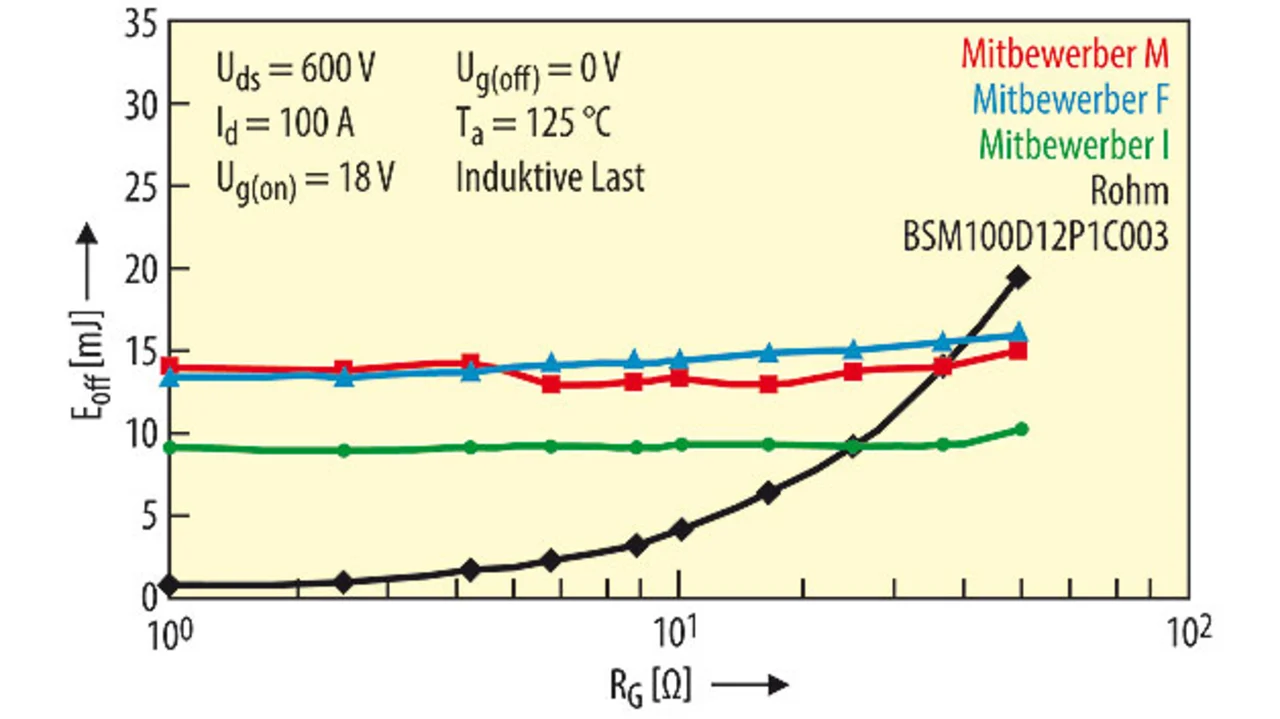
Durch den Kommutierungsstrom verursachte Sperrverzögerungsströme fließen durch den entgegengesetzten Zweig und führen dort zu einer Zunahme der Schaltverluste im Schaltbaustein. Bei SiC-Modulen reduziert sich der Eon-Verlust jedoch dank ihres schnellen Sperrverzögerungsverhaltens. Je kleiner der externe Gate-Widerstand ist, umso niedriger werden die Schaltverluste. Die Abschaltverluste von IGBTs resultieren aus dem Stromschweif dieser Bauelemente. Ihr Eoff-Wert ist hoch und vom Gate-Widerstand im Wesentlichen unbeeinflusst (Bild 9). Dank des fehlenden Stromschweifs schalten SiC-MOSFETs stattdessen verlustarm und extrem schnell. Je kleiner der externe Gate-Widerstand ist, umso niedriger werden die Schaltverluste.
Im letzten Teil 3 der SiC-Artikelserie stehen die verschiedenen Anwendungen im Vordergrund.
Teil 1 der Artikelserie finden Sie hier.
- Eigenschaften und Strukturen von SiC-Komponenten
- SiC-MOSFETs
- SiC-Leistungs-Module


