3D-Integration mit Hilfe keramikbasierender Fertigungsprozesse:
Passives Embedding
Fortsetzung des Artikels von Teil 3
Semiconductor Embedded in Substrate
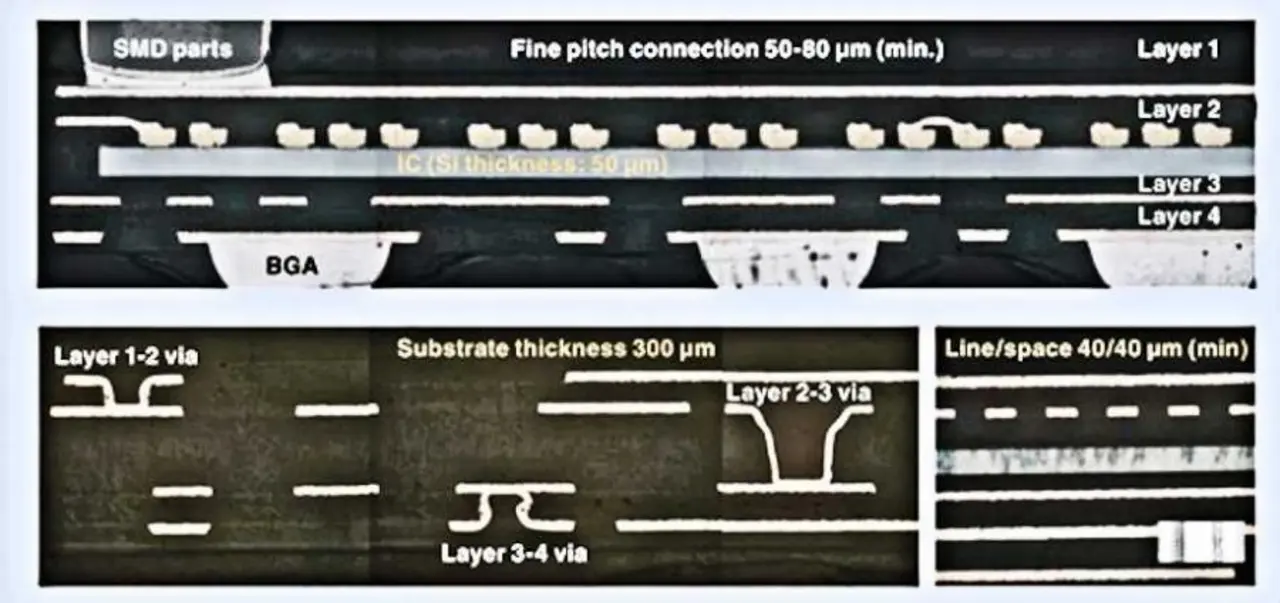
Ein neuer Ansatz für die Integration ist die TDK-Substrattechnologie SESUB (Semiconductor Embedded in Substrate). Die Gesamthöhe des SESUB-Substrats beträgt einschließlich der integrierten Halbleiter-Chips nur 300 µm (Bild 5).
Zusätzlich erforderliche, diskrete passive Bauelemente können auf der Oberfläche des Substrats bestückt werden. Um die Integrationsdichte noch weiter zu erhöhen, sollen in einem nächsten Schritt dünne passive Bauelemente auch in das Substrat eingebettet werden. Dadurch, dass die dritte Dimension für die Integration genutzt wird, sinkt der Flächenbedarf um 50 bis 60 Prozent – verglichen mit konventionellen diskreten Lösungen.
Durch die kurzen Leiterführungen in den Modulen ergeben sich sehr gute elektrische Eigenschaften, da parasitäre Effekte minimiert werden und durch schirmende Lagen die EMV verbessert wird. Zudem bietet SESUB ein überragendes thermisches Verhalten: Weil der IC vollständig eingebettet und auf allen Seiten vom Substrat umgeben ist, wird die Abwärme des Halbleiters über die gesamte Oberfläche abgeführt. Die Substratlagen selbst wiederum beinhalten mikrostrukturierte Leitungswege aus Kupfer, die die Abwärme homogen und effizient verteilen.
Mit diesem thermischen Verhalten bieten sich SESUB-Module insbesondere für das Energiemanagement, als Sende- und Empfangseinheit, für Prozessoren oder als Leistungsverstärker an – kurz gesagt: für alle wesentlichen Komponenten eines Smartphone.
Jobangebote+ passend zum Thema
- Passives Embedding
- Snubber-Kondensatoren für IGBT-Module
- Sehr enge Toleranzgrenzen
- Semiconductor Embedded in Substrate
- Kompaktes TDK-Bluetooth-Low-Energy-Modul