Kupfer- oder Gold-Bonds?
Ausfallanalyse an Leistungs-MOSFETs
Fortsetzung des Artikels von Teil 1
Fallstudien
Das zu untersuchende Bauteil, ein MOSFET mit Kupferdraht-Bonds, war nach 1.000 Temperaturzyklen gemäß „Condition C“ ausgefallen. Symptom: anormal hoher On-Widerstand. Beide Enden der Bond-Verbindung - der Ball- und der Wedge-Bond - erforderten eine genaue Untersuchung. Dazu wurden zuerst die Wedge-Bonds freigelegt. Hierbei arbeitete Vishay ausschließlich mit Laser-Entkapselung, um eine Beschädigung der Bonds durch nass-chemische Entkapselung zu vermeiden (Bilder 9 und 10). Unter dem Rasterelektronenmikroskop (SEM) wurden Risse an den Wedge-Bonds sichtbar, die als Hauptursache für den ungewöhnlich hohen RDS(ON) des MOSFET in Frage kamen.
Im nächsten Schritt fand die Untersuchung der Kontaktstelle zwischen dem Ball-Bond und dem Bondpad statt, indem man durch mechanisches Schleifen einen Querschnitt durch die Mitte der Ball-Bonds herstellte. Danach folgte die Beseitigung der Kupfer-Schmierreste durch FIB-Feinpolieren. Abschließend folgte die Untersuchung der Kontaktstelle zwischen dem Kupferdraht und dem Aluminium-Bondpad mit dem Rasterelektronenmikroskop - sie erwies sich als einwandfrei (Bilder 11 und 12).
Die Analyse der Ball- und Wedge-Bonds ließ den Schluss zu, dass die Risse in den Wedge-Bonds die Ursache für den anormal hohen RDS(ON) waren.
Ausfallanalyse an Leistungs-MOSFETs
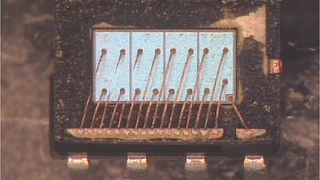
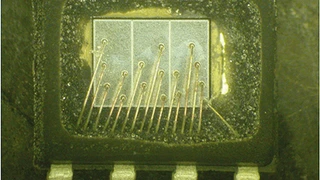

Fallstudie 2
Im Rahmen der Entwicklung und Optimierung des Kupferdraht-Bonding-Prozesses spielt die Ausfallanalyse eine entscheidende Rolle für die Charakterisierung der Bonding-Prozessparameter. Mit Hilfe von Ausfallanalyse-Techniken erfolgte die Charakterisierung der Mindestdicke der unter den Kupferdraht-Bonds verbleibenden Aluminiumschicht in Abhängigkeit von verschiedenen Bonding-Parametern. Die Tabelle enthält Zahlen mit relativen Werten aus einem Versuch, bei dem die Bonding-Parameter innerhalb eines gewissen Bereichs um ihre jeweiligen Nennwerte herum variiert wurden.

Zunächst stellte man eine Reihe von Bonds (A1 bis A4) mit jeweils unterschiedlichen Bonding-Parametern her. Danach wurden die Kupferdraht-Bonds mit Hilfe 63-prozentiger Salpetersäure bei 30 °C weggeätzt, ohne dabei das Aluminium-Bondpad zu beschädigen. Die Untersuchung der Mindestdicke der verbleibenden Aluminiumschicht mittels FIB-Querschnittsanalyse schloss den Vorgang ab.
Bild 13 zeigt, dass die verbleibende Aluminiumschicht beim Bond-Typ A1 etwa 2,06 μm beträgt; in Bild 14 beträgt die verbleibende Aluminiumschicht beim Bond-Typ A4 etwa 3,97 μm. Die Dicke der verbleibenden Aluminiumschicht kann als Maß dafür dienen, wie weit man noch vom Over-Bonding entfernt ist. Dieser Wert zeigte auf, dass die von 95 (A1) auf 70 (A4) reduzierte Grundleistung das Over-Bonding-Risiko drastisch verringerte. Vishay folgert daraus, dass sich durch Optimierung der Bonding-Parameter größtmögliche Bond-Integrität bei minimalem Over-Bonding-Risiko erzielen lässt.
Literatur
[1] Song, Meijiang; Gong, G. L.; Yao, J. Z. et al.: Study of Optimum Bond Pad Metallization Thickness for Copper Wire Bond Process. 12th Electronics Packaging Technology Conference 2010. Seite 597 - 602
[2] Murali, S.; Srikanth, S.: Acid Decapsula-tion of Epoxy Molded IC Packages with Copper Wire Bonds. IEEE Trans. Electron. Packaging Manufacturing, Vol. 29, Nr. 3; Juli 2006. Seite 179 - 183.
[3] Klein, J. E.; Copeland, L.: Decapsulatioon of Copper Bonded Encasulated Integrated Circuits Utilizing Laser Ablation und Mixed Acid Chemistry. ISTFA 2010. Seite 133 - 136.
[4] Staller, K. D.: Low Temperature Plasma Decapsulation of Copper-wire-bonded und exposed Copper Metallization Devices. ISTFA 2010. Seite 127 - 132.
[5] Premkumar, J.; Senthil Kumar, B.; Madhu, M. et al.: Key Factors in Cu Wire Bonding Reliability: Remnant Aluminum und Cu/Al IMC Thickness. 10th Electronics Packaging Technology Conference 2008. Seite 971 - 975.
[6] Zhang, X.; Lin, X.; Chen, Y.: The Reliability Evaluation of Cu Wire Bonding by Using Focus Ion Beam System. Int’l Conf. on Electronic Packaging Technology & High Density Packaging 2010. Seite 1.049 - 1.052.
| Die Autoren |
|---|
| Arthur Chiang ist Leiter der Abteilung Reliability Engineering bei Vishay Intertechnology. Er ist Mitglied der Organisationen IEEE, AEC & JEDEC und EDFAS sowie Inhaber zahlreicher Patente auf den Gebieten Emissionsmikroskopie und Leistungsdioden. Arthur Chiang hält einen M.S. in Elektrotechnik von der Stony Brook University und einen Ph.D. in Elektrotechnik und Computerwissenschaft von der Princeton University. |
|
Huixian Wu ist Reliability Manager bei Vishay Intertechnology. Er ist Mitglied des IEEE und der AEC und hat über 30 wissenschaftliche Abhandlungen verfasst. Neben einem B.S. in Materialwissenschaft und einem M.S. in Halbleitermaterialwissenschaft von der Zhejiang University hat er einen M.S. in Zuverlässigkeitsforschung von der University of Maryland sowie einen Ph.D. in Elektrotechnik von der Lehigh University. |
|
David Le ist Ausfallanalyse-Ingenieur bei Vishay Intertechnology. Er hält einen B.S. in Elektrotechnik von der San Jose State University. |
- Ausfallanalyse an Leistungs-MOSFETs
- Fallstudien