tde - trans data elektronik
MMC setzt Maßstäbe für die Hochgeschwindigkeitsübertragung
»Keine Frage, der MMC wird kommen! In den USA setzt er bereits Maßstäbe, ist bei Hyperscale-Rechenzentren mit höchsten Übertragungsraten im Einsatz. Es wird wahrscheinlich keine sechs Monate dauern, bis er auch in Transceivern verbaut wird«, sagt André Engel, Geschäftsführer von tde.
Beim "tech forum München 2024" hatte er seine Premiere bei tde: der hochkompakte MMC-24-Faser-Steckverbinder von US Conec. Als einer der ersten Netzwerkexperten in Europa fertigt tde am Produktionsstandort in Niedersachsen komplette LWL-Verkabelungssysteme mit dem kompakten MMC-Stecker. So etwa die Plug&Play-Verkabelungsplattform tML 24+, die als erste Plattform den MMC-Steckverbinder sowohl im Rückraum als auch im Patchbereich integriert und damit dank Verdoppelung der Packungseffizienz neue Maßstäbe setzt.
Für Unternehmen eröffnet sich so die Möglichkeit der einfachen Migration zu Übertragungsraten von aktuell bis zu 800 G.
Jobangebote+ passend zum Thema
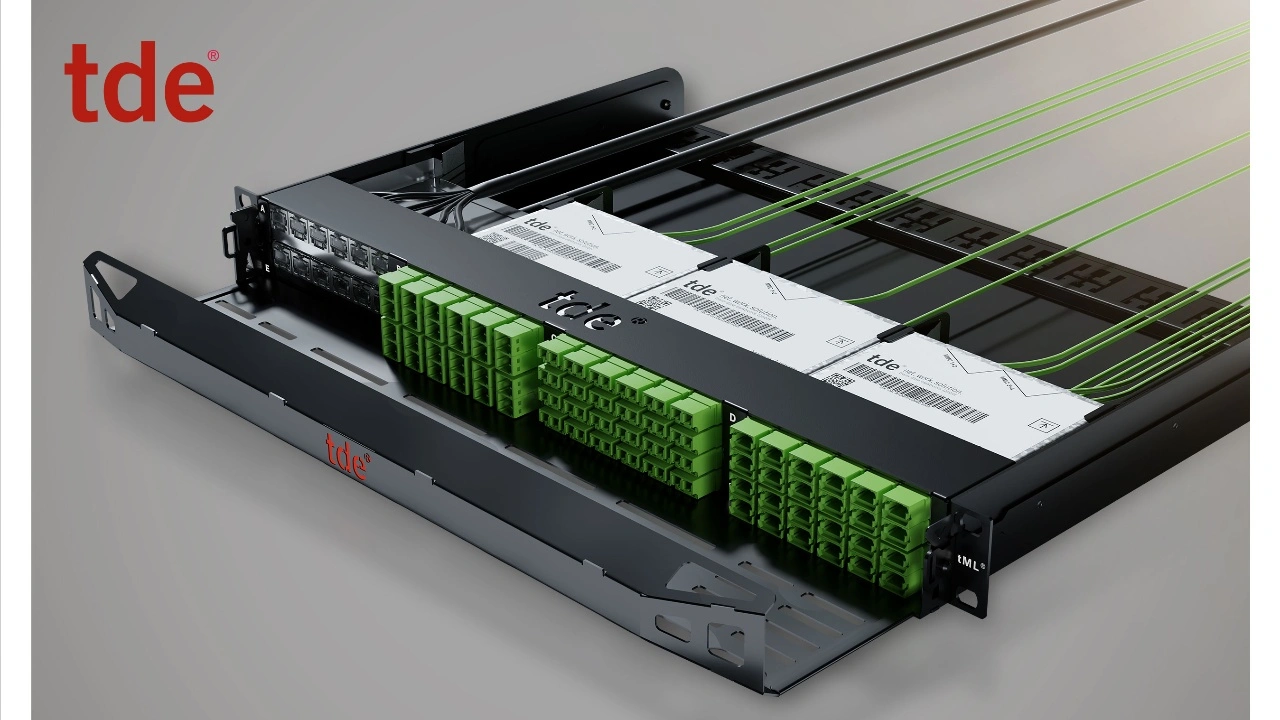
Nach 2024 wird auch das "tech forum München 2025" bei tde ganz im Zeichen des MMC-Steckverbinders stehen. »Wir haben nun über ein Jahr Erfahrung in der Anwendung gesammelt«, verdeutlicht André Engel, Geschäftsführer tde. »In den vergangenen Monaten haben wir die Prozesse für die eigene Produktion des MMC-Steckverbinders entwickelt und optimiert. Dabei profitieren wir von unserer 25-jährigen Erfahrung im Zusammenhang mit MT-Ferrulen«.
tde auf dem tech forum München am 4./5. Februar 2025
tde – trans data elektronik zeigt auf dem diesjährigen tech forum die Zukunft der Verkabelung, Mehrfaser- und Paralleloptik-Technik.

Neben der modulare Systemplattform tML 24+ stellt der Netzwerkspezialist weitere Innovationen vor, welche insbesondere die Systemplattform tML noch smarter machen: das neu designte tML Spleißmodul für bis zu 192 LWL-Spleiße auf nur einer Höheneinheit sowie das tML Reverse Modul für gleiche Portdichte im Rückraum und im Patchbereich.
»Bei tde befinden wir uns aktuell in einem wirklichen Innovations-Flow«, so Engel. »Wir hören hin, was unsere Kunden beschäftigt: immer weiter steigende Übertragungsraten bei nach wie vor knappem und teurem Platz im Datacenter. Und wir entwickeln Lösungen, die eine noch höhere Packungseffizienz bieten. Das tech forum bietet Raum für fachlichen Austausch und neue Ideen, die wiederum in weitere Innovationen einfließen – darauf freuen wir uns«.