Wide-Bandgap-Materialien
GaN-Bauteile wirtschaftlich fertigen
Lassen sich GaN-Leistungshalbleiter mit Sperrspannungen von 600 V und darüber wegen der schwierigen Epitaxie-Technologie überhaupt wirtschaftlich tragfähig produzieren? Das ist eine der Kernfragen, mit denen sich die Anbieter auseinandersetzen müssen. Wie sieht die Antwort dazu aus?
Hinlänglich bekannt und nachgewiesen ist, dass GaN-basierte Leistungshalbleiter für höhere Spannungen um die 600 V bislang noch nie dagewesene Chancen eröffnen können, sowohl die Leitungs- als auch die Schaltverluste in vielen Schaltungen zur Leistungswandlung zu reduzieren. Eine Hetero-Epitaxie auf Siliziumsubstraten kombiniert mit der Bausteinherstellung auf Standard-CMOS-Equipment stellt die notwendige Kostenstruktur sicher, um mit Alternativangeboten auf Siliziumbasis wirtschaftlich konkurrieren zu können.
Die Herausforderungen, dicke AlxGayN-Legierungen ohne Fehlstellen (Cracks) in Fertigungsmengen auf Siliziumsubstraten mit Standarddicke aufwachsen zu lassen, wurden häufig unterschätzt – entweder als unumgänglicher Bestandteil für die Vermarktung von GaN-basierten Leistungsbausteinen oder als beträchtliche technologische Hürde beim Übergang von wirtschaftlich nicht sinnvollen Substraten wie Siliziumkarbid (SiC). Bei der Kommerzialisierung von GaN-basierten Leistungsbausteinen sollte diese Fähigkeit, zusammen mit dem eigenen geistigen Eigentum, oberste Priorität haben.

International Rectifier (IR) beispielsweise hat nachgewiesen, eine bis 5 µm dicke Epitaxieschicht aus AlxGayN auf 150 mm großen Siliziumsubstraten mit Standarddicke herstellen zu können. Gleiches gilt für Crack-freie, 2,25 µm dicke GaN-on-Si-Epitaxieschichten mit geringer Verformung (Wölbung 15 ± 10 µm), die das Unternehmen auf Siliziumsubstraten mit 200 mm Durchmesser in Standarddicke (725 µm) in Massen fertigen kann. IR hat das anhand von mehr als zwanzig Multi-Wafer-Chargen aufgezeigt (Bild 1). Möglich machte diese der Einsatz von IRs proprietärer, komplex aufgebauter epitaktischer Übergangsschicht (Transition Layer) aus III-N auf Silizium.
Eine weitere wesentliche Voraussetzung für die Vermarktung liegt in der Fähigkeit, Bausteine parallel zu den vorherrschenden hochvolumigen Leistungsbausteinen auf Siliziumbasis zu produzieren. Auch für diese Fähigkeit wurden bereits Nachweise erbracht.
Häufig wird behauptet, dass die Entwicklung eines GaN-basierten HEMT (High Electron Mobility Transistor) vom Anreicherungstyp (Enhancement Mode) aufgrund seiner selbstsperrenden Natur (normally off) wichtig sei, damit sich diese Bauteile überhaupt vermarkten lassen. Denn nur dann verhielten sie sich genauso wie ein normaler Silizium-MOSFET, wie ihn Entwickler seit Jahrzehnten einsetzen. Allerdings eignen sich selbstleitende Schalter (normally on) vom Verarmungstyp (Depletion Mode) für viele leistungselektronische Schaltungen (z.B. Topologien, die auf Schaltern basieren, die eine Gleichspannung zum Einschalten benötigen), und in einigen anderen Topologien, etwa Umrichter in elektrischen Antrieben, sind sie sogar von Vorteil. Das liegt daran, dass GaN-basierte Depletion-Mode-HEMT-Bausteine von Natur aus zum Betrieb als bidirektionale Schalter fähig sind. Zudem stellt die inhärente Instabilität des zweidimensionalen Elektronengases (2DEG) gegenüber angelegten positiven Feldern, die das Eigenpotenzial der AlGaN-Sperrschicht (in AlGaN-GaN-HEMTs) zusammenbrechen lässt, eine massive Einschränkung der Gate-Ansteuerung für jeden selbstsperrenden 2DEG-Baustein dar. Grund dafür ist, dass das Gate nur eingeschränkt über die Schwellenspannung übersteuert werden darf.
Vorteile von Normally-on-HEMTs
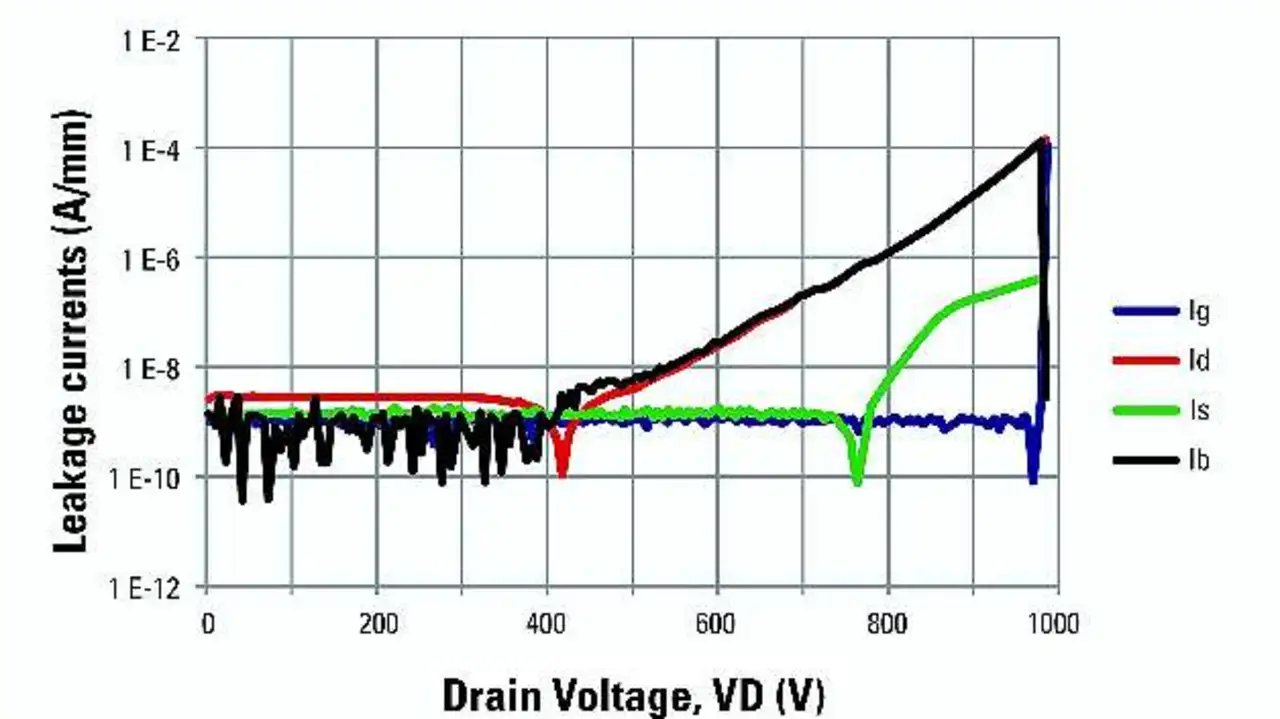
Deshalb wird in den Fällen, in denen das Normally-off-Verhalten bevorzugt wird, die kaskodierte Konfiguration aus selbstleitendem GaN-
Schalter und Niederspannungs-MOSFET empfohlen. Dieser Lösungsansatz weist, zusätzlich zu der Tatsache, dass er eine bestens etablierte und zuverlässige Gate-Treiber-Schnittstelle für externe Schaltkreise bietet, zahlreiche Vorteile auf, die in einem GaN-basierten Leistungsbaustein vom Anreicherungstyp nicht vorzufinden sind.
Über die inhärente Integrierbarkeit hinaus haben die auf lateral strukturiertem Galliumnitrid basierenden HEMTs im Vergleich zu siliziumbasierten Alternativen wie Superjunction-MOSFET oder IGBT Vorteile hinsichtlich signifikant geringeren Anschlusskapazitäten, einem mehrfach niedrigeren Source-Drain-Widerstand sowie einer Reverse-Recovery-Spannung von praktisch gleich Null. Es konnte gezeigt werden, dass die oft gefürchtete Begrenzung der Stromtragfähigkeit, die mit der lateralen Struktur der HEMTs verbunden ist, effektiv durch die Verwendung von auf der Vorderseite lötbaren Bausteinen sowie doppelseitigen Gehäusetechniken zur Oberflächenmontage behoben wird. Stromtragfähigkeitsdichten von mehr als 500 A/cm² bei +150 °C wurden mit großen 600-V-Bausteinen (Gate-Breite (Wg) = 330 mm, Active Area (AA) = 8 mm²) demonstriert, die mehr als 80 A bei Raumtemperatur tragen können.
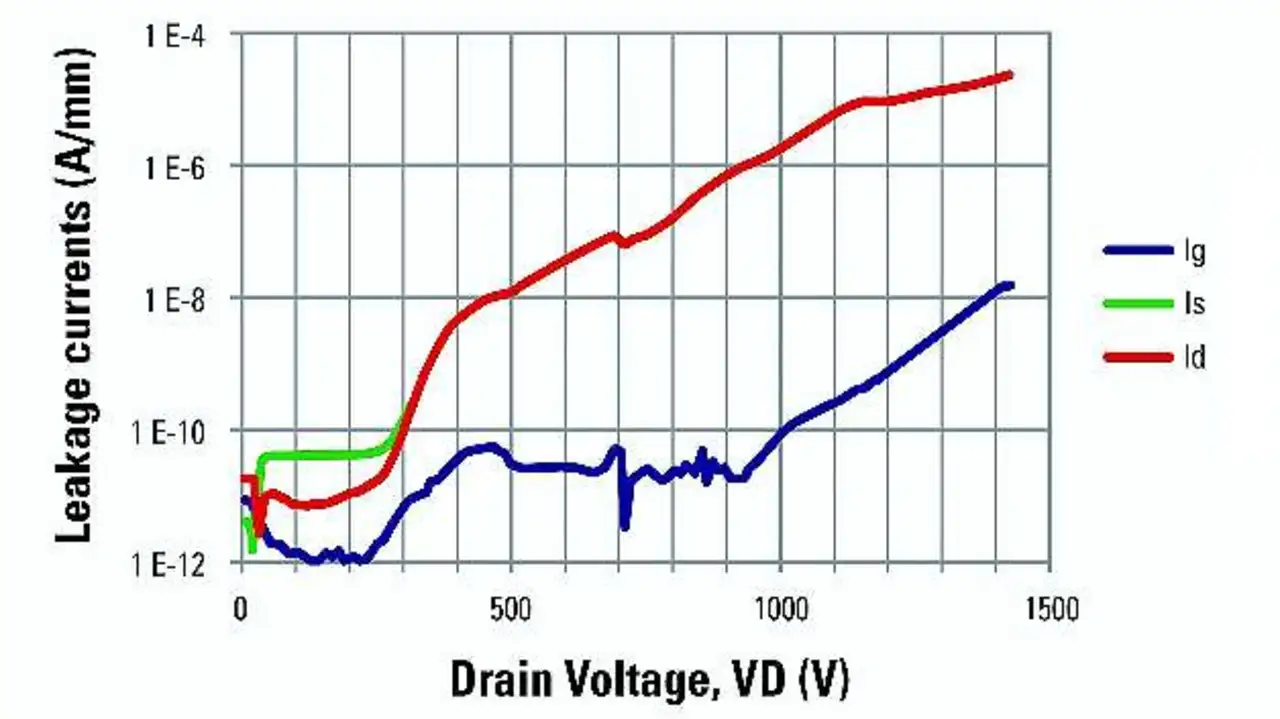
Selbstverständlich ist es wichtig, den durch die Oberfläche begrenzten Ausfall von anderen Ausfallmechanismen zu unterscheiden, zum Beispiel dem, der über der Epitaxialschicht zwischen Drain und Substrat auftritt. Bilder 2 und 3 zeigen Leckstrom-Messungen bei vier beziehungsweise drei Anschlüssen an einem Baustein mit 600 V Nennspannung für den Fall eines geerdeten Siliziumsubstrats (Bild 2) und den Fall eines potenzialfreien Siliziumsubstrats (Bild 3).

Beim geerdeten Siliziumsubstrat ist die Durchbruchsspannung durch die Epitaxialschicht bei ungefähr 950 V begrenzt, während beim »schwebenden« Substrat der Durchbruch durch die Oberfläche bei mehr als 1400 V begrenzt ist. Beide Ergebnisse bestätigen die Fähigkeit des Bausteins, eine Nennspannungsfestigkeit von 600 V zu unterstützen.
Außerdem beweist die in den Bildern 4 und 5 dargestellte Langzeitstabilität die Fähigkeit von 600-V-Bausteinen, auch über mehr als 5000 Stunden bei beschleunigten Belastungsbedingungen von 480 V und +150 °C zuverlässig zu arbeiten. Auch ist zu sehen, dass der dynamischen RDS(on) vernachlässigbar ist.

Derartige Langzeituntersuchungen müssen längere Zeiträume umfassen als 1000 Stunden, wie bei siliziumbasierten Bauteilen üblich, weil die maßgebliche Aktivierungsenergie für den zeitabhängigen dielektrischen Durchbruch in diesen GaN-basierten HEMTs wesentlich geringer ist als die 0,8 eV, die üblicherweise mit den Fehlermechanismen von siliziumbasierten Bausteinen verbunden werden.
GaN in Antriebsumrichtern
Neben den üblichen Stromversorgungsarchitekturen wie Point-of-Load- und DC/DC-Wandler sowie Schaltnetzteile werden diese 600-V-Bausteine wohl in Antriebsumrichtern mit die größte Verbreitung finden.

Aus diesem Grunde ist es wichtig, den Wert von GaN-basierten Leistungsbausteinen in Motorantrieben korrekt einzuschätzen.
Bild 6 zeigt, wie dramatisch die Verluste in 400-W-Antriebsumrichtern sinken, wenn statt moderner siliziumbasierter IGBTs GaN-basierte Kaskoden-Schalter der ersten Generation zum Einsatz kommen. Die Leitungsverluste reduzieren sich um den Faktor 6, während sich die Schaltverluste gleichzeitig halbieren. Dieses bemerkenswerte Ergebnis hat seine Ursache in einer 4- bis 10-fachen Verbesserung (je nach Laststrom) der Performance-Gütezahl (Figure of Merit) von GaN-basierten Bausteinen, ermittelt aus RDS(on) ∙ Qsw, gegenüber der von IGBTs, ermittelt aus UCE(on) ∙ Esw.
Durch derartige Verbesserungen in der Belastbarkeit lässt sich die Leistungsdichte des Wechselrichters mehr als verzehnfachen. In diesem Beispiel wird, wenn man mit berücksichtigt, dass der GaN-basierte Wechselrichter nicht den Kühlkörper des siliziumbasierten Wechselrichters benötigt, die Volumendichte zur Leistungswandlung um mehr als 100 erhöht. Solche revolutionären Verbesserungen bei Effizienz und Dichte der Leistungswandlung sind Beispiele dafür, welches Potenzial GaN-basierte Leistungsbausteine für einen Wandel in der Leistungselektronik haben.
Über den Autor:
Dr. Michael A. Briere ACOO Enterprises LLC, im Auftrag von International Rectifier.